
----追光逐电 光引未来----



(一)芯片三维互连技术
TSV垂直互连工艺的主要步骤以及细小直径、高深宽比TSV加工的工艺难点;
TGV垂直互连技术的优势、劣势,主要工艺流程以及工艺难点;
其它垂直互连技术,如通模通孔(TMV)、封装通孔(TPV)的介绍;
RDL水平互连工艺、工艺流程的介绍以及高密度RDL的主要问题;
(二)基于TSV以及RDL的异质集成方案
基于TSV及RDL互连的晶圆级封装,文中主要介绍了基于硅基的三维异质集成技术;
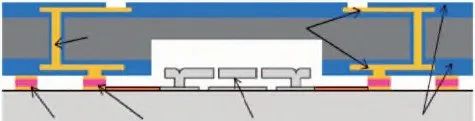
2.5D TSV转接板异质集成,文中介绍了基于TSV及微凸点互连技术的典型的2.5D转接板异质集成结构。
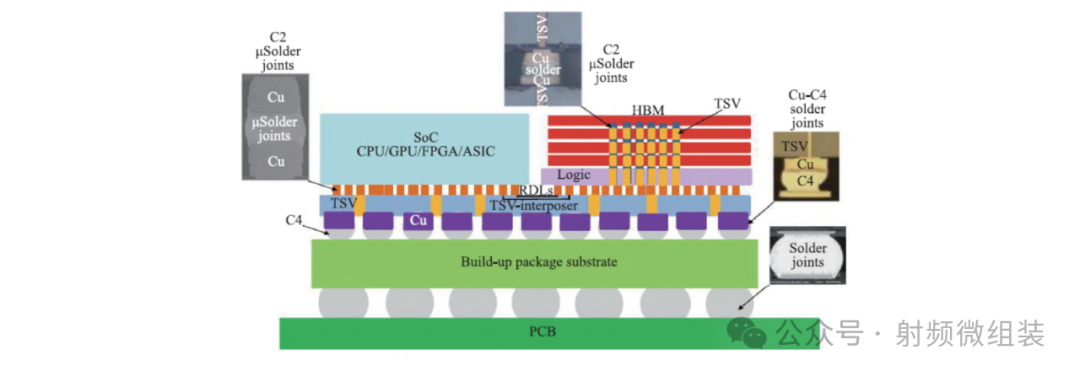
基于TSV和微凸点的三维异质集成,文中展示了基于TSV和微凸点的芯片面对面堆叠技术。
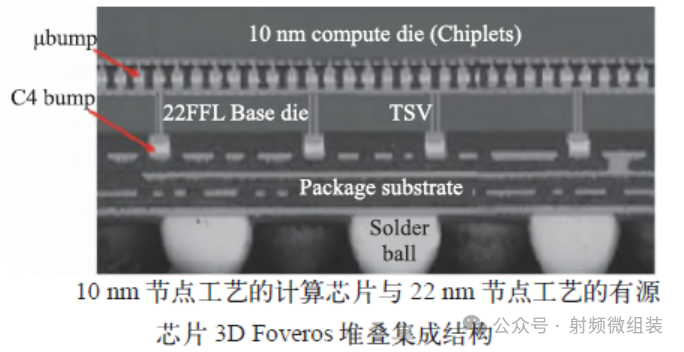
基于无凸点混合键合的三维异质集成,文中介绍了Cu-Cu直接键合以及Cu-绝缘层混合键合的工艺。
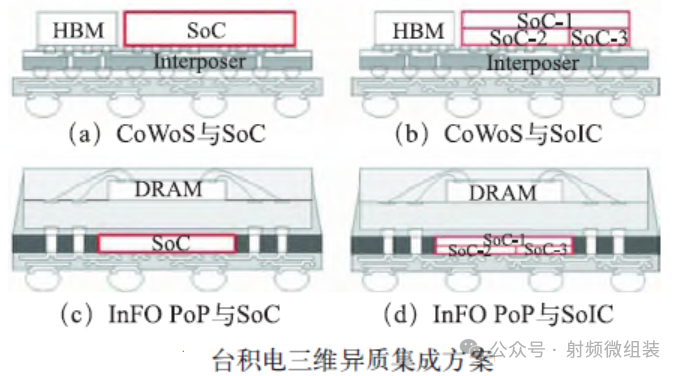
(三)基于玻璃基板的异质集成方案
基于TGV及RDL的异质集成,文中论述了TGV及玻璃基板的优劣势,文中还展示了其在天线上的探索案例。

埋入玻璃式扇出型异质集成,文中展示了埋入玻璃式扇出型异质集成的一些最新研究成果。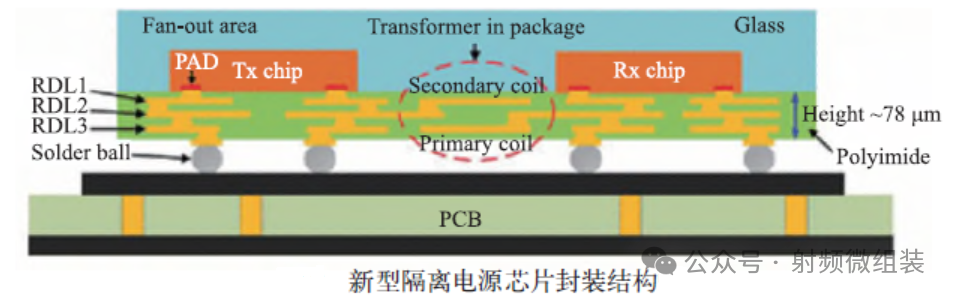
原文如下:







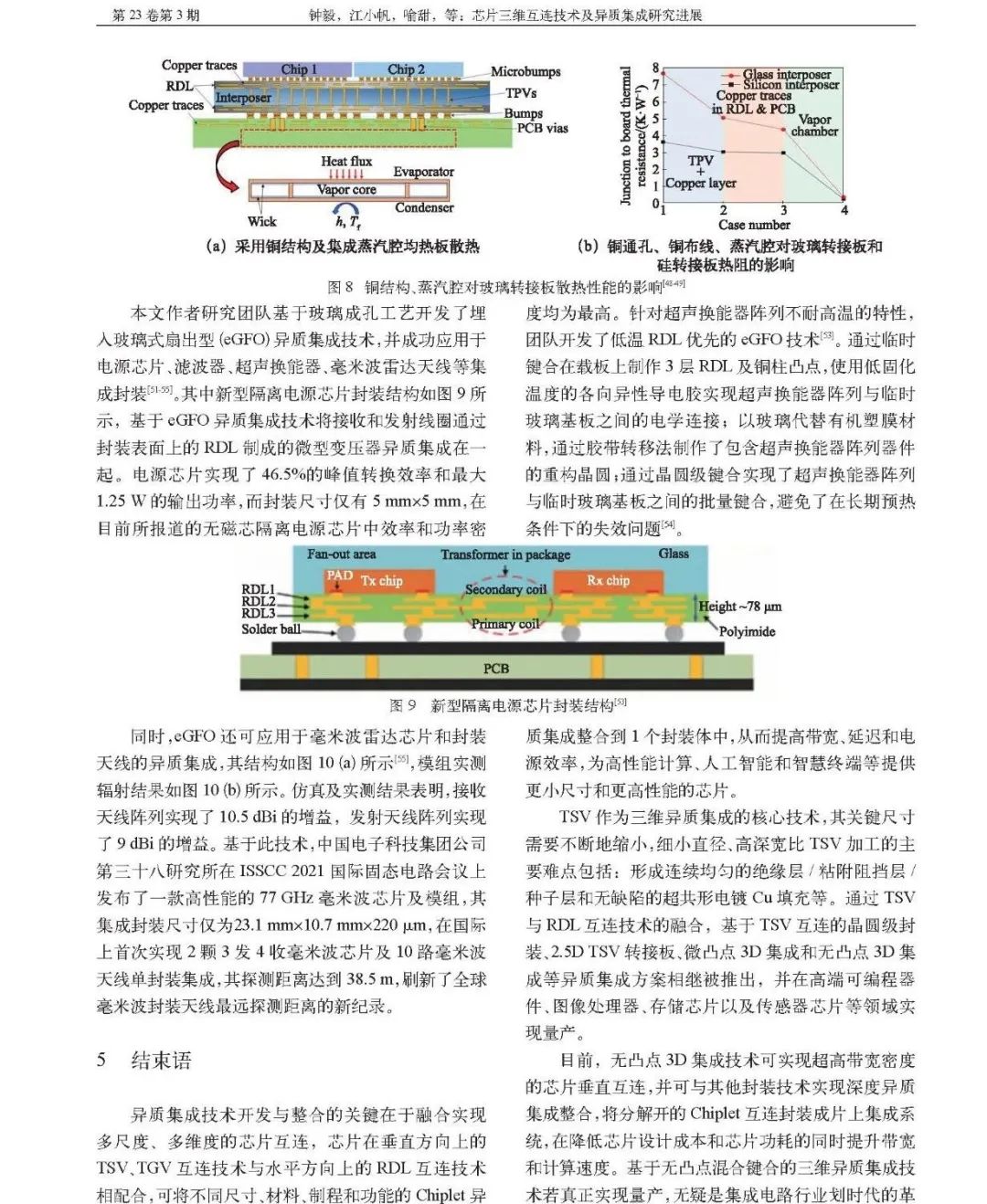
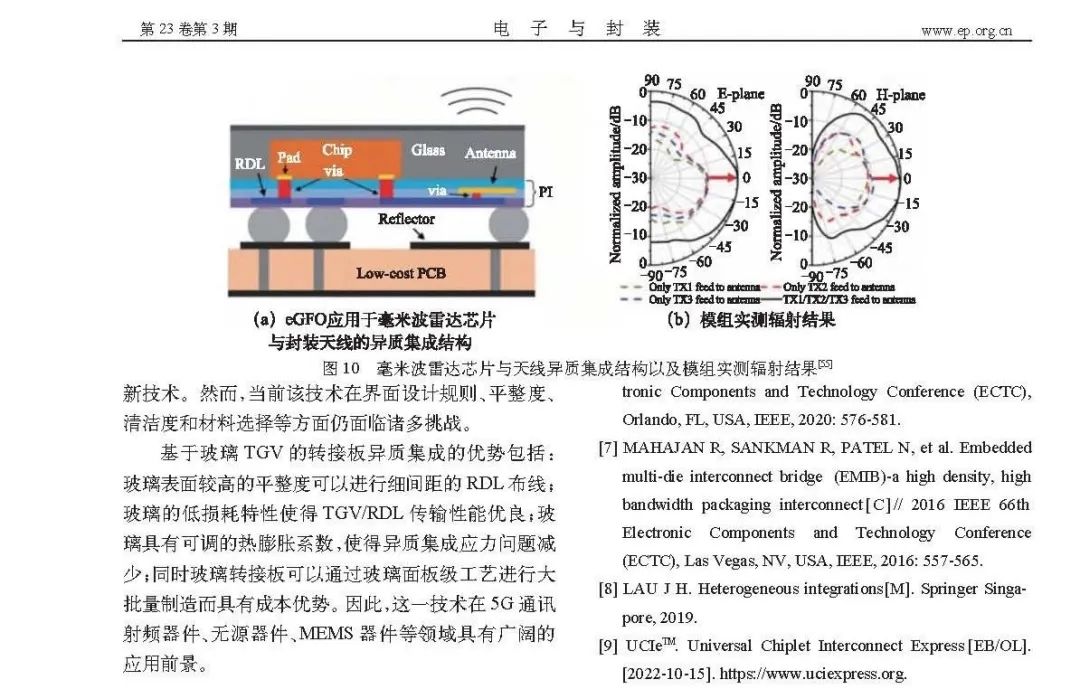
当前行业竞争激烈,工程师们面临着繁重的工作压力,业余时间还需兼顾家庭责任,难以投入大量精力进行文献查阅。为此,本公众号精心整理相关领域的研究文献,旨在搭建一个便捷的学术交流平台。我们始终秉持尊重知识产权的原则,对每位原作者的学术贡献深表敬意。如发现内容存在版权问题,请及时与公众号联系删除。


申明:感谢原创作者的辛勤付出。本号转载的文章均会在文中注明,若遇到版权问题请联系我们处理。

----与智者为伍 为创新赋能----

联系邮箱:uestcwxd@126.com
QQ:493826566