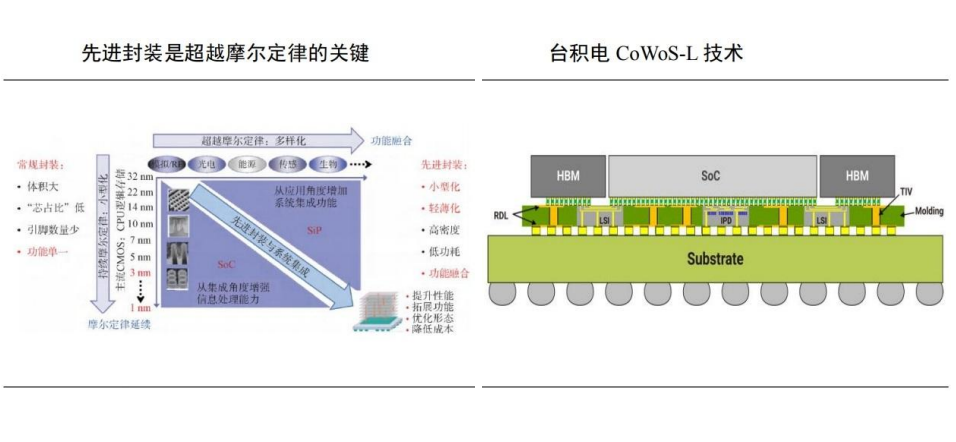

本文来自“半导体先进封装行业深度:市场现状、发展前瞻、产业链及相关企业深度梳理”,先进封装也称为高密度封装,通过缩短I/0间距和互联长度,提高I/0密度,进而实现芯片性能的提升。相比传统封装,先进封装拥有更高的内存带宽、能耗比、性能,更薄的芯片厚度,可以实现多芯片、异质集成、芯片之间高速互联。英伟达从2020年开始采用台积电CoWoS技术封装其A100 GPU系列产品,相比上一代产品V100,A100在BERT模型的训练上性能提升6倍,BERT推断时性能提升7倍。
在技术路线实现上,Bump、RDL、TSV、Hybrid Bonding是实现先进封装的关键技术。WLP、2.5D、3D是当前主流的几种先进封装技术。
围绕先进封装行业主题,我们对先进封装的行业现状和发展进行具体梳理。先进封装行业的市场现状如何?核心技术有哪些?产业链上下游概况如何?相关环节的国产替代呈现怎样的具体情形?相关公司有何布局?以及站在未来发展的视角下,未来先进封装的发展趋势如何?循着以上问题,为大家一一解析。
本文所有资料都已上传至“智能计算芯知识”星球。如“《285+份DeepSeek技术报告合集》”,“《100+份AI芯片技术修炼合集》”,加入星球获取严选精华技术报告,提供打包下载,内容持续更新...




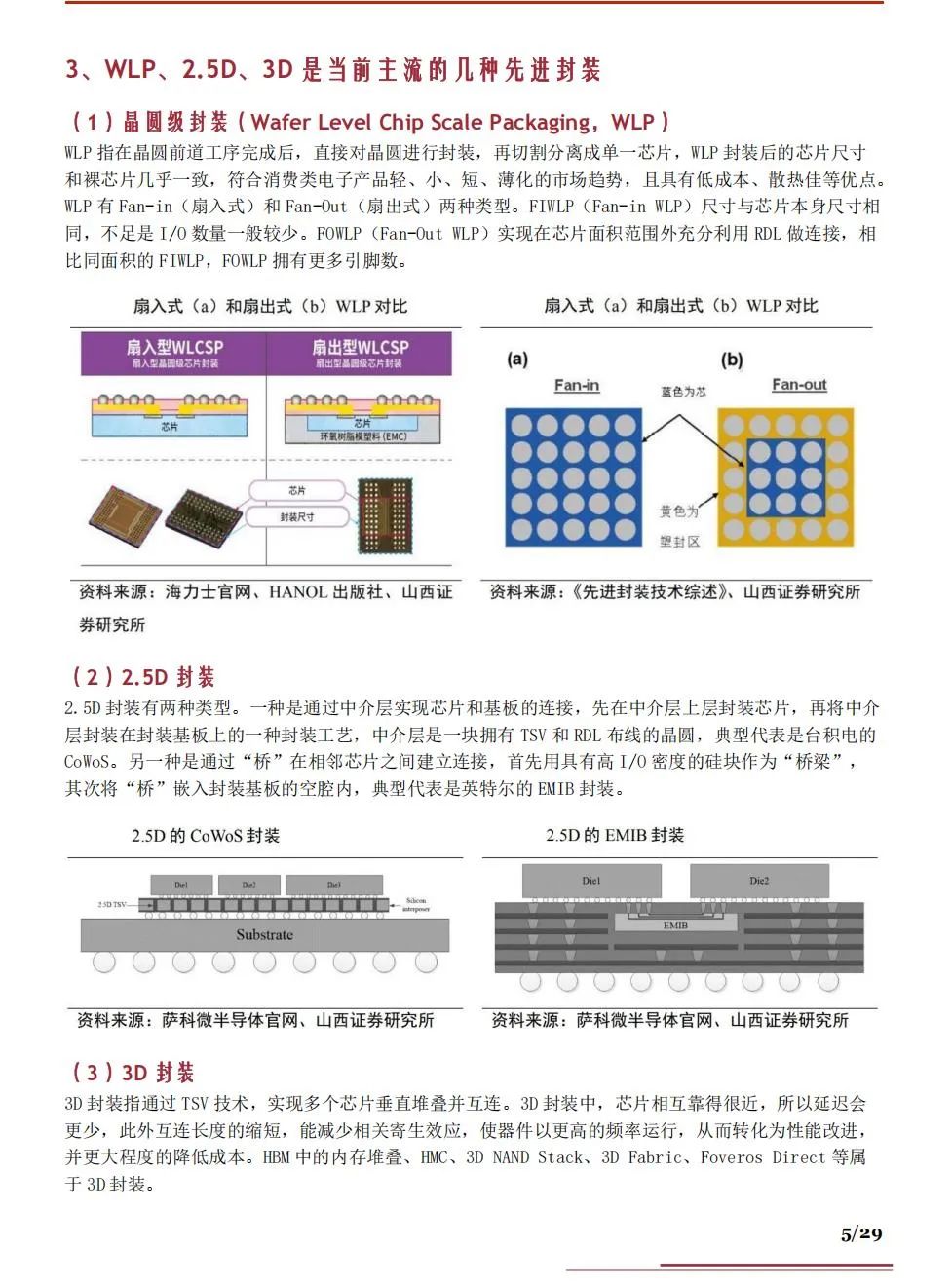




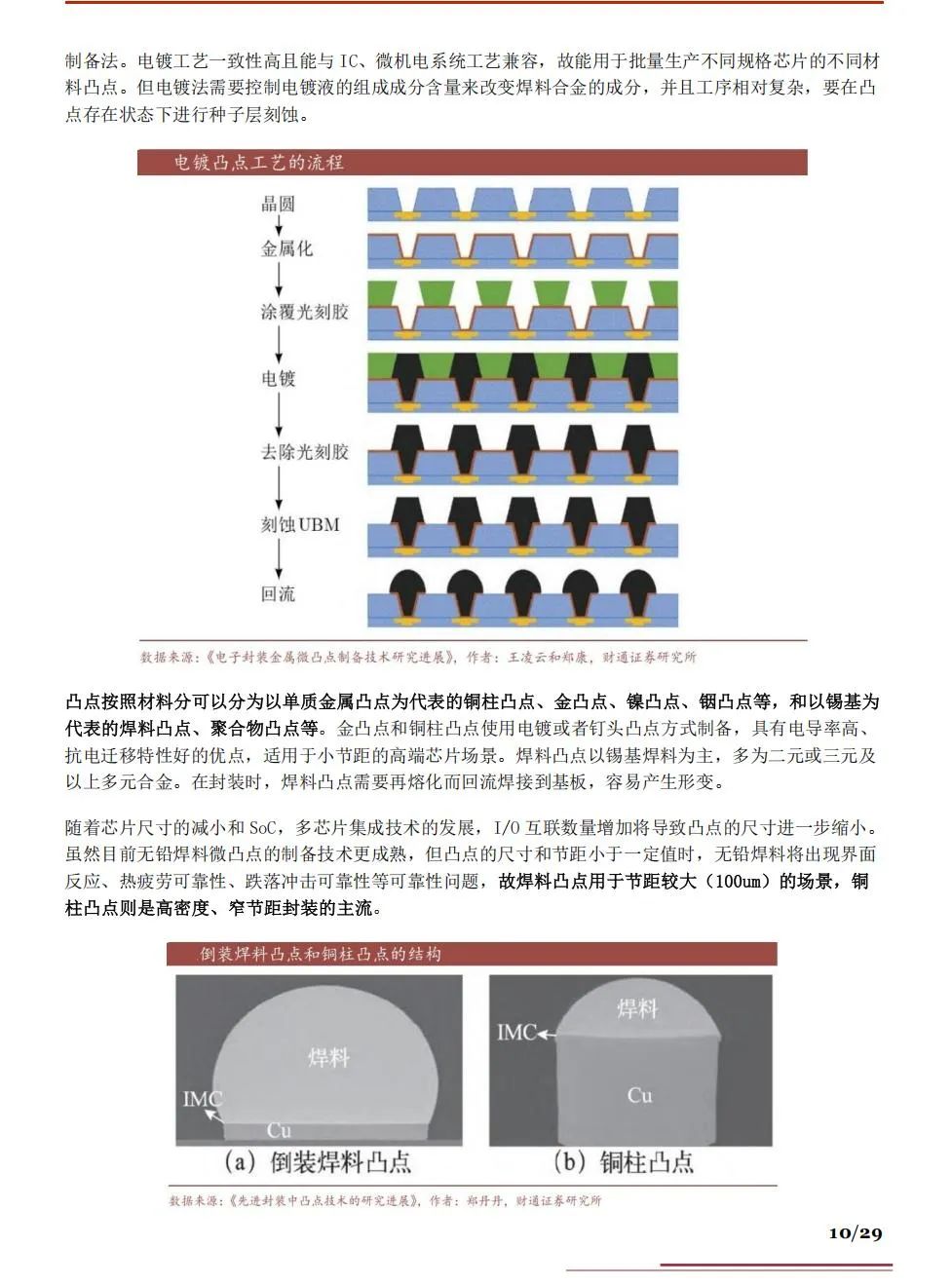



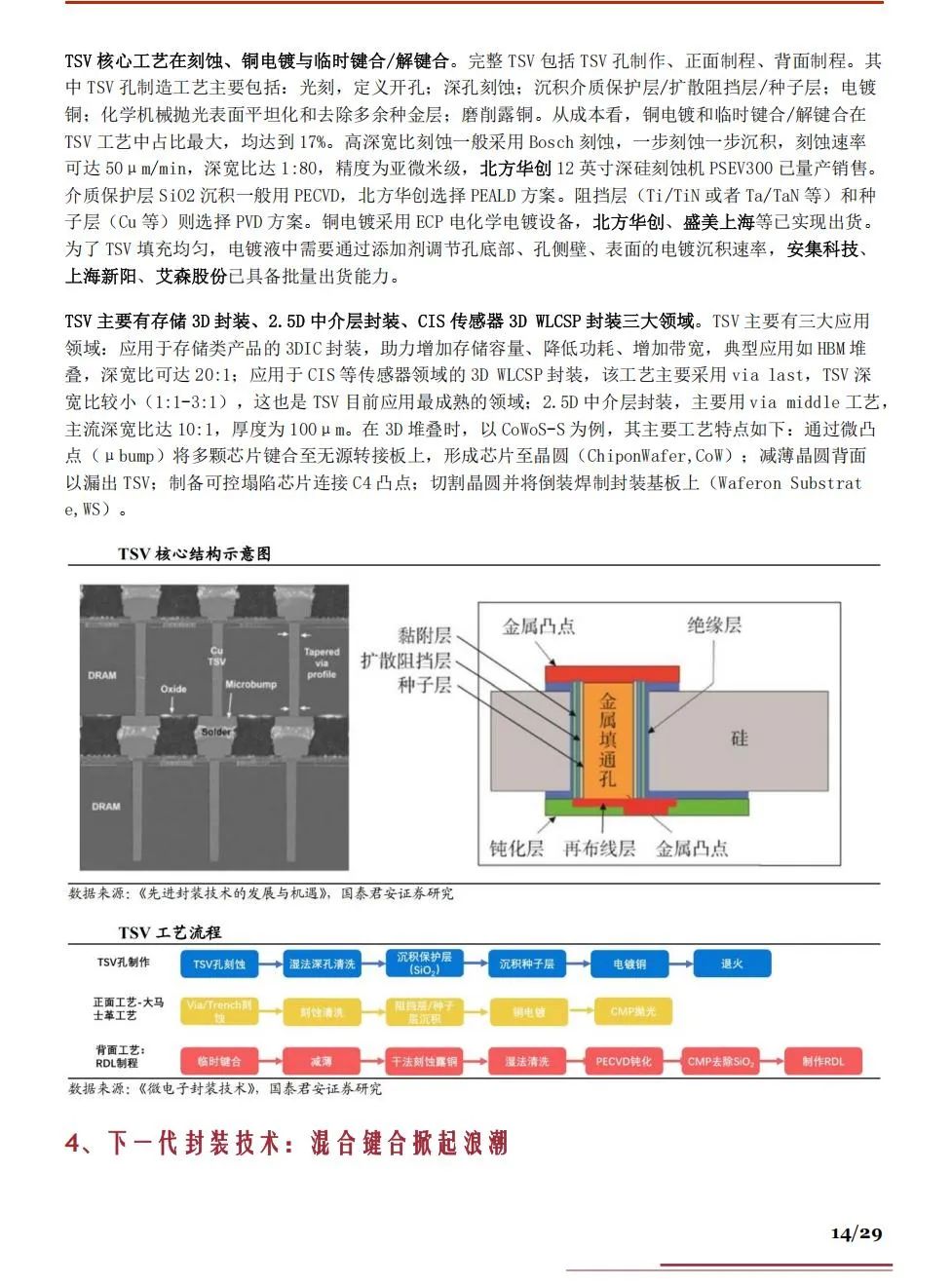















下载链接:
8、《3+份技术系列基础知识详解(星球版)》
《245+份DeepSeek技术报告合集》
《42篇半导体行业深度报告&图谱(合集)
亚太芯谷科技研究院:2024年AI大算力芯片技术发展与产业趋势
本号资料全部上传至知识星球,更多内容请登录智能计算芯知识(知识星球)星球下载全部资料。

免责申明:本号聚焦相关技术分享,内容观点不代表本号立场,可追溯内容均注明来源,发布文章若存在版权等问题,请留言联系删除,谢谢。
温馨提示:
请搜索“AI_Architect”或“扫码”关注公众号实时掌握深度技术分享,点击“阅读原文”获取更多原创技术干货。

