
----追光逐电 光引未来----
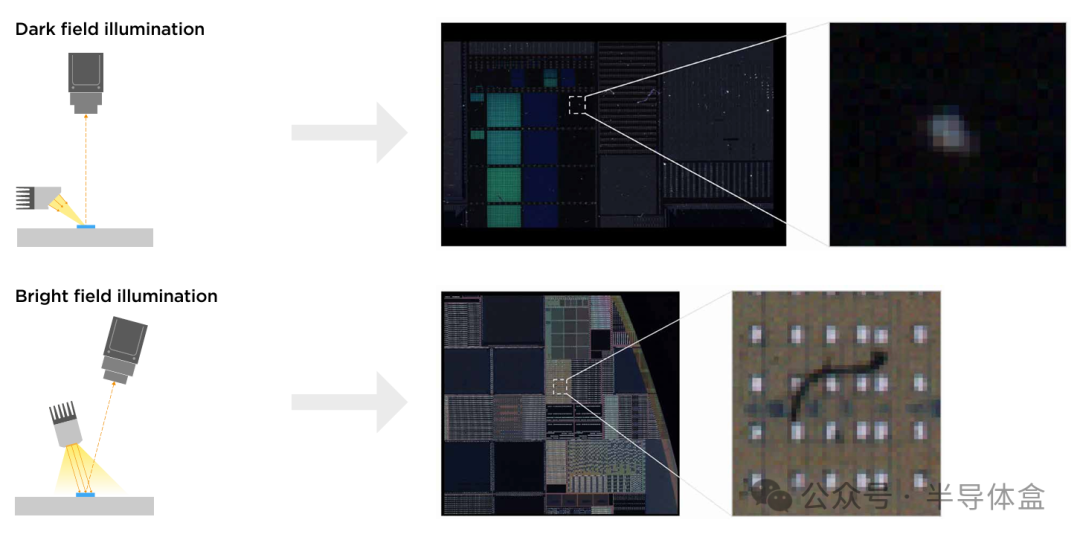
晶圆表面缺陷的光学检测技术,依据其基本光学原理,可分为衍射法、干涉法和散射法。其中,散射法利用缺陷对入射光的散射特性进行缺陷检测,是一种应用广泛的缺陷检测方法,散射法根据照明方法与成像原理等不同又可分为明场散射和暗场散射。尽管明场与暗场均利用了光的散射,但二者在检测原理上存在较大差异。倘若晶圆表面是一个光滑面,其被光线照射时,会发生镜面反射,而事实上晶圆表面存在颗粒等诸多缺陷,会导致部分入射光的反射方向较预定方向发生偏离,即发生散射。明场检测和暗场检测的主要区别就在于,前者检测损失了一部分光强的反射光;后者直接检测散射光。

图2 各照明方式 (From: MKS)
在光学检测系统的设计中,一个重要的考虑是宽带与窄带光源的选择。宽带系统使用光强度极高的灯来提供一系列波长,窄带系统则使用激光来产生单独一个波长。现实中,晶圆厂大多在明场系统中使用宽带光源,在暗场系统中使用窄带光源。
成像原理
反射光或散射光经若干透镜构成的收光系统收集后,由CCD(电荷耦合器件)或PMT(光电倍增管)作为探测器进行记录,将光强信息转换为缺陷信息。在两类光子探测器中,CCD 可以检测一定波长范围内的所有谱线,且可以成像;而一个PMT 只检测单个波长的谱线,因此基于上述照明方法差异,明场系统通常使用CCD,暗场系统则可以使用CCD 或PMT。成像法中,明场系统利用反射光束构造图像,暗场系统则利用反射束之外的散射光构造图像。特别地,基于暗场原理的检测方法除成像法外还包括非成像法,非成像法本身不能直接成像,而是采用PMT 收集晶圆表面缺陷的散射光,通过标准参照物与散射光强度之间的相关曲线将缺陷的散射光强度转化为等效尺寸,进而对得到的结果进行统计与分类。

图3 明场与暗场的成像 (From: biorender)
无图形晶圆一般是指裸硅片或者有一些空白薄膜的硅片(主要用作测试片),其表面的典型缺陷包括颗粒、残留物、刮伤、晶体原生凹坑、裂纹等,这些缺陷会影响后续工艺的加工质量,并最终影响产品的良率。
有图形晶圆是指经过光刻、刻蚀、沉积等关键工艺后形成纳米结构图形的硅片,其缺陷不仅包括纳米颗粒、凹陷、突起、刮伤、断线、桥接等表面缺陷,还包括空洞、材料成分不均匀等亚表面和内部缺陷。这些缺陷是在大批量生产制造过程中,不可避免的工艺误差和环境污染导致的。
无图形晶圆检测
一般来说,暗场检测是无图形晶圆缺陷检测的首选。这是由于当晶圆表面没有图形时,无需进行图像比较,而暗场检测具有高速、高灵敏度的特点,因而具有更高的产能。在检测系统中,激光束径向扫描旋转晶圆的表面,晶圆的旋转位置和光束的径向位置定义了缺陷在晶圆表面X-Y 网格中的位置。
KLA 公司的SP 系列(Surfscan)无图形晶圆缺陷检测设备主要采用了暗场检测方法。其中SP7 缺陷检测系统能够检测 7nm 尺寸的缺陷。以SP1 为例,该系统有倾斜入射和垂直入射两个入射角(Incidence Beam)以及“宽”、“窄”两个信号收集通道(PMT),它们相互组合形成四种检测模式。
由于散射信号的强度分布与缺陷的形状、尺寸、材料,以及基体膜层有关,因而可以依据入射光和收集通道的模式不同对缺陷进行分类。

有图形晶圆检测
有图形晶圆的缺陷检测是一个很慢的过程且相对复杂,需根据具体应用来决定采用明场、暗场,或是二者结合。有图形晶圆检测系统将晶圆上的晶粒与相邻晶粒(或已知的无缺陷的“黄金”晶粒)的图像进行比较,图像处理软件对图像进行扣除处理,在扣除过程中晶粒的任何随机缺陷都不会变为零,反而会在扣除后的图像中清晰地显示出来。在很多情况下,基于照明方法与成像原理等方面的特征,明场系统能够检测到更广泛的缺陷类型。
当前半导体行业主流的硅片图形结构缺陷检测设备仍然是基于明场光学散射原理。典型的明场光学缺陷检测设备采用柯勒照明光路将高亮宽谱等离子体光源光束调制成超均匀、特定光束截面形状的偏振光束;随后利用高NA(数值孔径,用以衡量光学系统能够收集的光的角度范围)低像差的物镜收集硅片结构图形缺陷引起的散射光,再通过折反混合透镜组与变焦透镜组相结合的成像光路将散射光成像至时间延迟积分相机(TDI-CCD);最后利用基于片对片的图像差分处理算法实现缺陷信号的准确识别。

参考资料
文字内容主要摘自《一“明”一“暗”检缺陷,相辅相成提良率》- 光大证券
《半导体工艺 控制设备 ,国产化率不足 5 %%,替代 空间大》- 安信证券

申明:感谢原创作者的辛勤付出。本号转载的文章均会在文中注明,若遇到版权问题请联系我们处理。

----与智者为伍 为创新赋能----

联系邮箱:uestcwxd@126.com
QQ:493826566