
最近,国产SiC MOSFET质量问题感觉有点被“以偏概全”、过度放大了,一定程度影响了整体国产品牌的声誉,但实际上一些头部国产品牌的碳化硅器件质量管控体系还是不错,行业还是要看到和可能近些年国产碳化硅的进步,而且需要给更多的国产品牌一些成长的“时”和“机”。
客观来说,对于在怎么用好或者充分发挥SiC MOSFET的优势,全球企业都在进一步摸索和优化阶段,尤其是在检测SiC MOSFET可靠性问题方面,需要开发出更好的、更高效、更低成本的方式和方法。
前段时间,福特汽车和美国俄亥俄州立大学团队发布的文献《使用新型温度触发方法分析栅极氧化物屏蔽对 SiC 功率 MOSFET 界面陷阱密度的影响》,宣布开发出了一种新颖的温度触发阈值电压偏移 (T3VS) 方法,用于研究1200V平面栅和沟槽栅SiC MOSFET栅氧层SiC /SiO2界面处界面态密度(Dit)。
福特汽车证明了这种方法是可行的,而且不需要详细了解SiC MOSFET器件设计或制造参数,大大降低了检测设备投入和时间成本(获取该文献请加微信:hangjiashuo999)。


加入汽车电驱/电控交流群,请加微信:hangjiashuo888
研发背景:
解决SiC MOS栅氧可靠性问题
福特汽车团队认为,SiC MOSFET具有很多的优势,正在很多领域替代硅基开关器件。但是,与硅基竞品相比,SiC MOSFET器件SiC/SiO2界面处的界面态密度(Dit)几乎高出两个数量级,这会导致出现性能和可靠性问题。
首先,SiC MOSFET的反型沟道迁移率仍在30–50 cm2/V-s范围内,几乎比硅器件(>200 cm2/V-s)低一个数量级。
其次,高Dit会导致阈值电压不稳定,危及SiC MOSFET器件在运行过程中的可靠性。
第三,碳化硅衬底和外延高密度的凹坑和孔洞等外部缺陷,以及氧化物中的污染对栅极氧化物的可靠性造成了重大问题。这些缺陷的存在会导致栅极氧化物内局部电场和电流密度增加,导致SiC MOSFET器件过早失效。
目前,平面栅SiC MOSFET占据市场主导地位,然而,业界越来越关注通道迁移率和短路耐受时间更好的沟槽栅SiC MOSFET器件。但是,相较之下,沟槽SiC MOSFET 的可靠性问题更大,这归因于其设计和制造工艺。
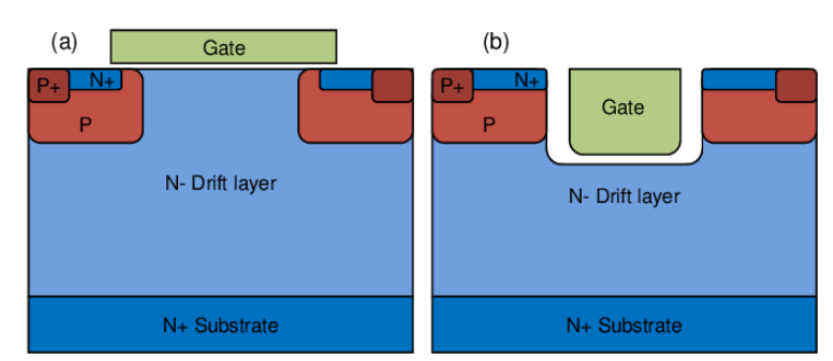
一方面,SiC MOSFET的沟槽角落在高栅极偏置下会发生电场拥挤,导致栅极氧化物可靠性下降;
另一方面,沟槽SiC MOSFET中的栅极氧化物是沉积的,而不是像平面SiC MOSFET那样是热生长,因此氧化物的质量也会受到影响。而栅极氧化物处理技术会影响Dit的变化。
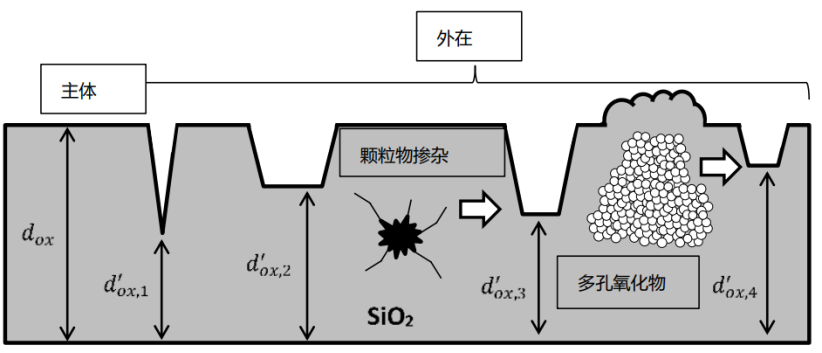
因此,需要实施适当的筛选,以有效消除栅极氧化物质量较差的SiC MOSFET器件。 目前,业界有两种筛选技术:
一种基于高压和高温的筛选技术,该技术可以去除有缺陷的器件,同时静态特性(例如阈值电压Vth)的退化可以忽略不计。但这种方法的筛选条件受限:氧化物场(Escreen)小于9 MV/cm,筛选时间(Tscreen)为100 ms-1 s,这是了防止由于电荷捕获导致Vth发生大幅负向偏移,从而降低筛选效率。
另一种是新的室温筛选方法,称为调整脉冲筛选 (SWAP),该方法的的筛选条件为Escreen ≥9MV/cm,Tscreen为10秒,然后采用8MV/cm的调整脉冲(Eadj)。通过在施加Eadj脉冲的同时释放捕获的空穴,SWAP有助于恢复由于高Escreen 引起的负Vth偏移,因此这种方法可以实现更高效的器件筛选,并且无需高温。
但是,SWAP技术的主要问题是,由于栅极氧化场高,可能会在导带边缘附近引入额外的界面态。而界面态的存在会影响 SiC MOSFET 的可靠性和性能,因此业界已经进行了多项研究,以提取能量相关的Dit分布,尤其是靠近导带边缘的分布。
目前,业界采用了许多不同技术来提取Dit分布,然而,这些技术通常表现出有限的适应性,并且通常需要极其灵敏的设备和/或复杂的测量和提取过程。
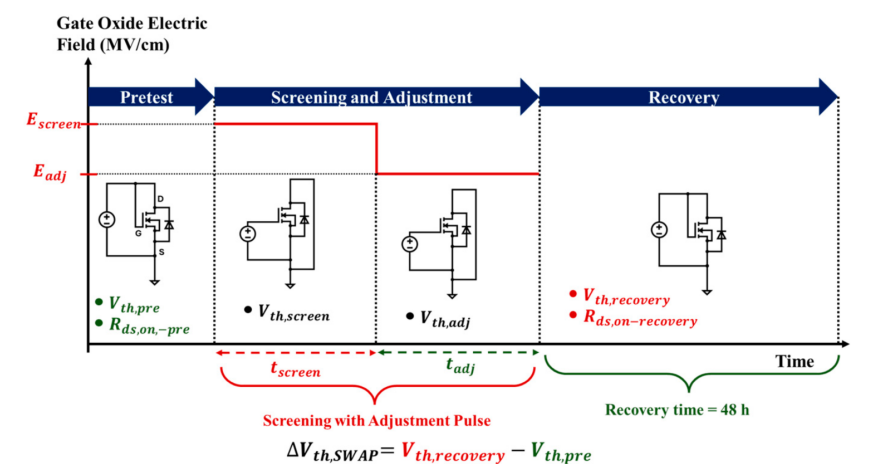
SWAP方法的测试流程。

福特方法:
监测栅压温变,轻松提取Dit分布
福特汽车团队认为,对应他们这些汽车厂商来说,传统的Dit提取方法很复杂,需要精密的仪器、复杂的分析,而更为重要的是,做这些分析需要SiC MOSFET器件设计和制造相关的深度信息,而SiC MOSFET器件的购买方通常无法获得这些信息。
为此,他们希望开发一种新的方法,只需要仅利用SiC MOSFET器件的传输特性,就能很简单地实现Dit数据的提取和分析。
根据文献,福特汽车团队提出了一种新颖而直接的Dit提取技术,他们将它称为温度触发阈值电压偏移(T3VS)方法,并且已经将该方法对多家碳化硅供应商的1200V平面和沟槽栅SiC MOSFET进行了进一步验证。

碳化硅供应商及SiC MOSFET器件规格
该团队表示,在30 K至 450 K的宽温度范围内,在恒定漏极电流为1 µA 的情况下,这种技术通过监测栅极电压随温度的变化,就能来提取非常接近导带边缘的Dit分布。此外,这种方法是可行的,无需详细了解器件设计或制造参数。 该团队还得出2个结论:
一是使用T3VS方法的Dit分析表明,与平面SiC MOSFET器件相比,沟槽SiC MOSFET器件的Dit明显更低,因此它在实际应用中更可靠、更高效。 通过下图可以知道,与具有沟槽SiC MOSFET器件(粉、蓝和绿曲线)相比,平面栅SiC MOSFET器件(红和黑曲线)显示出更高的Dit。因此,沟槽器件在沟道区域中表现出更高的载流子密度。
此外,沟槽器件非常接近导带边缘(ECS-ET) 的较低Dit(~0.05 eV),可提高通道迁移率和阈值电压稳定性,使其在实际应用中更具吸引力。
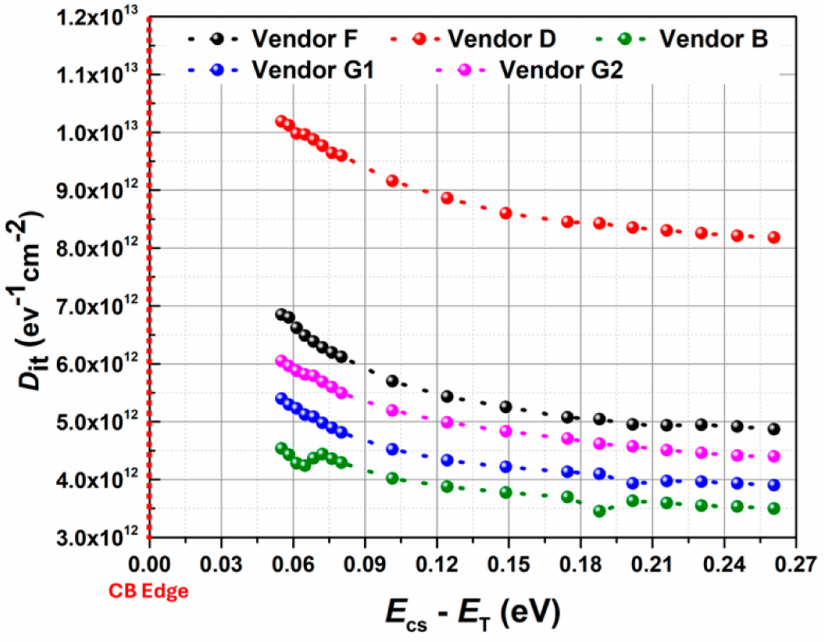
所有供应商器件的Dit提取情况
二是SWAP方法的采用需要谨慎。
福特汽车团队利用这种新颖的Dit提取方法,研究了SWAP方法对平面SiC MOSFET中导带边缘附近界面态密度的影响。结果表明,SWAP 技术本质上具有侵略性,会在导带边缘附近引入新的缺陷状态。因此,在筛选优化过程中需要格外小心,以确保筛选设备在后续应用中的可靠性和可用性。
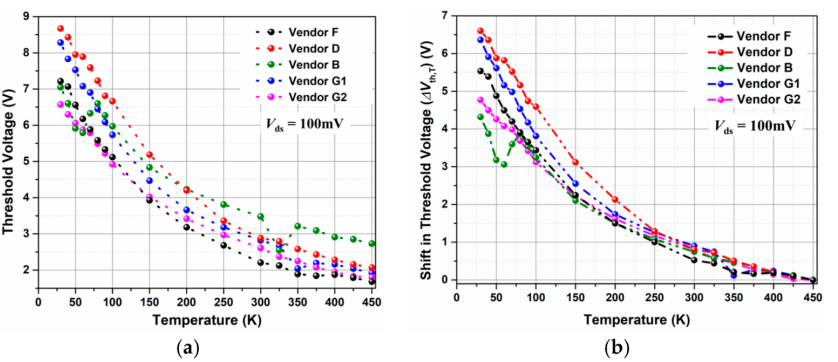
所有SiC MOSFET器件温变时的 (a) 阈值电压和(b) ∆Vth,T情况。
电动交通&数字能源SiC技术应用及供应链升级大会
碳化硅是新能源和工业电气化的技术发展方向,2025年5月15日,“行家说”将在上海举办“电动交通&数字能源SiC技术应用及供应链升级大会”,本届大会将邀请SiC头部厂商、下游终端应用厂家等产业链核心玩家,共同探讨碳化硅在新能源汽车中的技术应用等关键话题。
大会现已开放报名渠道,因会议名额有限,先到先得,欢迎扫码报名参会。同时,活动还有少量演讲和摊位展示席位,赞助咨询请添加微信联系(hangjiashuo888)。

