(本文编译自Semiconductor Engineering)
从平面SoC向3D-IC和先进封装的转变,需要更薄的晶圆,以提高性能、降低功耗,缩短信号传输所需的距离以及驱动信号所需的能量。
对超薄晶圆有需求的市场正在不断扩大。一个由12个DRAM芯片和一个基础逻辑芯片组成的HBM模块的总厚度,仍小于一片原生硅晶圆的厚度。在为人工智能应用组装扇出型晶圆级封装以及先进的2.5D和3D封装方面,薄晶圆也起着关键作用,而这些人工智能应用的增长速度比主流IC要快得多。再加上行业对轻薄手机、可穿戴设备和医疗电子产品的需求,似乎如果没有可靠地加工薄硅晶圆的能力,现代微电子将难以实现。
薄硅通孔(TSV)的显露工艺是一种需要进行背面处理的经典工艺。Amkor Technology先进3D/技术总监Rick Reed表示:“在当前的许多应用中,引入硅通孔需要非常可控的减薄工艺,而且由于几乎总是需要进行背面处理,这一工艺立即需要用到临时键合和解键合工艺。”
任何晶圆减薄工艺的第一步都是确定目标。“如果硅片上有所谓的盲TSV,并且您又不了解晶圆中所有TSV的深度范围,那么就有可能研磨到其中一些TSV,”Reed解释道,“由于铜在硅片中扩散速度很快,它会导致漏电。而且它也会污研磨轮,因此后续的晶圆上就会沾上铜。”
在薄型器件晶圆的减薄和加工过程中,需要做出几个关键决策。哪种临时键合粘合剂与工艺流程最兼容?它能否在包括CMP和高温沉积等多种工艺过程中,将薄晶圆固定到位,并在加工完成后又能被干净地去除?哪种载体晶圆最适合该应用,是硅晶圆还是玻璃晶圆?在几种主流的解键合工艺中,哪种工艺能够在加工完成后以合理的成本最好地去除粘合剂?
尽管有载体晶圆(也称为处理晶圆)提供保护,但超薄晶圆依然脆弱易碎。这使得它们容易受到损坏,在减薄过程中以及在随后的高温工艺(如等离子增强化学气相沉积,PECVD)中出现微碎裂和裂纹。当超薄晶圆经历光刻图案化、PECVD、回流、切割和解键合(去除载体)时,损坏是影响良率的最大威胁。此外,由于晶圆之间的翘曲和/或空隙形成,还可能出现其他问题。
晶圆边缘在斜面处是圆形的,但在减薄后,这一形状会发生变化。“因此,如果你对设备晶圆进行研磨,通常会得到一个非常尖锐的边缘,在理想情况下基本上只有一个原子那么薄,”苏斯公司(Suss)的产品经理托马斯・拉普斯(Thomas Rapps)表示,“它非常脆弱。边缘碎裂意味着边缘的一部分会破裂,也可能引发贯穿整个晶圆的裂缝。因此,为了防止这种情况发生,通常会进行边缘切割,这也需要使用研磨轮。你要在晶圆边缘切割出一个台阶,这个台阶的深度至少要达到最终晶圆的厚度。”
除了处理关键的良率问题,芯片制造商还在寻求适合其特定器件类型的解决方案,而设备可靠性是首要要求。Lam Research产品营销总监Ian Latchford表示:“随着器件越来越复杂,应用也变得越来越具体。客户需要精度,并且希望每次都有可重复的工艺。他们不想要通用的解决方案,而是想要每次都以同样的方式运行且生产率高的解决方案。”
为了满足这些需求,业界正在完善减薄步骤、粘合剂和去除剂的化学成分,以及临时键合和解键合工艺(见图1)。粘合剂通常是一种有机热固性或热塑性材料,通过旋涂的方式涂覆在载体晶圆上,而更薄的解键合材料通常旋涂在设备晶圆上。键合是在真空热压(TCB)或通过紫外线照射来完成的。载体晶圆为设备晶圆的减薄和加工提供了基础,直到在解键合过程中使用去除剂。
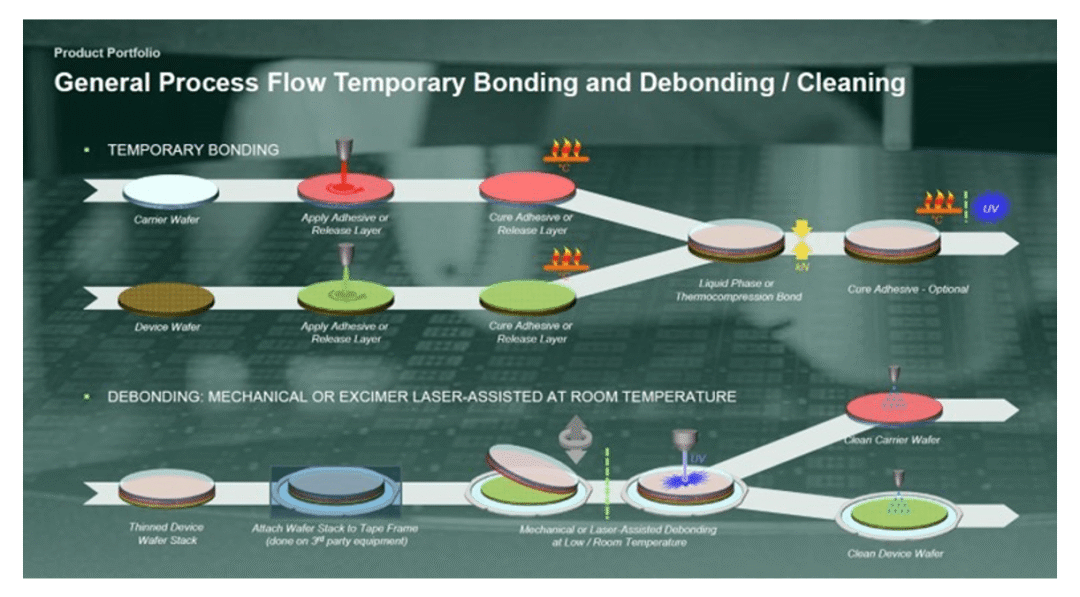
图1:临时键合(上)和解键合(下)的工艺流程。
图源:Suss
硅与玻璃载体晶圆
业界既使用玻璃载体晶圆,也使用硅载体晶圆。玻璃成为流行载体的原因之一是,其热膨胀系数(CTE)可以设计得接近硅的热膨胀系数,从而确保了它与堆叠结构中其他材料的兼容性。例如,硼硅酸盐玻璃的CTE接近硅的CTE,在较宽的温度范围内都很稳定,并且它可以让红外(IR)或紫外(UV)激光穿过其表面,从而激活解键合释放层。
Brewer Science业务开发工程师Hamed Gholami Derami表示:“对于机械解键合和红外激光解键合,根据工艺要求,既可以使用硅载体,也可以使用玻璃载体。但对于紫外激光和光子解键合,则必须使用玻璃载体。”
硅载体晶圆具有吸引力,部分原因在于硅与所有晶圆加工设备和静电吸盘都兼容。硅的CTE与硅器件的CTE完全匹配。硅的最后一个优势是,与玻璃晶圆相比,它能以更低的成本实现更低的TTV(总厚度变化)。
临时键合的工作原理
在将一片晶圆临时堆叠到另一片晶圆上时,工程师通常会使用载体晶圆、“胶水”或临时键合粘合剂,以及便于加工后移除的释放层。在少数情况下,单个粘合剂层即可完成这两项任务。重要的是,键合和解键合机制协同工作,使得加工后的材料从载体上释放后能够别干净地移除。
有多个标准可以衡量一种粘合剂的优劣。它可在低温下实现键合,同时又能经受高温加工。它必须通过旋涂的方式在300毫米的表面上均匀沉积,而且还要实现高度的键合均匀性。
但适用于一种应用的方法可能不适用于另一种应用。Suss的Rapps表示:“主要问题在于,基本上没有一种适用于所有可能工艺流程的解决方案,而材料选择最重要的标准是温度稳定性。在临时键合和去键合之间的下游工艺中,最高温度是多少呢?有很多材料能够承受高达250℃的温度,这是因为如果你进行回流操作,通常不需要高于这个温度。但只有少数材料能够承受350℃的高温。”
旋涂提供了一定程度的工艺灵活性。Rapps表示:“通过旋涂,你可以使材料平整,这样它也可以嵌入某些特征结构。因此,粘合剂有两种功能——作为粘合剂,同时它还能使嵌入的特征结构平整,这些特征结构的表面形貌可能非常低或非常高。因此,在旋涂之后,我们会烘烤晶圆,然后将进行键合。而且通常这种材料需要固化以稳定键合效果,但这确实要具体看所采用的材料解决方案。”
晶圆减薄要点
接下来,晶圆将逐步减薄。要将晶圆减薄至100µm以下,需要在研磨、CMP和蚀刻工艺之间实现微妙的平衡,以满足TTV的严格规范,TTV是晶圆上最厚和最薄测量值之间的差值。对于硅晶圆,通常使用激光干涉仪在晶圆的数百个点上进行测量,而TTV是大批量制造中必须保持的晶圆间和批次间的质量指标。
减薄晶圆有点像打磨木材。先从粗磨开始,然后使用越来越细的砂纸打磨,以获得最光滑的最终效果。对于晶圆,每个步骤都能提高晶圆表明的均匀性,并降低TTV。
西亚系统公司(scia Systems)的产品与技术总监Matthias Nestler解释道:“最粗糙的方法是晶圆研磨步骤,这会使最终的厚度变化范围达到几微米。CMP步骤比晶圆研磨更精确,在这一步骤中,厚度变化可以达到几百纳米。接下来,通过等离子体蚀刻,厚度变化可以达到10到100纳米。或者,以离子束蚀刻作为最后一步,在最佳情况下,我们可以将晶圆的厚度变化缩小到原来的二十分之一,也就是说,250纳米的厚度变化可以减小到25纳米,而且如果采用中间带有测量步骤的两步式修整工艺,我们还能做得更好。”
鉴于总厚度变化的重要性,工程师们热衷于量化减薄和加工过程中的变化因素。“我们在硅通孔(TSV)显露工艺中使用玻璃载体,但即使是能买到最好的玻璃,其晶圆上的TTV也只有1微米,”Amkor的Reed表示,“然后,当我们在上面涂上粘合剂时,这会增加几微米的厚度变化。然后,我们的研磨工艺非常均匀,但仍然会引入大约2微米的TTV。”
干法蚀刻也会引入厚度变化,这种变化可能呈径向分布。“所以总结下来,大约会有5微米的厚度变化。”Reed表示。
确保TSV显露工艺精确的要点包括:
绘制由博世蚀刻法在硅中确定的TSV深度;
均匀旋涂键合粘合胶及解键合释放层,后进行烘烤、固化和键合;
采用粗磨、中磨和细磨方式将硅背面研磨至距TSV底部10微米以内,达到镜面效果;
CMP粗磨、中磨、精磨;
利用等离子蚀显露TSV;
沉积氮化硅薄膜作为抛光终止层;
在TSV顶部沉积厚的二氧化硅层;
再次进行CMP以显露TSV。
另一个需要密切监测的参数是温度。“我们现在正在对CMP工艺的温度进行原位控制,总体来说,这对CMP工艺有很多好处,”Axus Technology首席执行 Dan Trojan说道,“主要的温度限制因素是由聚氨酯制成的抛光垫的玻璃化转变温度。当超过此温度时,聚合物会从液体变为固体,此时摩擦力会大得多,并且很快就会出现问题。所以我们有一种方法可以在不稀释研磨液的情况下对加工垫表面进行基本冷却,这也有助于提高去除率。我们还使用多区膜载体在晶圆上局部施加不同的压力,而不是只施加一种压力。”
目前,硅中介层最常见的TSV架构可能采用直径11微米、深度110微米的TSV,其中阻挡金属层和氧化物绝缘层占了1微米的直径。尽管已经证实能够制造例如深度55微米、直径5微米的TSV,但目前业界似乎仍坚持使用更厚、更昂贵的100微米硅中介层。
处理背面和边缘缺陷
在薄晶圆工艺中,工程师面临的最常见问题是如何防止缺陷或微裂纹,尤其是在晶圆边缘。
仅在晶圆边缘进行的选择性等离子蚀刻有助于去除边缘缺陷,而选择性CVD可以钝化边缘。“在3D封装领域,堆叠的晶圆结构需要一些材料来填充边缘的间隙,”Lam Research的Latchford表示,“由于CMP过程中产生的边缘滚降现象,器件制造商在边缘轮廓方面遇到了很多问题。然后他们必须对器件晶圆进行减薄处理,最终可能会导致边缘开裂,这对良率产生严重影响。所以实际上,我们在此处沉积了几微米厚的二氧化硅薄膜,以便在键合晶圆的工艺流程应用中填充间隙。”
等离子蚀刻或离子束蚀刻工艺还可以消除CMP过程中引起的任何缺陷,例如压表面划痕、所谓的凹坑(硅晶格中的凹痕)和污渍。
寻找正确的释放方法
对于解键合工艺,紫外线和红外线激光烧蚀以及光子解键合已成为主要的机械分离机制,因为它们与大型薄晶圆格式(300毫米晶圆,50µm厚)兼容,并且与热滑动和化学浸没方法相比,能够在对器件造成最小损伤的情况下分离晶圆(见图2)。

图2:最流行的晶圆解键合方法。
图源:Brewer Science
热滑动解键合使用熔点较低的聚合物,即热塑性塑料,这种聚合物在受热时会流动,以便于滑动和分离。遗憾的是,这种方法与诸如金属PVD或电介质的PECVD等热工艺不兼容,因为这些热工艺会产生强大的应力,可能导致晶圆破裂。热滑动解键合还会使器件受到不必要的更多热暴露,因为其它解键合方法可在室温下进行。尽管如此,热滑动解键合仍是一种低成本方法,对于较小且稍厚的衬底来说,仍然是一种有用的选择。
化学溶解的工作原理是将键合对浸入溶剂中,穿孔载体晶圆可以帮助加快该过程。溶剂消耗量大和处理量低阻碍了化学解键合方法的广泛应用。
光子解键合是一种相对较新的解键合方法,它使用脉冲宽带光源,通过将光吸收层作为无机金属释放层,来使临时键合的晶圆对实现解键合。光子解键合的一个优点是,与激光烧蚀方法相比,它的成本更低、处理速度更快,并且对释放层焦距的变化容忍度较高。这使得它适用于具有一定翘曲或弯曲的键合晶圆对。对于那些将基板减薄到20µm以下,并使用非常高的下游温度工艺(在这种工艺中,粘附力和TTV的控制至关重要)的应用,光子解键合可能是一种首选的解键合方法。
机械解键合(又称机械剥离)是将刀片插入晶圆对之间,以物理方式将它们分离。这种方法要求器件晶圆能够承受一定的物理应力。
激光烧蚀使用紫外线激光(254、308或355nm)或红外线(1064nm)激光,再配合调谐到相应波长的释放层,通过吸收照明能量、发生化学变化并实现分离。它是最快的解键合方法,每小时大约可以处理20到30片晶圆,对晶圆产生的应力也很小。但是,可能需要一个屏蔽层,来减少激光声波对器件造成的任何损害。
结论
晶圆减薄、临时键合、薄晶圆加工和解键合方法,正成为2.5D和3D封装、晶圆堆叠和晶圆级扇出型封装中必不可少的工艺步骤。芯片制造商正在与供应商密切合作,选择合适的粘合剂、释放材料、键合机、解键合方法、研磨、CMP、蚀刻和清洁工艺,从而能够以高良率和可靠性生产出厚度小于50µm的超薄器件。这需要热稳定性、机械稳定性和对晶圆边缘的关注,在运用这些关键的薄晶圆工艺时,所有这些要素都是降低潜在缺陷、提高良率所必需的。
END