不知道各位电源行业的工程师们,平时工作中是否遇到了下列问题:
1. 芯片规格书上面提供的热阻参数,能直接用到我的电路板上吗?
2. 我用芯片规格书上面标的热阻参数计算芯片内部结温,怎么感觉算出来的和实际对不上?
3. 我测量芯片的OTP温度,是从芯片外部加热,我怎么保证芯片内的的温度和外部温度差异很小?
要回答这几个问题,其实并不容易,需要对芯片的热阻、热特性等的测量原理、测量标准、影响因素彻底、深入的了解。本文揭秘这其中的秘密。
1. 实际的热阻数据示例
通常在IC的技术规格书中都会提供IC热阻相关的信息。但是,所提供的热阻类型和设置可能会因IC的种类不同而略有不同。下面是500mA输出LDO线性稳压器的技术规格书中提供的热阻信息示例。

这款IC有两种封装,因此提供了每种封装(TO263-5、TO252-J5)的热阻。这两种封装都是带散热片的5引脚表贴型封装。下面来看一下具体内容。如Note 1所示,该热阻数据符合JESD51-2A(Still-Air)标准。提供的热阻为以下两种:
・Junction to Ambient:θJA(℃/W)
・Junction to Top Characterization Parameter:ΨJT(℃/W)
此外,还给出了每种热阻在两种电路板条件下的值,一种是安装于1层电路板上,另一种是安装于4层电路板上。1层电路板如Note 3所示是符合JESD51-3的电路板,4层电路板是符合JESD51-5和7的电路板(Note 4)。表中列出了每种电路板的条件。
2. 热阻与实装电路板之间的关系
在上例中,作为热阻条件,明确列出了JESD51中规定的实装电路板的条件。这意味着热阻不仅仅由IC封装决定,很大程度上还受到其实装电路板条件的影响。近年来,表贴型封装的应用非常广泛,在考虑IC的热阻时,必须要考虑到实装电路板的散热(降低热阻)情况。仅根据封装的热阻进行热计算是不现实的。
该图显示了每种热阻(θJA、ΨJT)与散热用的铜箔面积之间的关系。这是用于测试的封装为背面带散热片的8引脚SOP型封装、铜箔面积为15.7mm2到1200mm2条件下的数据。其他因素还包括电路板层数、材料和铜箔厚度等,不过在这个关系示意图中,请将这些因素视为条件相同,在此前提下来看铜箔面积与热阻之间的关系。
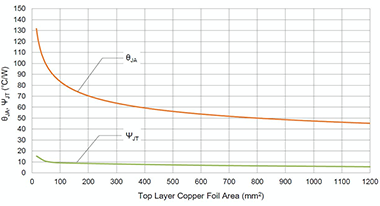
在本例中,从IC的结点(芯片)经由实装电路板到环境(大气)的热阻θJA和铜箔面积的关系非常显著。实际上,需要确保散热所需(即适当的θJA)的铜箔面积,以免在使用条件下超过Tjmax。反之,如果未明确说明所提供的热阻的条件,则必须要确认其条件。上例中的数值表明,热阻会因条件不同而有很大不同。
3. 热阻数据:热阻和热特性参数的定义
θJA和ΨJT的定义:
θJA(℃/W):结点-周围环境间的热阻
ΨJT(℃/W):结点-封装上表面中心间的热特性参数
为了便于具体理解这两个概念,下面给出了表示θJA和ΨJT的示意图。
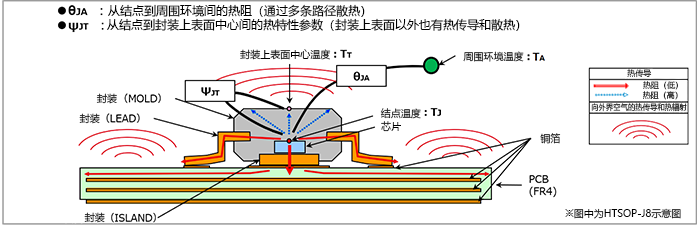
θJA是从结点到周围环境之间的热阻,存在多条散热路径。ΨJT是从结点到封装上表面中心的热特性参数。
此外,还定义了结点与封装上表面之间的热阻θJC-TOP和结点与封装下表面之间的热阻θJC-BOT,如下图所示。请注意,θJC-TOP和ΨJT之间存在细微差别,即“封装上表面”和“封装上表面中心”的差异。

这些均在JEDEC标准的JESD51中进行了定义。下表中汇总了每种概念的定义、用途及计算公式。

※1:环境温度(TA)是指不受测试对象器件影响的位置的周围环境温度。在发热源的边界层的外侧。
※2:θJA和ΨJT是实际安装在JEDEC电路板上时的数据。
※3:θJC-TOP和θJC-BOT根据JESD51-14(TDI法)标准测试。
从上述可以发现,热阻和热特性参数在JEDEC标准的JESD51中进行了定义。每种热阻和热特性参数均有对应的基本用途,计算时使用相应的热阻和热特性参数进行计算。
4. 热阻数据:估算TJ时涉及到的θJA和ΨJT
鉴于近年来电子设备中半导体元器件的实际安装条件,一般认为通过θJA进行热设计是比较难的。近年来难以统一TA的定义,实际往往需要单独定义。通常,在半导体器件安装密度很高的设备中很难实测TA。近年来,根据比较容易实测的TT和ΨJT来估算TJ已成为主流方法。接下来将分两次来探讨在进行TJ估算时如何使用θJA和ΨJT。另外,还将单独介绍使用了热阻数据的TJ估算示例。
4.1 θJA和ΨJT
下表是上文中提到的θJA和ΨJT相关的重点内容。θJA是从结点到周围环境之间的热阻,存在多条散热路径。ΨJT是从结点到封装上表面中心的热特性参数。ΨJT的计算公式中包含的TT是封装顶面中心的温度。

表格中建议的用途是θJA:“形状不同的封装之间的散热性能比较”,ΨJT:“估算在实际应用产品中的结温”,下面来思考一下这样建议的原因。
4.2 关于θJA
在热设计中,有一个讨论:“θJA可以应用于热设计吗?”从结论来看,可以认为使用θJA来进行热设计是存在困难的。其主要原因如下:
●TA的温度是哪里的温度?
最终还是需要通过估算TJ的温度来进行判断。使用θJA计算TJ时,需要环境温度TA。
TA的温度是由JEDEC Standard定义的。以下是用来参考的JEDEC Standard:
▸JESD51-2A Integrated Circuits Thermal Test Method Environmental Conditions – Natural Convection (Still Air)
TA基本上是在JEDEC指定的位置测量的,但有些制造商可能会单独提出TA测量条件。
另外,JEDEC Standard是在不受发热影响的空间前提下来定义TA的,但近年来设备的安装情况越来越复杂,出现了是否真的存在不受发热影响的空间的讨论。
●高密度安装趋势
如上一项所提到的,由于安装密度越来越高,IC和其他发热器件拥挤在电路板上。很容易想象,现实中由于与目标相邻的IC等器件的热干扰导致温度升高,因此很难判断认为是TA的位置的温度是否真的是TA的温度。

●θJA随有效散热范围的变化而变化
表面贴装型封装的IC,其技术规格书中的θJA会提供散热用的铜箔面积、电路板的材质和厚度等条件。因此反过来也可以说“θJA根据实装条件而变化”。右图是表示θJA和IC贴装部的表面铜箔面积之间的关系的数据示例。从图中可以明显看出,随着铜箔面积的增加,θJA变小了,但是θJA的变化并不是线性的,而且如果没有提供这样的图,根据实际电路板的相应面积估算θJA是相当困难的。很遗憾的是,并不是每个制造商都会提供这样的图表。
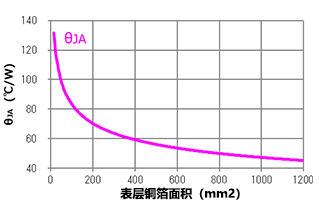
基于这些情况,尤其是在近年来的实际情况下,通常认为使用θJA进行热设计是很难的。近年来,逐渐成为主流的TJ估算方法是实际测量目标产品封装顶面中心的温度TT,并根据ΨJT计算TJ。
4.3 关于ΨJT
ΨJT表示相对于器件整体的功耗P的、结点与封装顶面中心之间的温度差的热特性参数。下图是表示TJ和TT的示意图。由于TT是封装顶面中心处的温度,即芯片顶部表面温度,通常可以在实装设备的实际工作状态下使用热电偶或热成像仪等设备进行测量。
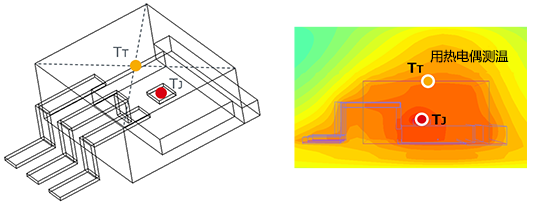
只要能够获得TT的数据,就可以通过变换前面给出的ΨJT的公式来求得TJ。
ΨJT=(TJーTT) / P ⇒ TJ=TT+ΨJT×P
“ΨJT×P”是TJ和TT之间的温差,因此将其与TT相加得到TJ。
4.4 不同条件下θJA和ΨJT的特性及有效性
由于ΨJT是一个表示相对于器件整体的功耗、结点与封装顶面中心之间的温度差的热特性参数,因此可以用来推算实际工作状态下的TJ。然而,有一些实际工作条件会影响θJA和ΨJT,并会影响它们在TJ估算过程中的有效性。下面举几个例子来探讨它们各自的特性和有效性。
●电路板散热性能的变化
右图表示电路板表层铜箔面积与θJA和ΨJT之间的关系。θJA受铜箔面积(即流入PCB的热量)的影响很大,而ΨJT由于器件的大部分热量都会流入PCB,因此TJ-TT间的温差非常小,故ΨJT的值和变化也都很小。由于θJA会因实装电路板的条件不同而有很大变化,因此很难直接用于估算TJ,但ΨJT不会因PCB的差异而有较大变化,所以是可以使用的。
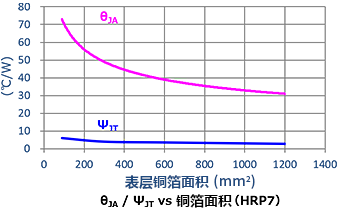
●被屏蔽罩等覆盖的状态
出于EMC对策等原因,目标器件可能会有使用屏蔽罩覆盖的情况。下面是使用和不使用屏蔽罩时实测的θJA和ΨJT结果比较。
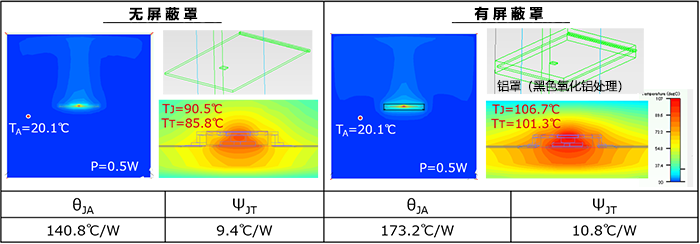
有屏蔽罩时,θJA和ΨJT均会上升,但θJA的波动较大,无法用于估算TJ。而ΨJT的上升量很小,原来的值也很小,波动也很小,即使直接用于TJ计算也不会造成太大的误差。例如,使用无屏蔽罩的ΨJT=9.4℃/W,来计算有屏蔽罩的TJ结果如下,与实际温度106.7℃相比,误差在1%以内。

●被树脂密封并被屏蔽罩等覆盖的状态
为了起到保护作用,有时会将电路板上的实装元器件进行树脂密封。在这里,假设是不仅被树脂密封还被屏蔽罩等覆盖的情况。
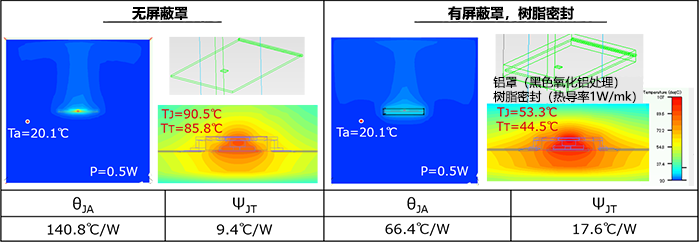
θJA受密封树脂影响,热阻显著降低,在这种条件下,θJA不能用于TJ计算。ΨJT呈上升趋势,波动较大。使用没有树脂密封和屏蔽罩时的ΨJT=9.4℃/W,计算有树脂密封和屏蔽罩时的TJ,结果如下。

与实际温度53.3℃相比,误差约为8%。这就需要探讨是否允许这个程度的误差,或者纠正误差后用于TJ的计算。
●成为热源的元器件彼此相邻的状态
虽然应该避免这种情况,但在元器件实际安装过程中产生热量的元器件还是可能会彼此相邻。下面是两者具有适当的距离(中间图)时和它们彼此相邻(右图)时的θJA和ΨJT结果比较。
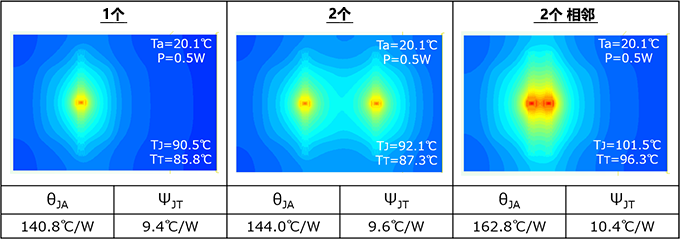
从数据可以看出,当元器件距离很近时,θJA和ΨJT均上升,但θJA的波动较大,不能用于TJ的估算。当然,ΨJT也有波动,但由于其值原本就小,波动也很小,因此即使用于TJ的估算也不会造成太大的误差。例如,使用一个元器件时的ΨJT=9.4℃/W,计算两个相邻状态下的TJ时,结果如下,与实际温度101.5℃相比,误差在1%以内。

●电路板层数变化时
下图显示了当电路板的层数发生变化时,θJA和ΨJT的变化情况。
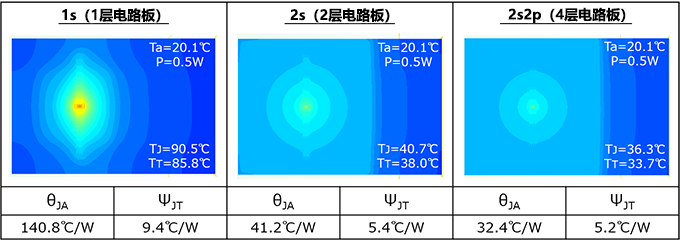
随着电路板层数的增加,θJA下降显著,但即使在这种情况下,θJA也不能用于TJ的计算。ΨJT的波动也很大,作为示例,使用1s(1层电路板)时的ΨJT=9.4℃/W,计算2s2p(4层电路板)时的TJ,结果如下。

与实际温度36.3℃相比,误差约为6%,这就需要探讨是否允许这个程度的误差,或者是否需要纠正误差。
5. 总结
上文在实际应用产品中安装时可能会有的4种条件下,比较了θJA和ΨJT。结论是受铜箔和电路板等散热条件的影响,以及相邻元器件的热干扰影响,在应用产品中很难将θJA用于TJ的估算。而ΨJT虽然会因安装条件而变化,但由于其值原本就很小,而且在某些条件下的波动也很小,因此通过掌握所使用的电路板和应用产品的状态,并高精度地测量TT,可以将提供的ΨJT值用于实际使用时的TJ估算。
三者的适用环境
当知道参考(即环境,箱子或板)温度,功耗以及相关的θ值时,可以计算结温。Theta-JA通常用于安装在环氧基PCB上的部件的自然和强制对流空气冷却系统。当封装具有直接安装到PCB或散热器的高导热封装时,Theta-JC非常有用。而Theta-JB则适用于与封装相邻的板的温度已知时的应用场景。
除了这些Theta热阻之外,Ψ-JB(结到板)和Ψ-JT(结到顶部)热特性参数有时也是比较有用的。对于在板上通电的器件,这些Ψ信息显示图结温和电路板温度或“封装顶部”温度之间的相关性。术语“Ψ”用于将它们与“θ”热阻区分开,因为θ不是所有的热实际上在温度测量点与Ψ之间流动。由于这个原因,所以它们不是真正的热阻,而是热特性参数。
ΨJB对θJB区别:
希腊字母“Ψ”用于区分ΨJB和θJB,因为并不是所有的热量实际上在温度测量点(即结点和板)之间流动,类似于θJB。这是因为ΨJB测试的设置不会像θJB那样强制所有热流从板子流过。因此,ΨJB不是“真正的”热阻。使用ΨJB测试,器件热量可以从封装顶部和底面同时散出;因此Ψjb将总是具有比θJB小的值。然而,事实证明,对于大多数常见的中小型包装,这两个值将是相似的 - 通常在15%内。因此,有时报告ΨJB代替θJB。
ΨJT和θJC区别:
值得注意的是,ΨJT与θJC不同,只有当封装表面安装到散热器上时才适用。测试方法和结果值是非常不同的。事实上,如果在同一封装上测量ΨJT和θJC(在顶表面处),则ΨJT通常将远小于θJC。希腊字母“Ψ”用于帮助清楚地区分ΨJT和θJC热电阻。在自然对流下,塑料封装的ΨJT通常是相对较低的值。这意味着TJ通常只比包装顶部TT稍热。管芯仅通过塑料封装的薄区域与顶表面物理分离。因此,除非顶部被气流强行冷却,否则它们之间将有非常小的温差。较薄型的封装的自然对流ΨJT值通常小于1℃ / W。并且ΨJT值还会因周围风流速度的变化而发生变化。

电源入口加磁珠,出事了

如何测量运算放大器的输入电容以尽可能降低噪声

扫码添加客服微信,备注“入群”拉您进凡亿教育官方专属技术微信群,与众位电子技术大神一起交流技术问题及心得~