
国芯网[原:中国半导体论坛] 振兴国产半导体产业!
大模型时代,AI芯片搭载HBM(高带宽存储芯片)内存已是业内共识。在人工智能算力需求爆发的当下,HBM凭借其3D堆叠架构与超高带宽性能,已成为AI芯片、数据中心及超算领域的“性能倍增器”。然而,HBM核心制造技术长期被海外巨头垄断,高端装备几乎完全依赖进口。
北京华卓精科科技股份有限公司(以下简称“华卓精科”)面向HBM芯片制造的核心环节,自主研发出多款系列高端装备,包括:混合键合设备(UP-UMA®HB300)、熔融键合设备(UP-UMA®FB300)、芯粒键合设备(UP-D2W-HB)、激光剥离设备(UP-LLR-300)、激光退火设备(UP-DLA-300),突破国产HBM芯片“卡脖子”困局,为中国存储产业自主化注入硬核动能。
HBM通过垂直堆叠多层DRAM芯片并与逻辑芯片互联,实现每秒数TB的带宽跃升,但其制造面临多个技术壁垒:
1). 精度极限:芯片堆叠需亚微米甚至几十纳米级对准,否则将导致互联失效或信号衰减;
2). 工艺复杂度:混合键合需同时实现介质层与金属层的原子级融合,工艺稳定性要求极高;
3). 工艺品质极限:DRAM是HBM的基础,HBM对DRAM芯片品质及可靠性要求极高,尤其是SNC结构的结晶质量对芯片良率具有决定性作用,激光退火工艺可以直接实现Void Free,大幅提升良率;
4). 良率与成本挑战:超薄芯片堆叠给良率和成本都带来挑战,芯粒键合及激光剥离给整体工艺流程优化带来更多可能;
5). 规模化量产:随着HBM3/4堆叠层数增至12层以上,传统热压键合良率骤降,混合键合成唯一技术路径。
当前,全球HBM市场由SK海力士、三星、美光主导。而中国HBM产业链在关键设备端国产化率不足5%,成为制约国产存储芯片突围的最大短板。华卓精科瞄准这一战略缺口,以自主可控的装备矩阵,为中国HBM企业提供“弯道超车”的利器。
根据HBM面临的技术壁垒,主要集中于DRAM的品质及多层DRAM堆叠的对准精度,华卓精科推出了高端装备矩阵,给出了成套关键工艺解决方案,具体如下:
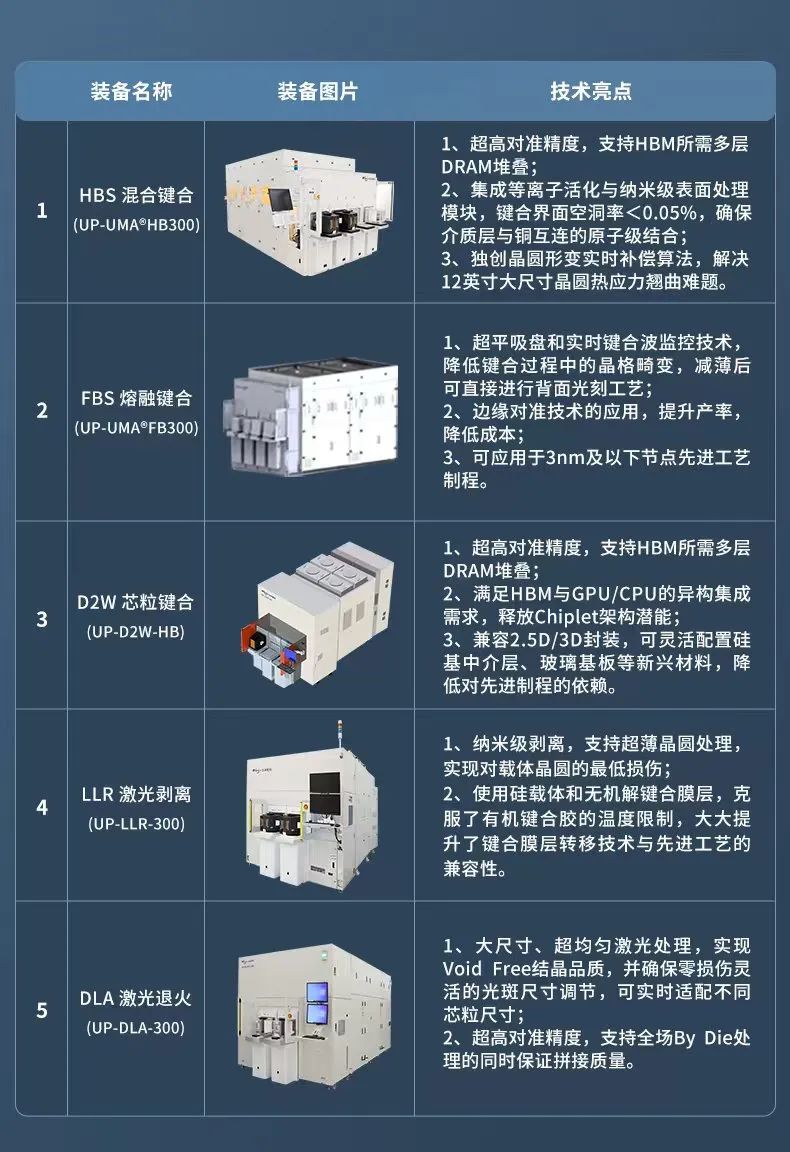
面对美国对华半导体设备的持续封锁,HBM国产化已上升至国家信息安全战略高度。华卓精科依托20余年储备的超精密测控技术、核心专利、及国家级博士后科研工作站等研发实力,以“零部件-设备-工艺”全链条自主创新作为核心驱动力。华卓精科推出的高端装备矩阵,不仅填补关键设备国产化的空白,更会推动中国存储产业从“替代进口”向“定义标准”跃迁,持续引领技术迭代。
选择华卓精科,共攀存储技术珠峰!
***************END***************
爆料|投稿|合作|社群
文章内容整理自网络,如有侵权请联系沟通
投稿或商务合作请联系iccountry
有偿新闻爆料请添加微信
iccountry