三星电子和SK海力士对于“移动HBM”的技术策略有所不同。在堆叠低功耗DRAM以实现与高带宽存储器(HBM)相似性能的下一代存储器产品中,三星电子选择了性能和稳定性,而SK海力士则选择了成本效益。
在“设备上 AI”核心存储器市场,三星与 SK 正在 HBM 封装方法上展开较量。
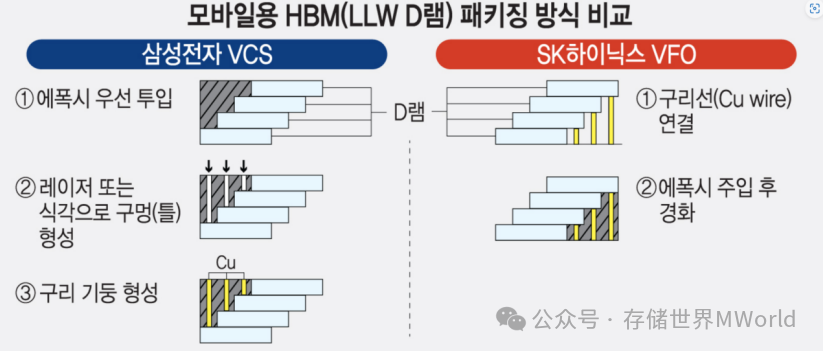
业界消息人士2月16日透露,三星电子正在开发下一代DRAM,以最大限度地提高人工智能(AI)智能手机和个人电脑的计算性能。它是通过堆叠LPDDR DRAM来大幅增加输入/输出(I/O)端子的产品,也被称为“低延迟宽输入/输出(LLW)”DRAM。
可以确认,三星电子一直致力于确保移动HBM的性能和稳定性。三星电子此前宣布将使用铜柱连接堆叠的 DRAM。
这就是“VCS(垂直铜柱堆叠)”方法,即将从晶圆上切割下来的 DRAM(芯片)以台阶形状堆叠起来,用环氧材料使其硬化,然后在其上钻孔并用铜填充。
另一方面,SK海力士选择铜线而不是铜柱。它在连接元件和工艺顺序方面与三星电子不同,它使用铜线连接堆叠的 DRAM,然后将环氧树脂注入空白处以使其硬化。
它被称为“VFO(垂直线扇出)”,类似于当前使用MUF材料填充 DRAM 堆栈之间的间隙以实现 HBM 的方法。
两家公司的结构相似。但据报道,根据工艺顺序和组件的不同,产品稳定性、性能、成本和生产率存在显著差异。
首先,以三星电子的案例来说,由于将环氧树脂钻入模具中,因此可以形成坚固的铜柱。具有优异的产品稳定性,有利于创造更多的输入/输出端子。然而,它非常耗时且昂贵,因为它需要使用蚀刻或激光钻孔并使用电镀形成铜柱,关键是确保价格竞争力。
SK Hynix 使用一种称为“引线键合”的工艺来连接铜线,这比钻孔更容易、更经济。然而,在环氧树脂填充过程中,细铜线可能会被推挤或脱落。
因此,MUF方式HBM在开发初期就提出了DRAM之间微凸块(焊球)损坏的问题。 SK Hynix通过改进MUF和工艺进步解决了这个问题,但这也成为了移动HBM必须解决的课题。
半导体封装行业一位资深人士表示,“总而言之,三星优先考虑产品的完美性,而 SK 海力士则优先考虑成本效益,现在判断谁更有市场价值还为时过早,因为每个客户都有不同的要求。”
两家公司的技术战略差异值得关注,因为它们可能会改变移动 HBM 市场的格局。正如数据中心市场的HBM技术差异决定了AI市场的主导地位一样,移动HBM作为搭载于智能手机、PC、XR耳机等的AI用存储器而备受瞩目,预计将对设备上AI市场产生直接影响。
三星电子和SK海力士均计划今年完成技术开发,并于明年开始量产移动 HBM。
存储芯片交流群
