
----追光逐电 光引未来----
光电共封装(Co-Packaged Optics,CPO)是一种新型的光电子集成技术。光电共封装基于先进封装技术将光收发模块和控制运算的专用集成电路(ASIC)芯片异构集成在一个封装体内,形成具有一定功能的微系统。光电共封装技术进一步缩短了光信号输入和运算单元之间的电学互连长度,在提高光模块和 ASIC 芯片之间的互连密度的同时实现了更低的功耗,是解决未来大数据运算处理中海量数据高速传输问题的重要技术途径。
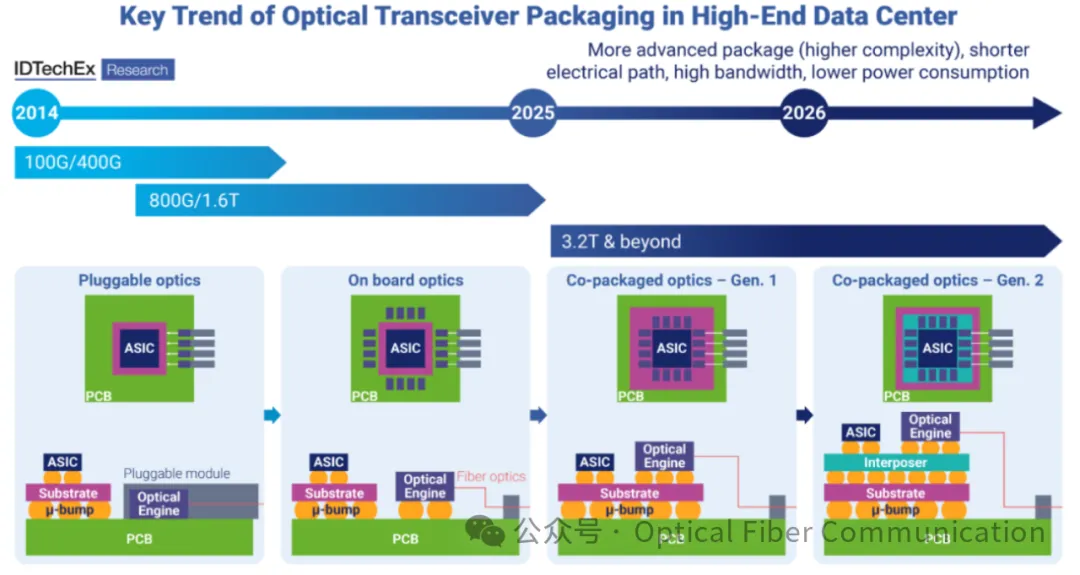
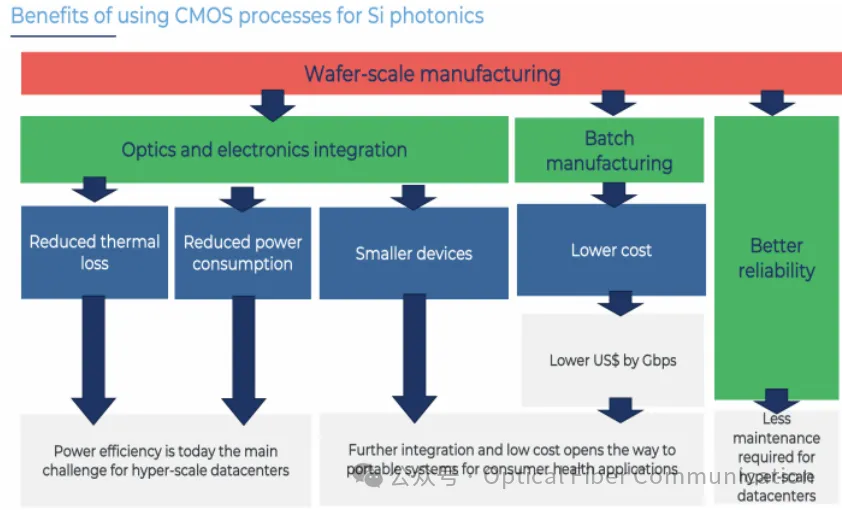
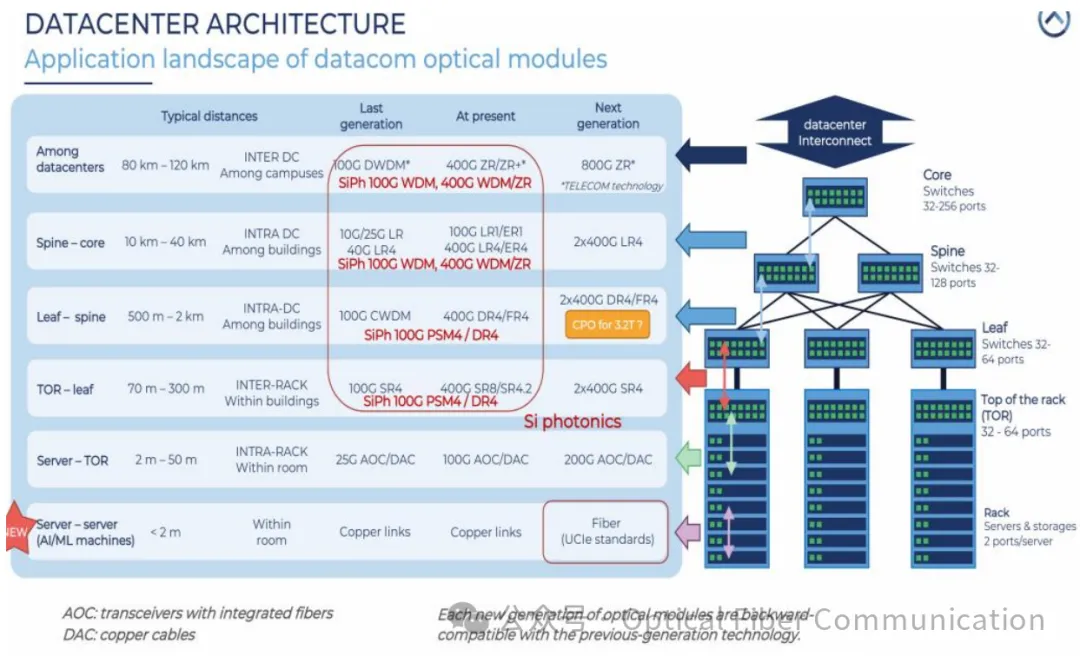

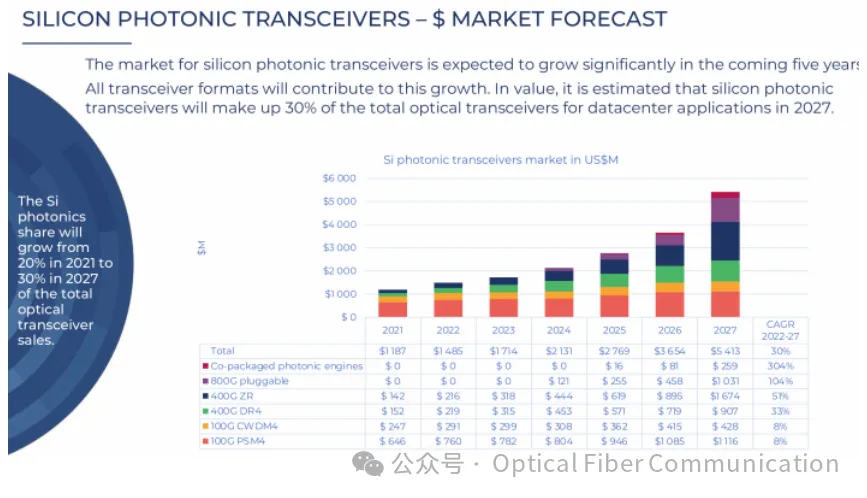
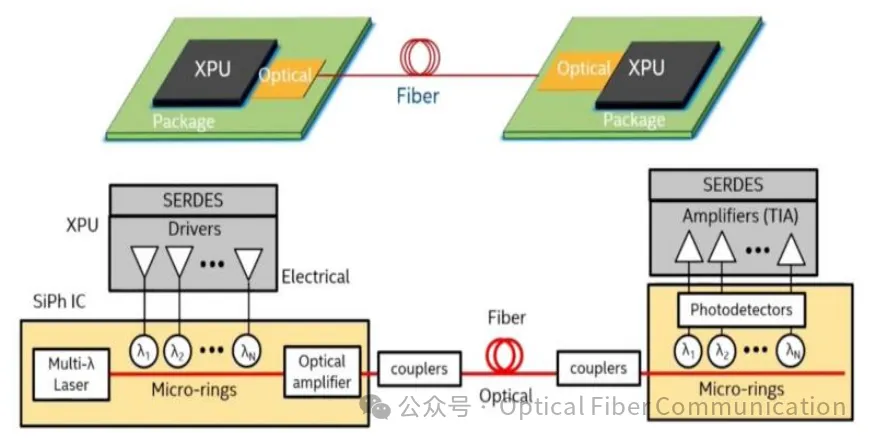



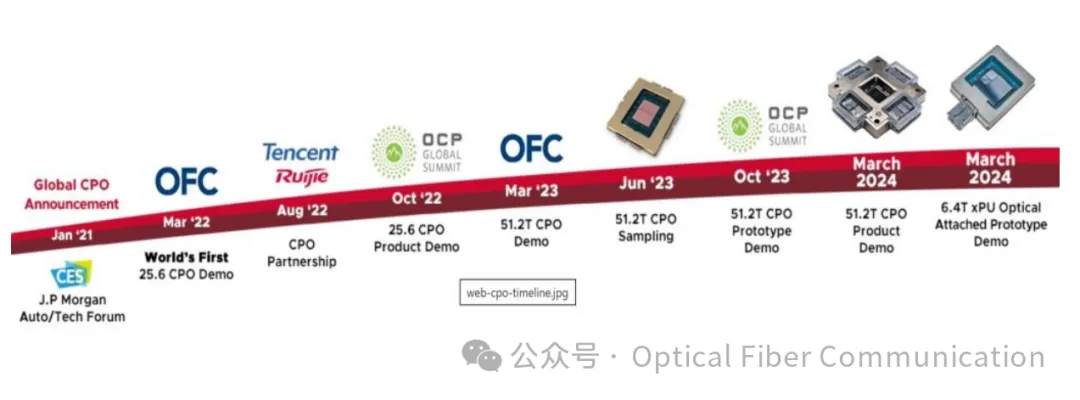
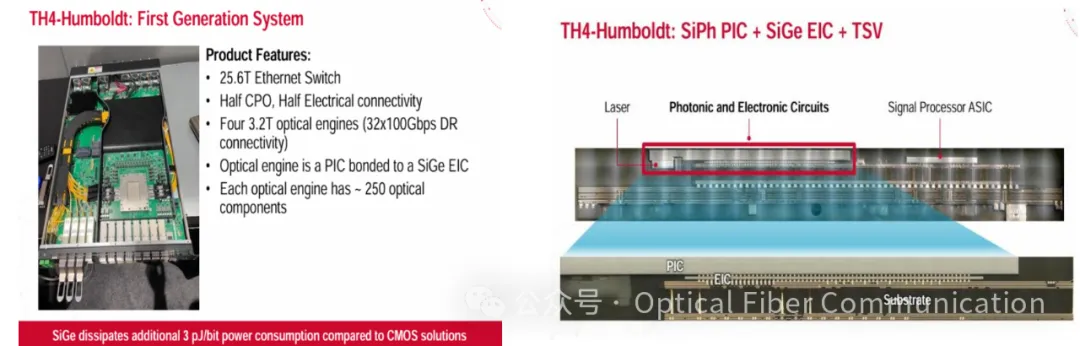

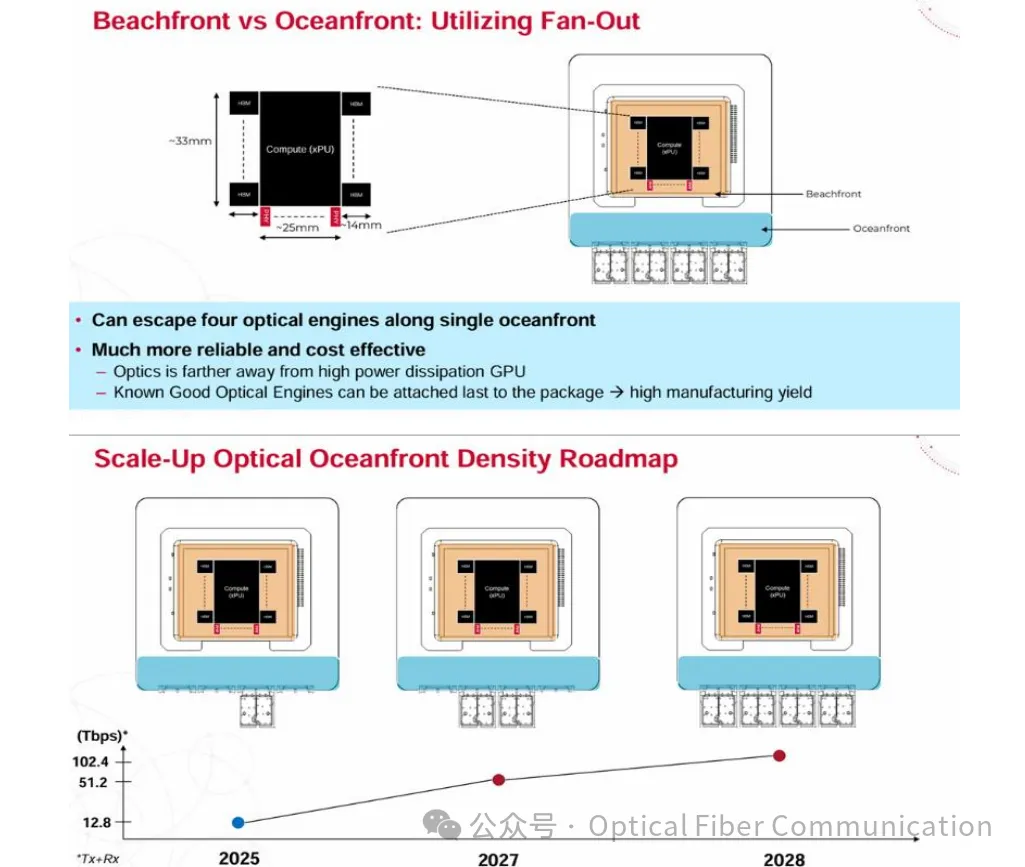

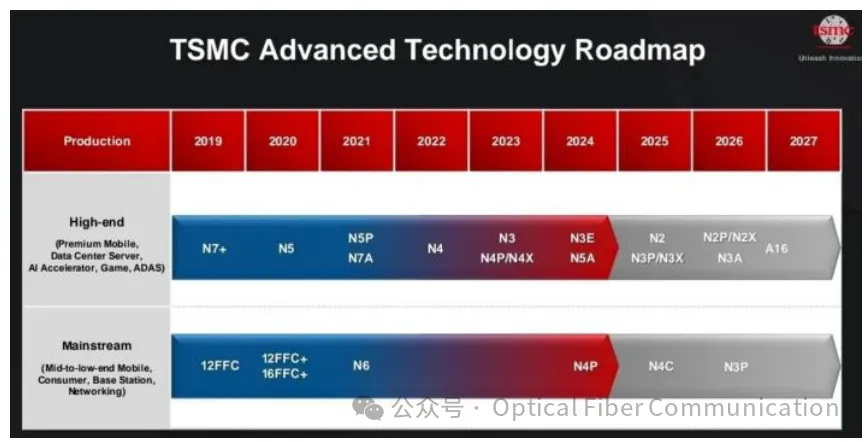
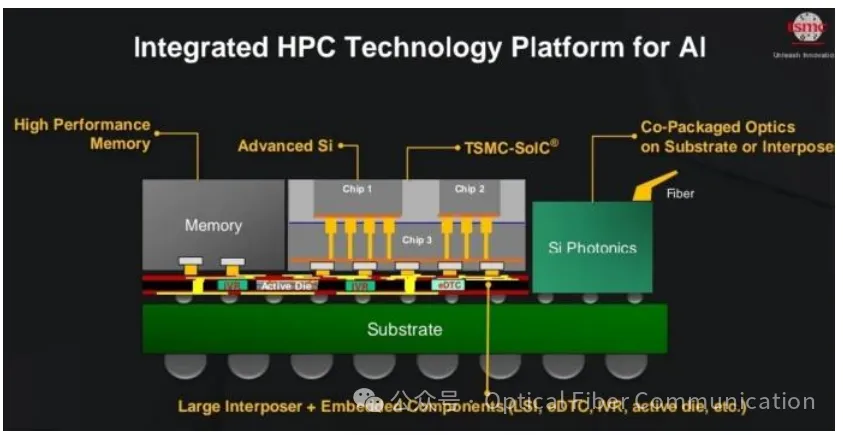

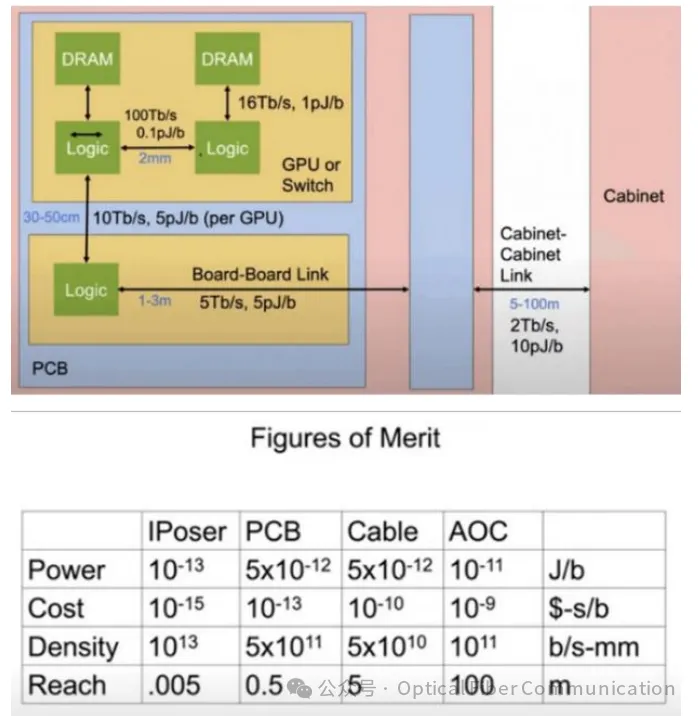
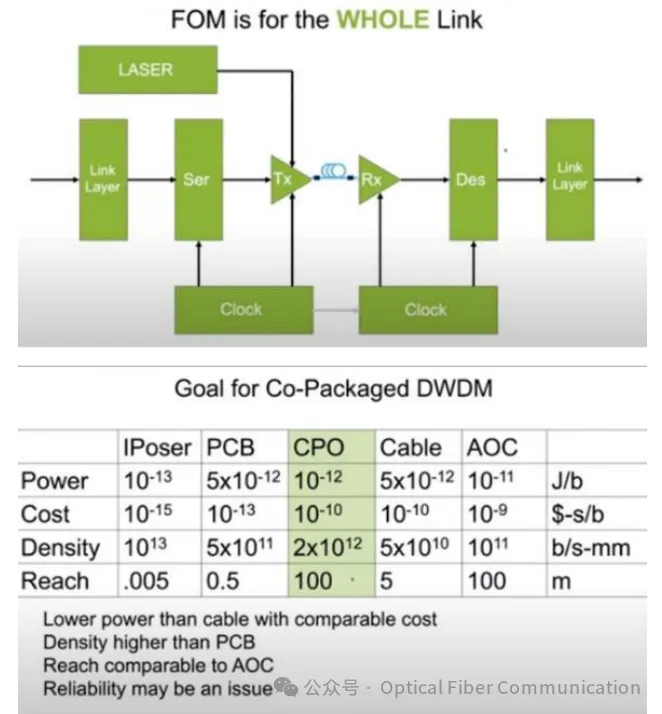
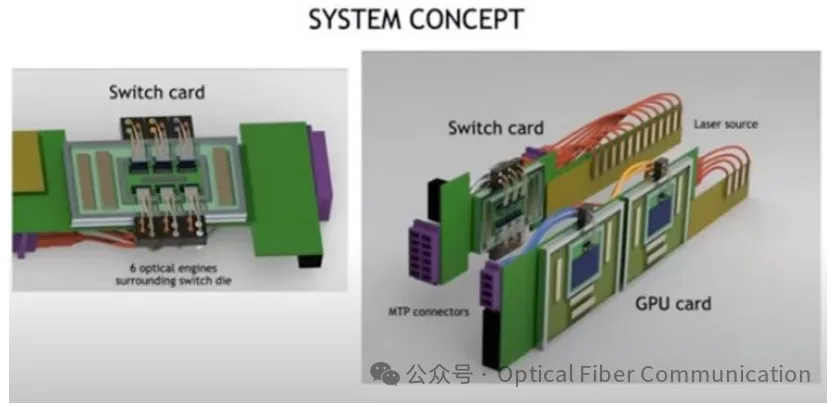
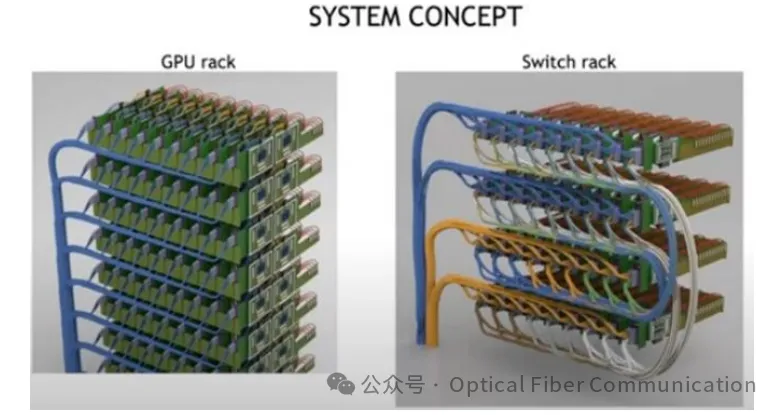
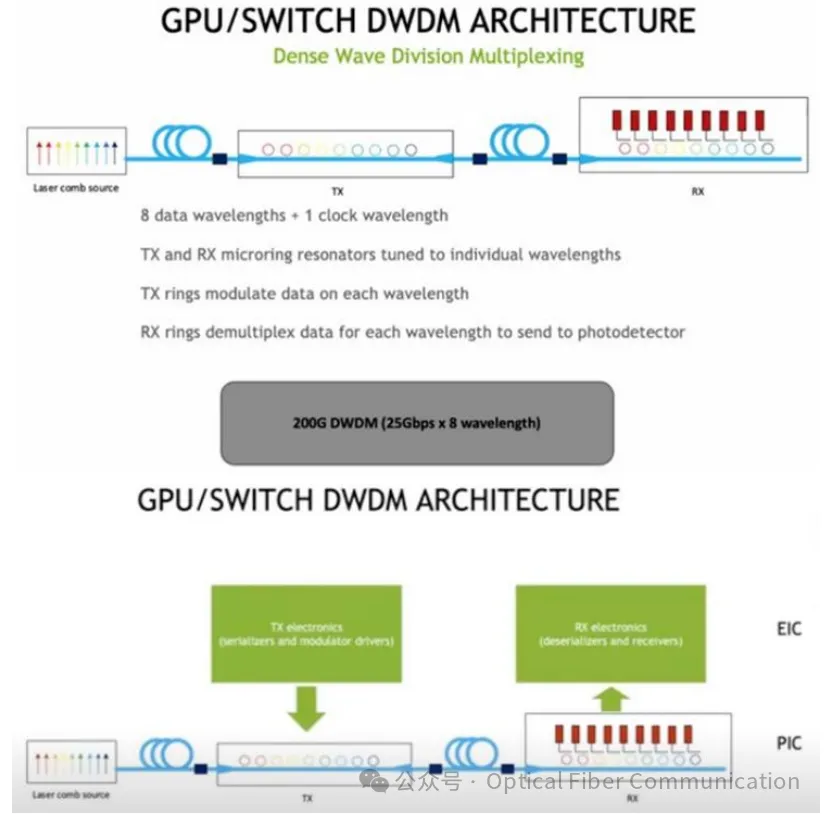

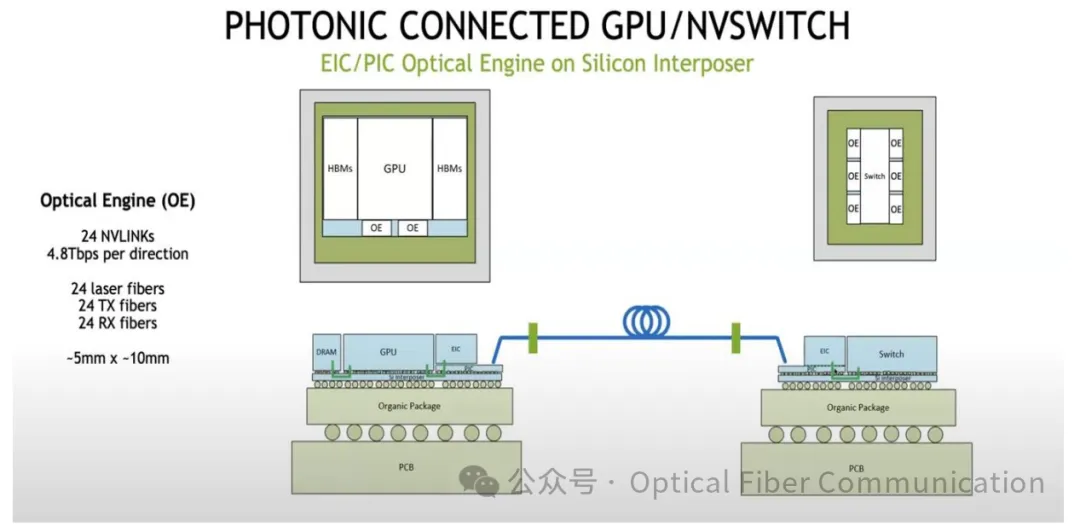

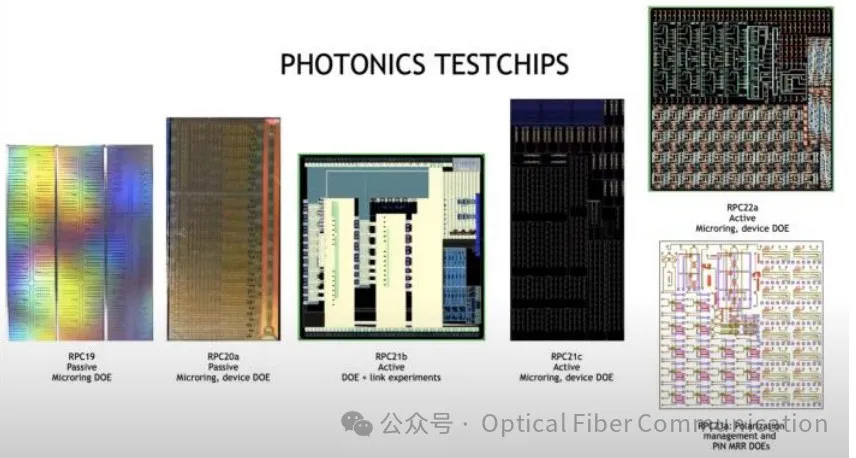
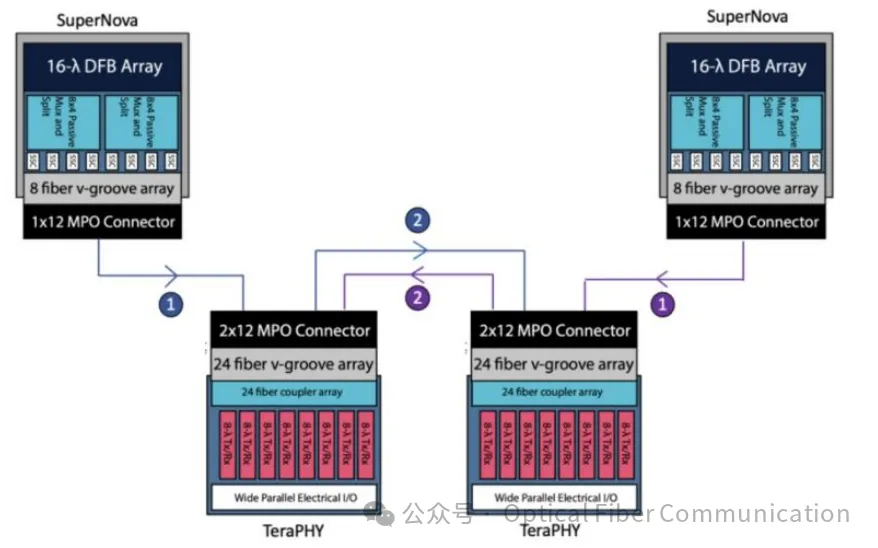
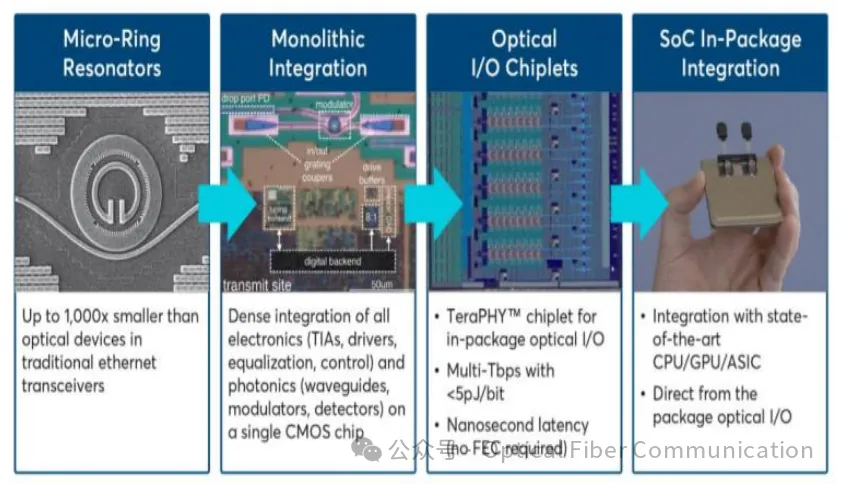

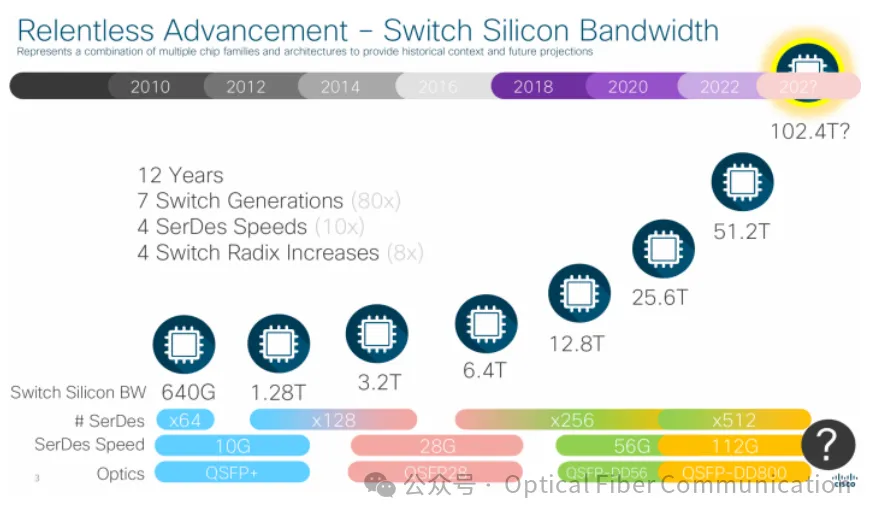




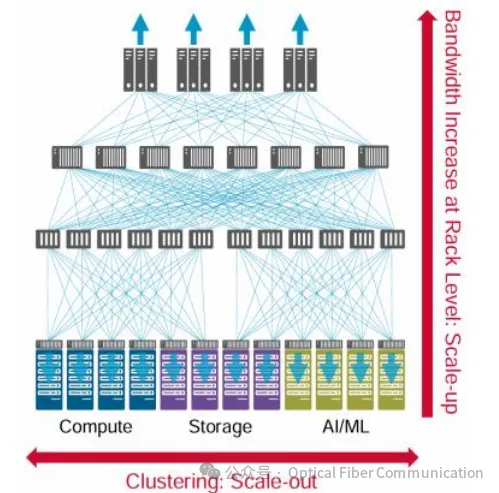
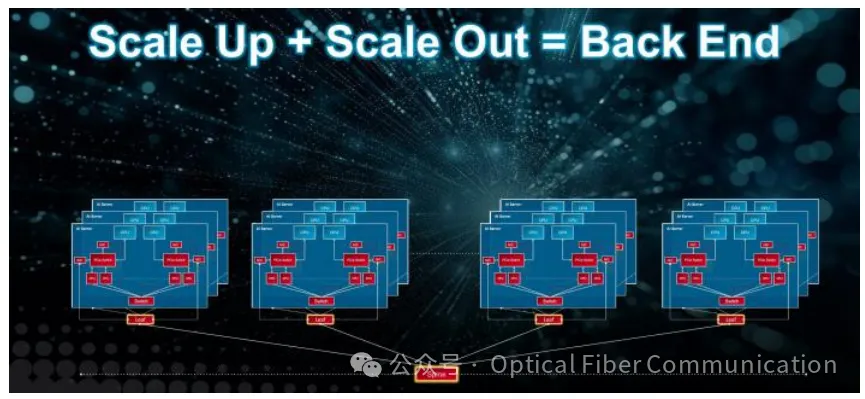
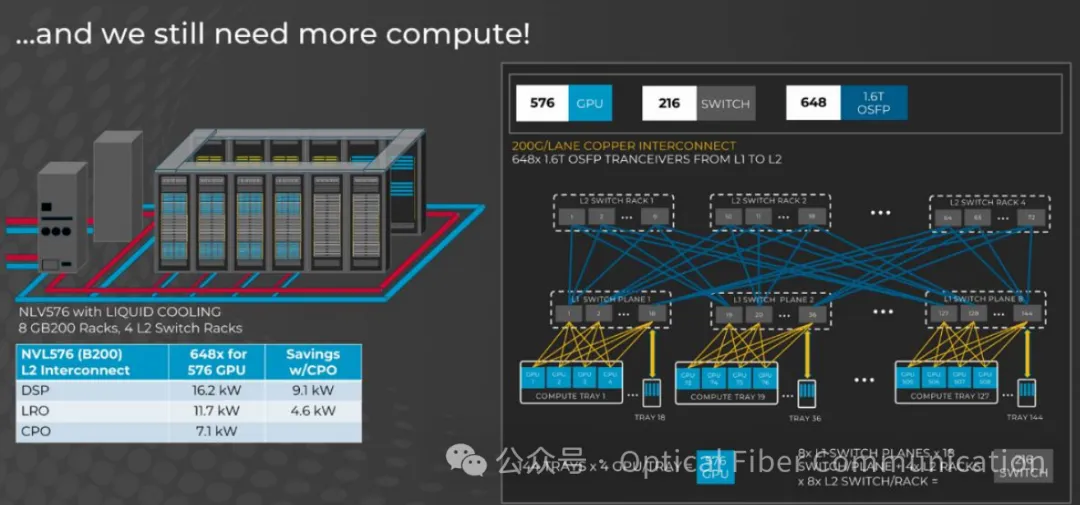
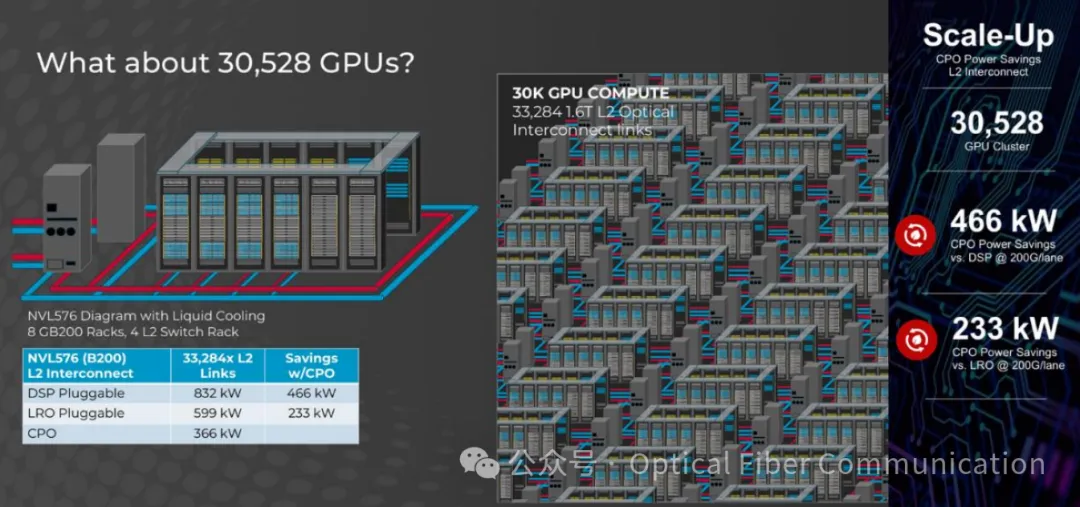

申明:感谢原创作者的辛勤付出。本号转载的文章均会在文中注明,若遇到版权问题请联系我们处理。

----与智者为伍 为创新赋能----

联系邮箱:uestcwxd@126.com
QQ:493826566