
生成式AI的发展带来第四次工业革命,通过半导体异质集成的3D封装及制程节点(Node)微缩技术的日益创新,我们正亲眼见证AI时代到来。
AI 所使用的IC芯片(AI芯片)是Al的硬件核心。台积电逻辑先进技术已实现单一芯片上超过2000亿个晶体管,且预期未来通过异质集成的3D封装,单体3D封装的Al芯片产品将超过1万亿个晶体管。在复杂IC电路中,AI芯片最重要的内嵌存储器就是SRAM (Static Random-Access Memory,静态随机存取内存或称静态随机存储器),这种内嵌的SRAM,也被称作嵌入式SRAM。
嵌入式应用的SRAM两项重要特点:首先,SRAM常常是Al芯片中构成读写的最快的内存寄存器(Register)及快取存储器(Cache,又称高速缓冲内存)的主要内存。其次,SRAM 的制程结构通常也是 AI 芯片制程中最小尺寸及最密集区域。因为尺寸小,同样面积内芯片可以容纳的内存数量就更多,相对成本降低。所以SRAM在AI芯片的地位就不言而喻。
目前最先进AI芯片使用的制程节点,已迈入3nm制程,于2025年及2026年将陆续有2nm及16Å(埃)的制程节点的产品上市,因此SRAM仍会是AI芯片的重要存储器。
SRAM(静态RAM)是随机存取内存的一种。「静态」的意思是指,只要保持通电,SRAM 中的数据就能持续保存。然而,一旦电力供应停止,数据将会消失,因此属于挥发性内存(Volatile Memory)。这点不同于断电后仍能保存数据的只读内存(ROM)或闪存(Flash Memory)。
SRAM 的电路结构根据晶体管数量可分为多种设计,如 4T、6T、8T 或 12T 等,其中 6T 是最常见的设计。6T SRAM 的「T」代表晶体管(Transistor),而「6T」指的是该单元由 6 个 MOS(金属氧化物半导体)晶体管组成。
6T SRAM 的基本电路由 2 个 PMOS 和 4 个 NMOS 晶体管构成。根据功能,不同的晶体管又可划分为 PU(上拉晶体管)、PD(下拉晶体管)、PG(传送门晶体管)等组件,如图一所示。这种设计使得SRAM成为AI芯片中重要的内存组件,具有高速、高效的存取特性。

▲ 图一 6T SRAM 的电路及各部名称
AI 芯片的检测分析方法多样,可大致分为以下三类:
1.电性测试 (Electrical Testing)
2.电性故障分析 (EFA, Electrical Failure Analysis)
3.物性故障分析 (PFA, Physical Failure Analysis)
其中,PFA 进一步包含 表面分析 (Surface Analysis) 和化学分析 (CA, Chemical Analysis)。若以医学检查作比喻,电性测试就像一般的健康检查,对芯片进行全面性的初步评估,而其他测试则是针对具体问题进行深入分析(见图二)。
嵌入式 SRAM 区域的检测分析尤为重要,因为其结构和性能直接影响 AI 芯片的稳定性与效率。本文将进一步探讨SRAM结构的观察与分析技术,深入解析其在芯片检测中的应用与挑战。
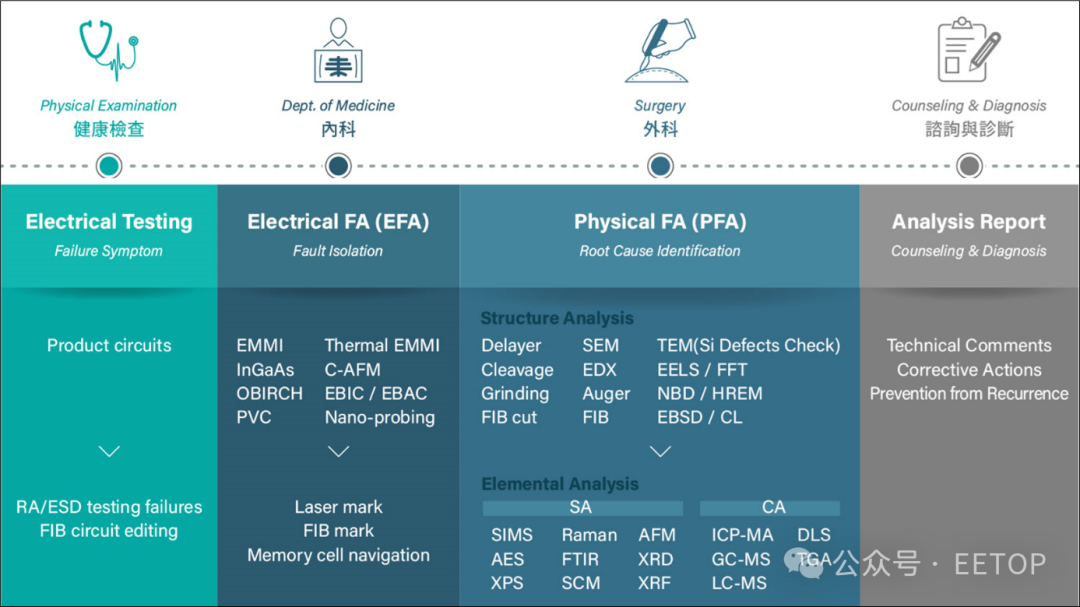
▲ 图二 医学中心的检验与 IC 检测分析比较
SRAM 主要结构观察工具包:
OM(Optical Microscope 光学显微镜)
SEM(Scanning Electron Microscope 扫描式电子显微镜)
DB-FIB(Dual Beam Focused Ion Beam 双束聚焦离子束显微镜)
TEM(Transmission Electron Microscope 穿透式电子显微镜或称透射式电子显微镜)
这些分析设备皆可观察 AI 芯片中 SRAM 制程结构,不过依据显微镜特性各自观察范围有所差异(如图三)。一般而言,使用OM大区域范围观察,找到目标区在芯片中的大致位置,接着使用SEM或FIB观察,把目标区域限缩在更小的区域,最后FIB配合SEM可以做精确位置的定位观察,FIB也是TEM试片制备的重要工具。
若 SEM/FIB 无法看清楚最终目标,最后才使用 TEM 或 Cs-TEM 观察。TEM 可观察纳米级微小区域结构。Cs-TEM(球面像差校正 TEM)是目前市面上可以达到 0.5 Å(埃,10000000000 Å)=1米)空间分辨率的设备,也就是 Cs-TEM 是目前放大倍率最高的设备。此外,SEM 和 TEM 还可搭配 EDS (Energy-Dispersive X-ray Spectroscopy,能量散射 X 射线谱),进行区域成分分析,为结构观察提供更深入的材料分析信息。
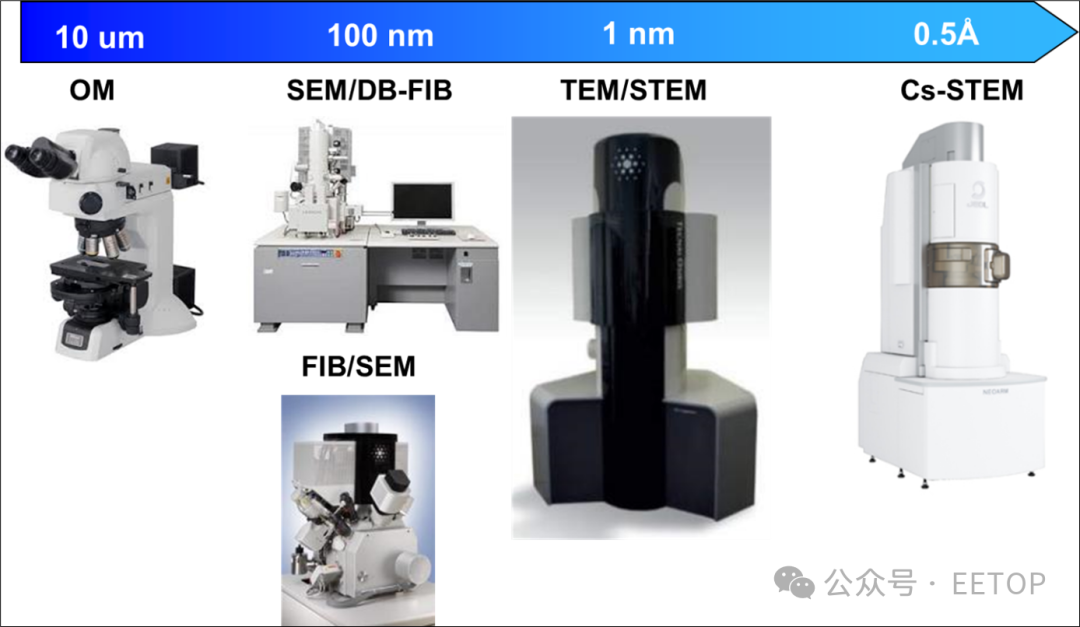
▲ 图三 OM/SEM/TEM 与观察范围
由于SRAM是AI芯片中最小尺寸且最密集的区域,其存储器结构通常呈现重复排列,这个特征使得辨识SRAM区域更为可信及可靠。如图四所示,通过OM(光学显微镜)观察芯片,可以初步找到嵌入式SRAM的大致区域,其中部分SRAM区域以蓝框标示出来。锁定 SRAM 的大略位置后,能够进行更精细的电性测试与物性分析。
除了OM外,红外线显微镜(IR,Infrared Microscope)和SEM(扫描式电子显微镜)也是寻找嵌入式SRAM区域的常用工具。这些工具的辨识方式与OM类似,但SEM的优势在于其放大倍率较高,更适合于确认SRAM的细节结构。相比之下,OM 的放大倍率有限,有时无法清楚辨识复杂或极小的区域结构,因此需借助 SEM 进一步确认。
通过这些观察工具的结合,可以有效地精确定位 SRAM 区域,为后续的深入分析奠定基础。

▲ 图四 为使用 OM 观察芯片的嵌入式 SRAM 区域范围。部份 SRAM 区域如蓝框所示
SEM (Scanning Electron Microscope,扫描式电子显微镜) 是通过聚焦电子束扫描样品表面来生成图像的电子显微镜,通常用于观察尺寸大于 100 nm 的结构。SEM 有多种应用,其中主要用于观察样品的表面结构。此外,SEM配合FIB (Focused Ion Beam, 聚焦离子束) 构成的DB-FIB (双束聚焦离子束显微镜),也将于下一章说明。
在本节中,我们将介绍 VC (Voltage Contrast, 电压对比) 技术。VC 是利用 SEM 或 FIB 的一次电子束或离子束扫描芯片表面,藉由区域间的电势差产生不同的明暗对比。当电子束通过不同电势的表面时,不同区域会呈现出不同的亮度,这种现象即为 VC。其技术原理可参考资料 [2]。
SRAM 包含 PMOS 区及 NMOS 区。在特定电压操作下,通常 SEM 扫描在IC的通孔 (Via) 或接触窗 (Contact) 区时,就会有 VC 效果。在低电压操作下,SEM 观察到的 PMOS 区的 via/contact 亮度最亮,NMOS 区的 via/contact 亮度次之,若有结构位置在闸级区 via/contact,则此区域呈现最暗。图五为 SEM 扫描在 SRAM 的 contact 区域造成不同的明暗对比。

▲ 图五 SEM 扫描在 SRAM 的 contact 区域造成不同的明暗对比。
聚焦离子束显微镜(FIB,Focus Ion Beam)是一种高精密的纳米加工工具,以镓(Gallium,Ga)作为离子源,熔点为29.76°C,在此温度下,其蒸气压极低(低于10⁻¹³ Torr),非常适合在真空环境下操作。使用时,液态镓会沿着灯丝流向针尖。在外加电场足够强的情况下,液态镓会被拉伸成曲率半径小于临界值的圆锥体(即 Taylor cone),从而产生镓离子束。这种束流的直径可达10 nm以下,能量分散约4.5 eV,亮度则高达10⁶ A/cm²·sr,因此可用于极精密的纳米结构加工,也被称为「纳米雕刻刀」。
当电子束系统与FIB整合后,即成为双束聚焦离子显微镜(DB-FIB,Dual Beam FIB),同时具备扫描式电子显微镜(SEM)和FIB的功能。SEM能有效帮助定位目标区域,并提供高解析影像观察,而 FIB 则负责精确切割,不会破坏其他样品区域。这种双重功能让DB-FIB在半导体制程与分析中发挥关键作用,特别是在制备穿透式电子显微镜(TEM)的试片时,能以纳米级的精度进行切割。
图六展示了DB-FIB中电子束 (E-beam) 和离子束 (I-beam) 的相对位置示意,说明了这些束流如何与样品互动。通过这种结构,DB-FIB 可以精准切割并制备超薄的TEM 试片,为深入观察提供便利。图七则呈现了DB-FIB用于SRAM结构分析的应用范例。从图中可同时看到制程的前段区 (FEOL,Front End Of Line) 和后段区 (BEOL, Back End Of Line),这对于工程师深入理解制程细节大有助益。
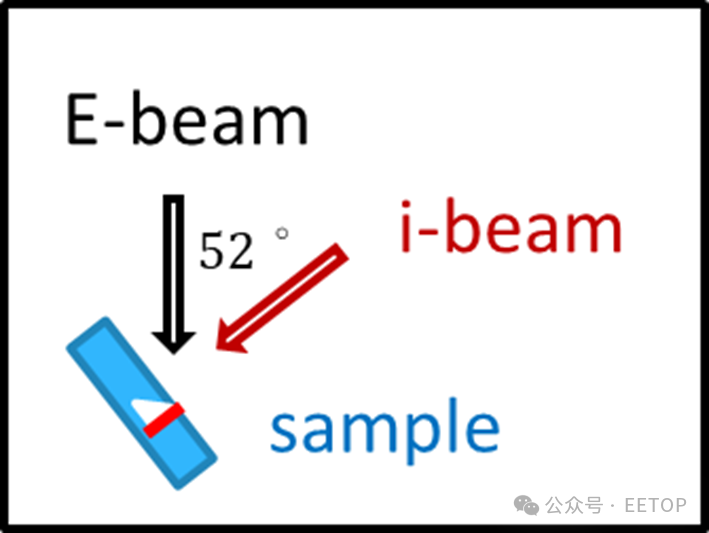
▲ 图六 DB-FIB 的 SEM (E-beam) 与 FIB (i-beam) 与样品的相对位置示意图。
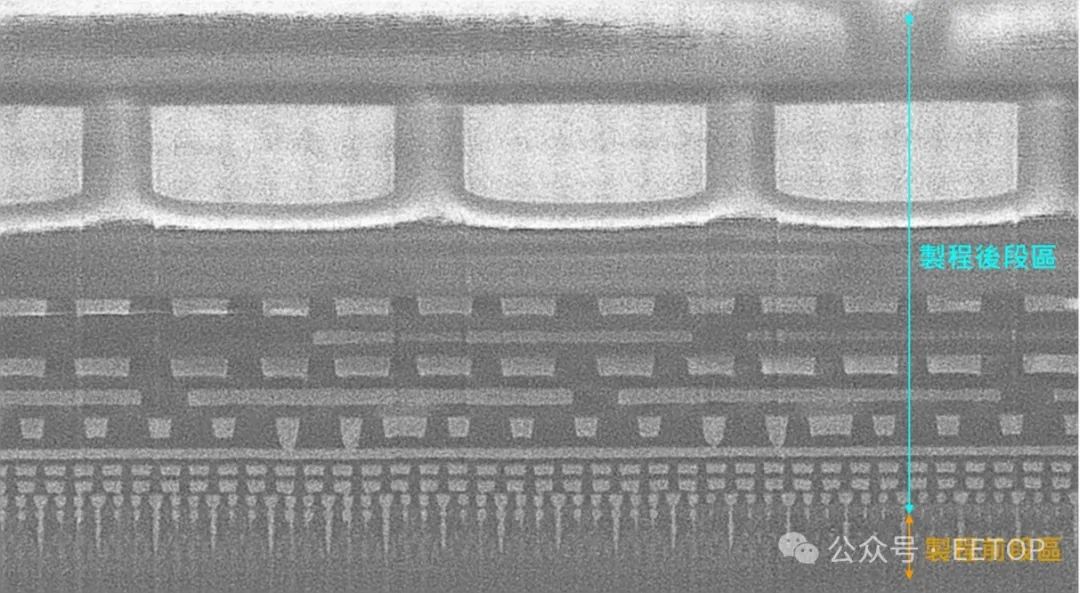
▲ 图七 利用 DB-FIB 精确定位切割,观察 SRAM 的截面结构。
要深入观察先进制程中的6T SRAM元件结构及其精细的制程层次,TEM(穿透式电子显微镜)或 STEM(扫描穿透式电子显微镜)是不可或缺的工具。TEM 利用 200KV 加速的电子束穿透厚度约 100nm 或更薄的试片,然后将信号投射到侦测器上,生成高分辨率的影像。对于现今的3nm制程、成熟制程,乃至未来的2nm和16Å(埃)制程节点,TEM始终是观察SRAM结构的重要检测分析方法,因其在空间分辨率及影像呈现方面的卓越表现。
通过TEM,我们能够清晰识别图一中所示的 6T SRAM 电路及其各部名称,真实结构得以一目了然。图八展示了平面式(Plan-view)STEM观察的先进制程6T SRAM,清楚呈现出六个晶体管的平面结构及其相对排列位置,包括接触点(Contact)、闸极(Gate)、鳍片(Fin)、隔离层(STI)等制程前段结构的平面布局。图八中的黄框标示出一个位(unit Cell)的 6T SRAM。图九则提供了截面式(Cross Section, XS)TEM 观察的影像,展现了部分晶体管的上下排列结构,包括接触点、闸极、鳍片及隔离层等制程前段的截面排列。
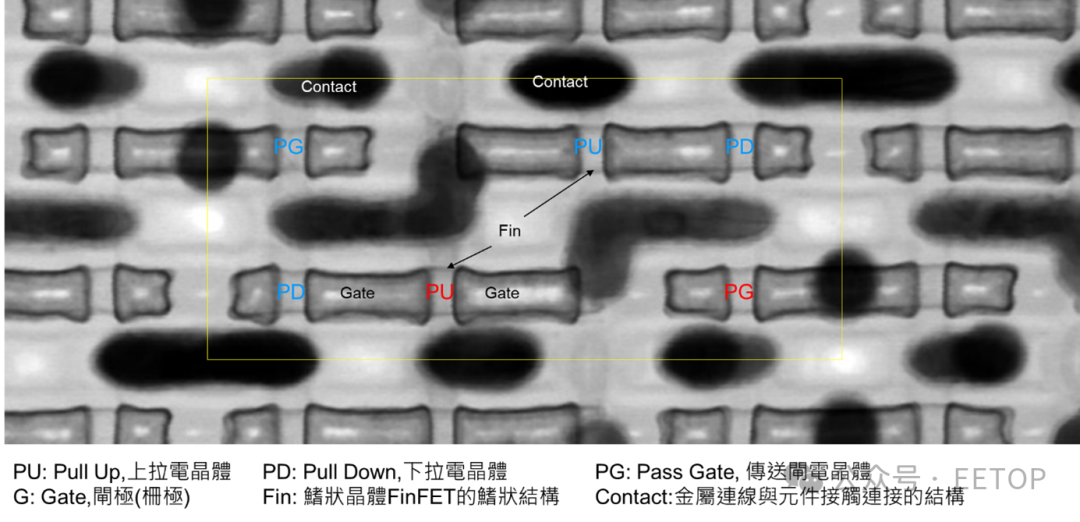
▲ 图八平面式(Plan-view)穿透式电子显微镜(TEM)观察先进制程的6T SRAM,黄框区为1个位(unit Cell)的6T SRAM
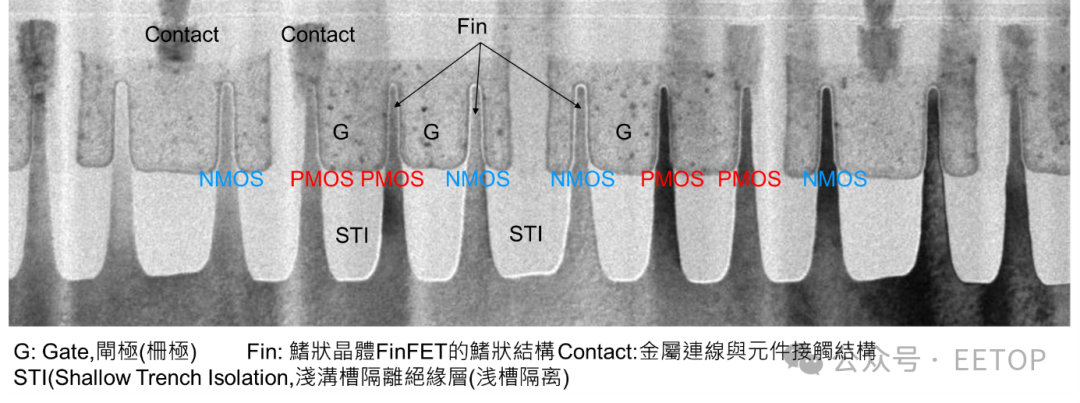
▲ 图九 截面式 (Cross Section, XS) 穿透式电子显微镜 (TEM) 观察先进制程的 6T SRAM 的部分晶体管结构。
SRAM 的结构观察是 AI 芯片检测分析的重要一环。本文从 OM、SEM、TEM 等展示一步一步观察 SRAM 结构的方式。主要是从大范围小倍率的OM观察,一直到最高倍率及最小范围的TEM,并利用图文及照片介绍SRAM的重要结构及名称,实现对SRAM结构的有效而精确的观测方法。
芯片精品课程推荐
双11优惠活动开启 75折!
