历史悠久的AMD 3DNow!指令集终于要彻底绝迹了,将于9月或10月发布的新版开源编译器LLVM 19,会最终移除对它的支持。
从今往后,除非你使用汇编语言,否则再也看不到这个指令集了。

故事还要回溯到1996年,Intel奔腾处理器增加了MMX指令集,多媒体处理能力大大提升,但它仅支持整数运算,浮点运算还得使用落后的x87协处理器指令。
1998年,AMD首次打造了完全属于自己的指令集3DNow!(据说是3D No Waiting的缩写),一共21条,支持单精度浮点矢量运算,可增强3D性能。
K6-2首发支持,成为第一个能够执行浮点SIMD指令的x86处理器,第一次在游戏性能上反超Intel。

1999年的Athlon速龙升级支持Extended 3DNow!,又增加了5条,其表现更是大放异彩。
1999年,Intel发布了自己的SSE指令集,覆盖3DNow!所有功能,而且单精度浮点性能翻番,也不再需要x87指令。
此后,3DNow!渐渐失宠,AMD的新款速龙也引入了SSE,陆续升级为SSE2、SSE3。
2010年,AMD宣布放弃3DNow!,只保留PREFETCH、PREFETCHW两条预取指令。
2021年,Linux系统内核不再支持3DNow!。

如今的AMD可谓春风得意,性能全方位碾压对手,针对其优化甚至专用的产品也越来越多。
芝奇官方宣布全新的Trident Z5 Royal Neo皇家戟EXPO系列旗舰级DDR5内存,专为AMD Zen5架构的锐龙9000系列平台打造。
新内存支持AMD EXPO内存规范,只需搭配可支持的处理器、主板,设置为Uclk、Mclk 1:2分频,就可以轻松跑到8000MHz高频率。
同时,时序控制在CL38-48-48-127,容量可选双条24GB或双条16GB。

作为皇家戟家族成员,它延续了超跑般的独特流线造型散热片设计,经过精工细腻的电镀处理,拥有如镜面清澈透亮的高质感光泽,搭配如水钻般晶亮璀璨的导光设计,金银双色可选。
全系都是高质量的DDR5 IC颗粒,并采用严苛的测试标准与验证流程。
Trident Z5 Royal Neo皇家戟EXPO内存套装将于8月开始上市。
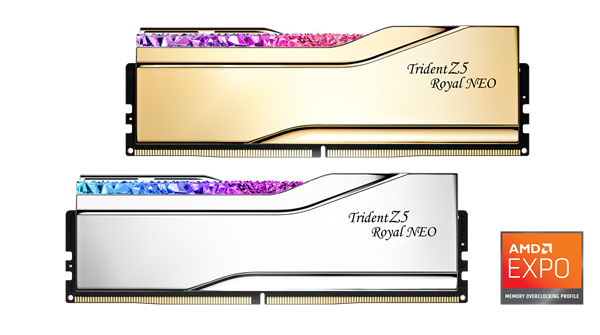


Intel这边这是全面不利,无论消费级还是数据中心都打不过,多年老将都下台走人了。
已经在Intel效力超过20年的资深高管Lisa Spelman将于8月15日正式离职,加盟高性能计算连接技术公司Cornelis Networks,担任新的CEO。
过去长达9年的时间里,Lisa Spelman一直是Intel至强处理器产品线的关键负责人,最近5年更是担任至强业务总经理,还是Intel的企业副总裁。

不过,在她任职期间,代号Sapphire Rapids的四代至强跳票长达两年,原定于2021年推出,但最终拖到2023年1月,在与AMD EPYC的竞争中落于下风。
这也严重影响了Intel至强产品线的后续路线图,直接导致Emerald Rapids五代至强、Sierra Forest/Granite Rapids六代至强快速迭代,生命周期相当混乱。
不知道她的离职,是否与此有关。
但有趣的是,Cornelis Networks其实就是从Intel孵化出来的,原本是Intel Omni-Path互连技术业务,2020年独立。
