(本文编译自Semiconductor Engineering)
芯片行业正在竞相开发用于先进封装的玻璃材料,为芯片材料几十年来最大的转变之一奠定了基础,而这一转变将带来一系列广泛的新挑战,需要数年时间才能完全解决。
十多年来,玻璃一直被讨论作为硅和有机基板的替代材料,主要用于多芯片封装。但随着摩尔定律逐渐失效,从平面芯片转向先进封装对于尖端设计来说几乎已成为定局。现在的挑战是如何更高效地构建这些设备,而玻璃已成为封装和光刻技术前沿的关键推动者。英特尔去年宣布,将在本十年后半段引入玻璃基板。美国政府根据美国芯片法案(CHIPS Act),向韩国SKC的子公司Absolics拨款7500万美元,在佐治亚州建造一座120,000平方英尺的工厂,用于生产玻璃基板。
“玻璃的优点是显而易见的,”英特尔的院士兼基板TD模块工程总监Rahul Manepalli说道,“必须要解决的问题包括界面应力、理解玻璃的断裂动力学,以及理解如何将应力从一层解耦到另一层。”
玻璃的脆性尤其是个问题,因为基板需要做得更薄以满足现代半导体设备的要求。处理和加工这些薄玻璃基板需要细致入微的关照和精确度,因为破裂的风险会显著增加。
玻璃也使得检测和测量技术更具挑战性。“我们正在从典型的基于晶圆的光刻小领域过渡,”Onto Innovation光刻产品营销总监Keith Best表示,“当使用玻璃时,仅仅扩大规模是不够的。它需要一个低数值孔径(NA)镜头系统,能够在不牺牲分辨率的情况下,在更大的区域内实现必要的焦点深度。”
此外,大型晶圆厂和OSAT已经在其他材料(如铜覆层层压板)上进行了大量投资。这些材料在PCB中作为基材得到了现场验证,但当封装行业低于2/2μm线/间距时,它们就会失效。转向玻璃需要新一轮的设备投资和新工艺,或者需要以某种方式将其与现有工艺结合起来。
“目前还没有任何因素能让我们为玻璃基板创建一条专用生产线,”ASE集团高级副总裁Yin Chang表示,“目前还没有业务支持这一点。它要么适应标准流程,要么将需要更长时间才采用它。”
为什么是玻璃,为什么是现在?
尽管存在这些障碍,业界普遍承认玻璃面板的变革潜力及其最终采用的可能性很高。玻璃提供卓越的尺寸稳定性,以及以更精细的图案支持更大区域的能力。它还具有与硅相同的热膨胀系数,并且非常平坦和稳定。
“玻璃的采用绝对是一种趋势,”佳能营销经理Doug Shelton表示,“玻璃的宽容度很高,并且具有一些有利的电气特性。只要不尝试将之变得超薄,它就会使光刻方面变得更容易。”
玻璃最吸引人的特性之一是其低介电常数,可最大限度地减少信号传播延迟和相邻互连之间的串扰,这对于高速电子产品至关重要。它还减少了互连之间的电容,从而实现更快的信号传输并提高整体性能。在数据中心、电信和高性能计算等速度至关重要的应用中,玻璃基板的使用可以显著提高系统效率和数据吞吐量。
低介电常数还可以实现更好的阻抗控制,确保整个电路的信号完整性。这在射频应用中尤其有吸引力,因为阻抗匹配对于最大化功率传输和最小化信号损失至关重要。通过在整个基板表面提供一致的电气特性,玻璃基板有助于高频电路的设计和制造,并提高可靠性和性能。
玻璃基板的另一个关键优势是卓越的热稳定性,这对于在波动的热条件下保持器件性能起着至关重要的作用。与在热应力下可能会发生变形或分层的覆铜层压板不同,玻璃基板在较宽的温度范围内表现出最小的尺寸变化。在热管理至关重要的应用中,例如汽车电子、航空航天系统和工业控制,玻璃承受热循环和在应力下保持尺寸完整性的能力有助于防止电气短路、开路或其他通常与温度引起的可靠性问题机械应变。
英特尔的Manepalli表示:“我们预计玻璃将首先在数据为中心应用中被采用,特别是在基于AI/ML的封装中。在这种应用会玻璃会立即带来性能优势。”
玻璃基板的热稳定性还简化了先进封装解决方案的设计和实施,从而实现更紧密的组件集成并提高封装密度。通过消除与基板翘曲或变形相关的问题,玻璃基板可以实现芯片组件更精确的对准、更细间距的互连以及改进的整体系统性能。
Promex Industries首席运营官David Fromm表示:“看到这些玻璃材料如何进入这些复杂设备的生态系统中,无论是在基板层面还是在更高级别的集成中,都会很有趣。”
工艺改进
玻璃基板的另一大优势是其出色的平坦度,这对于面板级光刻工艺至关重要,因为在该工艺中,精确的对准和特征均匀性对于实现高分辨率图案至关重要。玻璃基板可确保光刻期间一致的焦平面对准,从而能够以出色的精度和可重复性创建细间距互连和复杂的电路图案。
此外,玻璃基板的平坦度通过最大限度地减少图案失真或未对准等缺陷的发生,提高了半导体器件的良率和可靠性。反过来,这会导致更高的制造良率和整体器件性能的提升,特别是在需要严格公差和高集成度的应用中。
过渡到玻璃也支持工艺流程。玻璃在一系列加工条件下具有可预测的行为,可以最大限度地减少工艺变量。一旦处理问题得到解决,工程师就可以围绕可靠且一致响应的材料微调其工艺,从而提高生产线的效率和可预测性。
“玻璃面板加工需要很高的精度度,”Best补充道,“但是一旦你确定了你的流程,这些材料就会用起来得心应手,而不会跟你唱反调。”
玻璃基板光刻技术面临的一个重大挑战是其固有的脆弱性,随着行业转向更薄的基板以适应更高的设备集成度和性能需求,这一问题变得尤为突出。薄玻璃面板的厚度通常为100微米或更小,在处理和制造过程中存在很大的风险。玻璃在压力下容易破裂或破碎,这凸显了需要专门的设备和工艺来安全管理材料。
“玻璃基板其自身也面临着一系列的挑战,” Nordson Test & Inspection产品线总监Brad Perkins说道,“当您观察500多毫米见方的大型玻璃面板时,您会遇到一些真正的挑战,即弯曲和翘曲的程度,以及如何固定它们?”
解决这种脆弱性需要处理系统与光刻技术本身的复杂性相匹配。先进的封装公司正在积极探索稳健的处理、真空和机械支持系统,以运输和处理这些易碎的玻璃面板而不造成破损。此外,人们还在寻求从光刻设备装载和卸载基板的软处理技术进行创新,以减轻处理易碎玻璃基板所带来的风险。
“薄玻璃基板非常脆弱,需要小心处理,”Onto的Best说道,“它需要精细、精确,最重要的是,需要处理技术的创新。你必须非常小心地移动它。例如,当你将其放入电镀槽中时,电镀槽的搅动和湍流可能会使其破碎。”
混合基板
玻璃还可以与传统基板相结合,使现有方法能够利用玻璃的热稳定性和电气优势,同时利用有机层压板或硅中间层等材料的机械鲁棒性和成熟的制造工艺。其结果是一种具有卓越整体性能指标的基板,能够满足当代和未来芯片设计的多样化需求。
例如,混合基板可能采用玻璃芯来实现低损耗、高频信号传输,并采用覆铜层压板(CCL)进行分层,以增强结构刚性和成本效益。这种协同组合可以缓解玻璃带来的一些挑战,例如脆性,同时利用其高性能特性。
“玻璃与其他基材的结合不仅仅是融合两者的优势,”Onto的Best说道,“还可以获得前所未见的性能特征。”
标准化和兼容性
玻璃面板的采用面临的一个重大障碍是缺乏玻璃基板尺寸、厚度和性能的统一标准。与遵守精确的全球规格的硅晶圆不同,玻璃基板目前缺乏普遍接受的尺寸和特性。这种标准化不足使得努力生产普遍兼容工具的设备制造商以及寻求在不进行重大工艺调整的情况下互换基板的半导体工厂来说,面临着复杂的问题。
与标准化密切相关的是兼容性问题,这不仅存在于不同批次的玻璃基板之间,还存在于基板与它们支持的半导体设备之间。仔细匹配玻璃独特的电学和热学特性与半导体设备的这些特性是至关重要的。
“你不会在成熟产品上使用玻璃,”ASE的Chang补充道,“它将被用于具有更好电源解决方案的最先进应用。但处理起来会比较困难。这是其关键问题之一。”
随着半导体行业向小芯片和3D-IC等先进封装发展,后端工艺正在发生显着的变化。这种转变涉及采用和适应传统上与前端半导体制造相关的方法论。
现在,光刻在创建2μm以下的线间距方面发挥着关键作用,这是采用小芯片和2.5D/3D-IC封装所必需的。但这些更精细的尺寸也需要材料能够承受更严格的加工条件,同时保持结构和功能的完整性。
“我们现在面临的最大挑战是充分发挥光刻工具的作用,”Synopsys高级产品营销经理Travis Brist表示,“虽然一直以来都有这样的推动力,但现在它变得更加关键了。”
由于封装中对基板格式的限制较少,并且能够使用具有较低数值孔径的更大透镜,封装供应商正在转向扇出型面板级封装(FOPLP),以在单个面板上处理更多封装,从而降低成本。据估计,相对于圆形300mm晶圆扇出,面板成本可降低30%-40%。
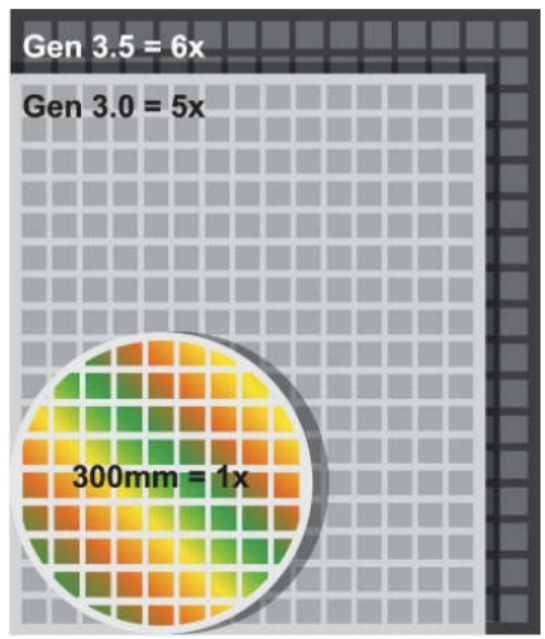
图 1:面板级封装可显著增加芯片数量,
作为基板尺寸的函数
(资料来源:Onto Innovation)
创新
鉴于面板比硅晶圆具有更大的尺寸和不同的物理特性,实现先进封装所需的细间距互连需要光刻技术,该技术可以在面板基板中产生更小的特征尺寸,而不影响对准精度。这在较大的面板上尤其具有挑战性,因为翘曲会成为一个问题,必须在光刻过程中加以考虑。
覆铜板(CCL)因其耐用性、强大的机械性能和成本效益而成为FOPLP的首选基板材料。其成分使其成为满足严格半导体封装工艺要求的耐用选择,而玻璃纤维和铜的相对经济性也有助于其被广泛采用。
虽然CCL的结构决定了其强度,但也使其在FOPLP中常见的热应力和机械应力下容易发生翘曲。基板的每一层都可能产生略有不同的重叠偏差,这是由于面板变形而引起的一个复杂情况。这种偏差对于控制至关重要,因为它们可能会给保持线型和特征尺寸的一致性方面带来挑战。即使是很小的差异也可能导致大量的产量损失并影响封装的整体效率。
此外,CCL在整个基板表面的电气性能的微小变化可能也会影响信号完整性和整体器件的性能,尤其是在高频应用中。
“覆铜板非常坚固,但在翘曲和变形时却非常不稳定,”Onto的Best表示,“但目前大多数人都在使用CCL。他们正在达到9/12[μm线/间距]的水平,并考虑可能达到5/5。有些人甚至想把它推到2/2,但这可能就是CCL的极限了。然后就是玻璃竞赛的开始。”
兼容性不仅限于玻璃的物理特性,还包括半导体堆叠中使用的其他材料(例如电介质和金属)的粘附性,与传统基板相比,这些材料在玻璃上的表现可能有所不同。
在缺乏行业标准的情况下,性能差异也成为一个普遍的挑战。由于每个制造商都遵守其玻璃基板的专有规格,因此会出现一种情况,即同一应用的不同公司的产品性能可能不尽相同。
随着先进封装向更精细的间距和更复杂的互连技术发展,玻璃与堆叠中其他材料之间的热膨胀系数和电气性能差异变得越来越重要。如果没有标准化,玻璃与玻璃通孔(TGV)和微凸块等技术的集成就会变得非常复杂,可能会影响良率和可靠性。
应对这些挑战需要全行业的合作来制定和采用玻璃基板的标准。这种合作涉及由玻璃制造商、半导体公司、封装专家和设备供应商组成的工作组,共同制定可靠的标准,以提高制造过程的可预测性和效率。
由于玻璃基板渴望在先进封装的未来中发挥关键作用,标准化和兼容性将至关重要。只有通过行业合作并就通用协议达成一致,才能发挥玻璃基板的全部优势。
结论
使用玻璃面板,制造商可以突破互连密度的极限,为更复杂和更紧密的集成电路铺平道路。由于基板上电气性能的均匀性,器件不仅变得更小、更快,而且更可靠,确保批次间的器件性能一致。
“玻璃的用途还有很多,而我们甚至还没有触及表面,”Manepalli补充道,“我们甚至还没有利用玻璃的高频优势。想象一下,一旦我们掌握了这一工艺,你就可以用玻璃及其优势特性创造出什么东西。”
END
