
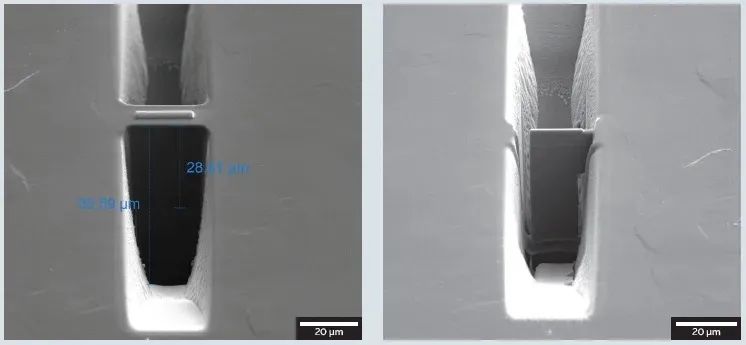 图 1:在沟槽中制备的大型 (55 μm × 30 μm) 薄片,显示底切之前(左)和之后(右)
图 1:在沟槽中制备的大型 (55 μm × 30 μm) 薄片,显示底切之前(左)和之后(右)
利用 Si 基底上 30 μm 厚的晶体 SiC 层来展示 TEM 样品的制备和堆垛层错的成像。 TESCAN AMBER FIB-SEM 配备 TESCAN OptiLift™ 纳米操纵器,其独特的位置位于 FIB 下方,用于制备 TEM 薄片。
第一步是分别使用 100 nA(图 1 左)和 5 nA(图 1 右)的束流在沟槽中制备大型 (55 μm × 30 μm) 薄片。
然后使用OptiLift ™ 纳米操纵器提起 TEM 薄片(图 2 左),然后将其旋转 100°,以使薄片的原始左侧和右侧与 TEM 平行。旋转的薄片连接到 Cu TEM 网格上,该网格位于支架上预先确定的位置(图 2 中和右)。
所有几何调整均仅使用载物台和 OptiLift™ 旋转以及载物台移动一步完成,无需腔室通风。
将样品附着到网格上后,在高 FIB 光束电流下进行初始抛光,可以清楚地显露出 SiC 层和 Si 衬底(图 3 左)。使用 FIB 抛光四个窗口,每个窗口宽度为 10 μm,深度为 15 μm,以防止大 TEM 薄片弯曲。
由于使用 SE 探测器在 5 keV 的 SEM 图像中抛光区域变得透明,因此假设抛光窗口的最终厚度低于 80 nm(图 3)。然后使用 TESCAN 的 HADF R-STEM 探测器在 30 keV 下完成对准备好的 TEM 薄片的直接成像。
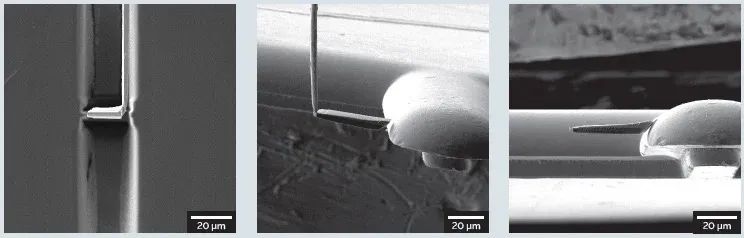
图 2: TEM 薄片被提出(左),旋转 100°(中),并使用 TESCAN OptiLift™ 单步连接,这有利于独特的提出几何形状。
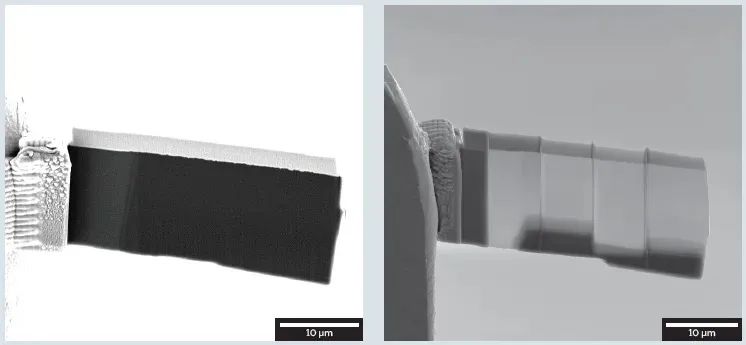
图 3:最终抛光前(左)和后(右)的 TEM 薄片。
利用 STEM 成像,确认所制备样品的质量足以用 STEM 或 TEM 进行表征,这证明 FIB 适用于制备厚涂层样品。 STEM 图像展示了使用多窗口抛光方法实现了均匀的样品透明度。大面积概览图像(图 4)显示了 Si 衬底、界面和整个 30 μm 厚的层。
STEM 图像表明,Si 和 SiC 之间的界面处存在大量堆垛层错,这对于改进 SiC 层制造工艺非常重要。靠近 SiC 层表面的层错数量缓慢下降(图 4 中从左到右)。
更大放大倍数的成像表明,堆垛层错出现在多个取向平面中,并且大部分位于 Si 和 SiC 之间的界面处。当从不同方向观察时,暗场图像的固有对比度会显示出堆垛层错(图 5 右)。
在图 6 中,可以更详细地看到堆垛层错,揭示了当缺陷相遇时不同的堆垛层错湮灭。为此目的并获得晶体学信息,需要更高的 keV (S)TEM。在这种情况下,SEM 中的 STEM 已被证明可以成功捕获小至 3 纳米尺寸的堆垛层错的对比度。
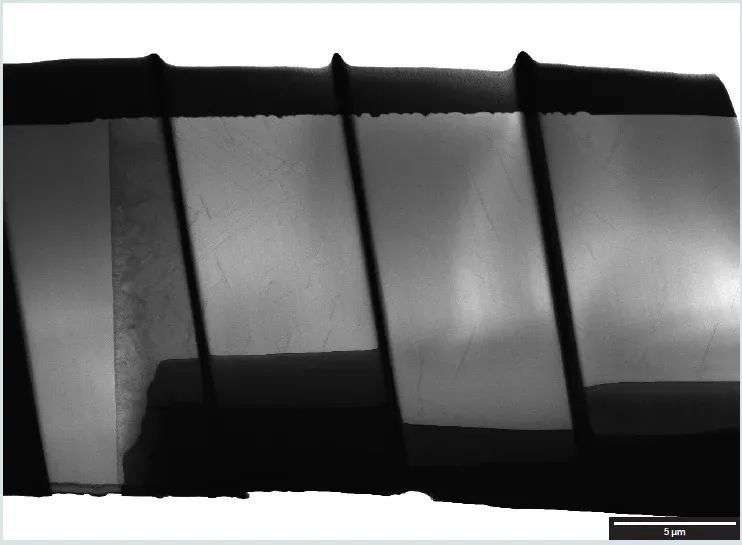
图 4:在 FIB-SEM 中使用 TESCAN 的 HADF R-STEM 探测器在 30 keV 下采集的 STEM 明场概览图像。
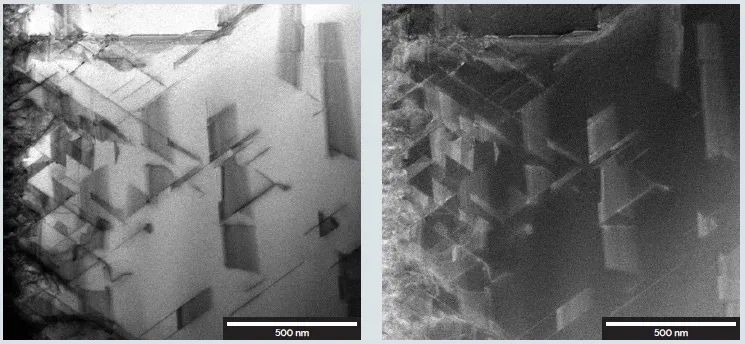
图 5:使用 FIB-SEM 中的 HADF STEM 探测器显示界面处的堆垛层错。图片来源:TESCAN USA Inc.
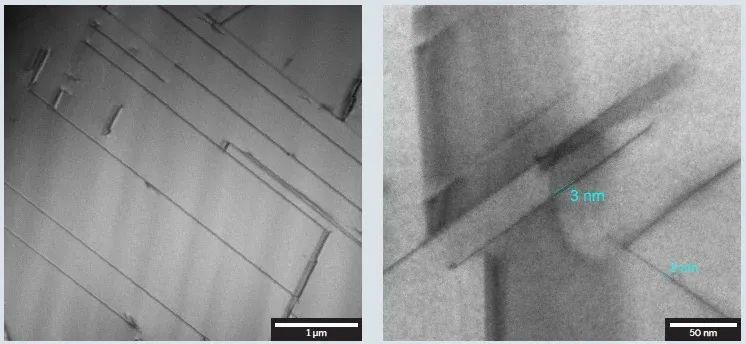
图 6:由 FIB-SEM 中的 HADF R-STEM 探测器获取的界面处堆垛层错的详细图像。图片来源:TESCAN USA Inc.
这项研究证明,TESCAN 独特的FIB 下方纳米操纵器位置,与 TESCAN 的 OptiLift™ 旋转尖端纳米操纵器相结合,在 30 μm 厚 SiC 层感兴趣区域的原位样品制备性能方面具有不可替代的性能。
TEM 薄片的 100° 旋转能够在特定位置对多个窗口进行抛光,从而提供堆垛层错及其在层、基底和界面中发展的能力的清晰图像。 STEM 探测器对堆垛层错缺陷进行成像,为 TEM 薄片质量验证和纳米级堆垛层错表征的详细表征提供了机会。
该数据可用于验证 SiC 层的质量,或作为在 TESCAN TENSOR 等专用 (S) TEM 中在高加速电压下进行更多 (S) TEM 成像的预筛选信息。

文章来源于 TESCAN USA Inc. 提供的材料。
*免责声明:本文由作者原创。文章内容系作者个人观点,碳化硅芯观察转载仅为了传达观点,仅代表碳化硅芯观察对该观点赞同或支持,如果有任何异议,欢迎联系碳化硅芯观察。