
----与智者为伍 为创新赋能----
摘要
随着芯片复杂度的增高和摩尔定律的放缓,半导体行业正在迅速向先进封装中的异质芯片组装转型。这种转变实现了通过组件的拆分与新的架构配置下的重新集成来持续缩小线距和创新。然而也带来了显著的设计、验证、制造和供应链等方面的挑战。本文探讨了实现异质芯片组装主流化所涉及的驱动因素、方法、权衡取舍和未解决问题。
导言
50多年来,摩尔定律推动了半导体行业的发展,其核心是每两年单片硅晶圆上的晶体管数量就会翻一番。这种坚持不懈的缩小线距使芯片可以更高度地集成,性能更强,成本更低。但是,随着芯片制造技术进入10纳米以下,继续缩小线距的成本高得惊人。此外,单片系统级芯片(SoC)也遇到了光刻机曝光范围限制、良率问题和其他瓶颈。因此,行业正在大力向2.5D和3D堆栈等先进封装中更小的异质芯片组装转变。这种方法通过组合匹配不同工艺节点和来源的组件,可以继续提升芯片的集成度、带宽、功耗和性能。然而,异质集成也给设计、验证、制造和供应链带来了重大的新挑战。工程师现在必须协同设计芯片本体、互连和封装,以实现系统层面的最佳综合。本文将探讨异质芯片组装主流化的驱动因素、方法、挑战和展望。
异质集成的驱动力
促使行业向多芯片架构转变的几个关键因素:
如图1所示,在摩尔定律放缓的情况下,芯片组装可提供更好的技术和经济路径。
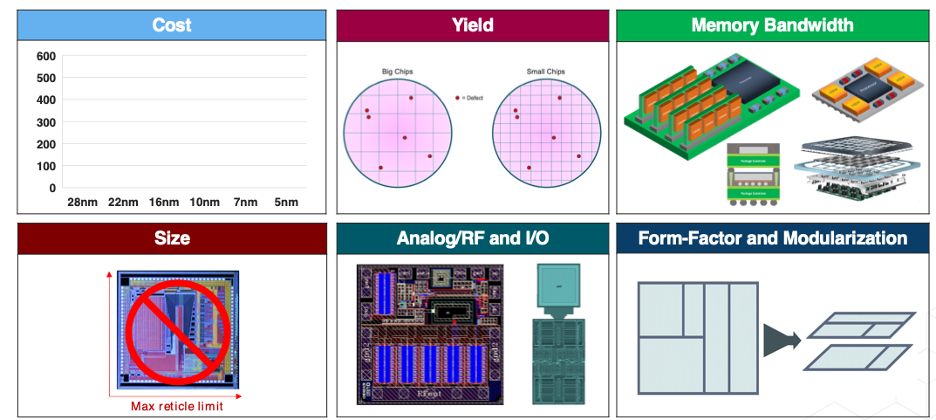
异质集成方法
连接芯片组装的两种主要方法:
芯片可以通过线键合、微突块、硅通孔(TSV)以及UCIe、BoW等新兴接口标准进行连接。
协同设计芯片、封装和互连,以实现热性能、功耗、性能和成本的最佳平衡,难度巨大。工程师必须从整体系统视角出发,而不仅仅是设计单独的ASIC芯片(图2)。
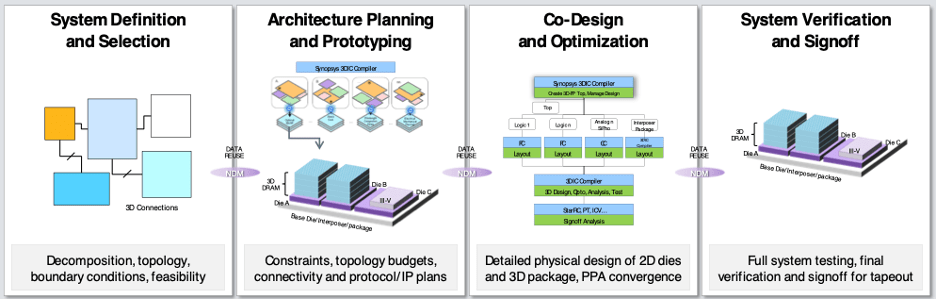
关键挑战
异质集成前景广阔但也带来许多新挑战:
许多标准、工具和方法还在演进,以实现可靠的芯片组装、验证和制造。工程师需要广泛的新知识,涵盖多芯片设计、系统级验证、2.5D/3D封装和测试。
展望
尽管异质芯片集成非常复杂,它在摩尔定律时代结束后也可以持续缩小线距、创新和降低成本。业界正在大力开发围绕封装、接口标准、设计工具、建模、自动化和制造的可靠解决方案和生态系统。
大公司已经实现了多芯片设计,但广泛采用将取决于解决方案的成熟和成本降低。最终,基于芯片组装的架构将需要从根本上改变系统的构思、设计、集成、验证、制造和支持,横跨全球化的供应链。这是重大变革,也是半导体行业一个激动人心的新篇章。
总结
过去无止境的推进摩尔定律缩小线距的结束,推动了向异质芯片先进封装的重大转变。这种方法通过组件的混合匹配可以继续获得收益,但也给设计和制造流程带来了重大新挑战。各方正在积极开发标准、工具、方法、测试、供应链等,以实现异质集成的大规模应用,将从根本上改变半导体行业的经济模式和实践方式。
来源:逍遥设计自动化

申明:感谢原创作者的辛勤付出。本号转载的文章均会在文中注明,若遇到版权问题请联系我们处理。

----与智者为伍 为创新赋能----

联系邮箱:uestcwxd@126.com
QQ:493826566