碳化硅(silicon carbide,SiC)功率器件作为一种宽禁带器件,具有耐高压、高温,导通电阻低,开关速度快等优点。如何充分发挥碳化硅器件的这些优势性能则给封装技术带来了新的挑战:传统封装杂散电感参数较大,难以匹配器件的快速开关特性;器件高温工作时,封装可靠性降低;以及模块的多功能集成封装与高功率密度需求等。针对上述挑战,本文分析传统封装结构中杂散电感参数大的根本原因,并对国内外的现有低寄生电感封装方式进行分类对比;罗列比较现有提高封装高温可靠性的材料和制作工艺,如芯片连接材料与技术;最后,讨论现有多功能集成封装方法,介绍多种先进散热方法。在前面综述的基础上,结合电力电子的发展趋势,对 SiC 器件封装技术进行归纳和展望。

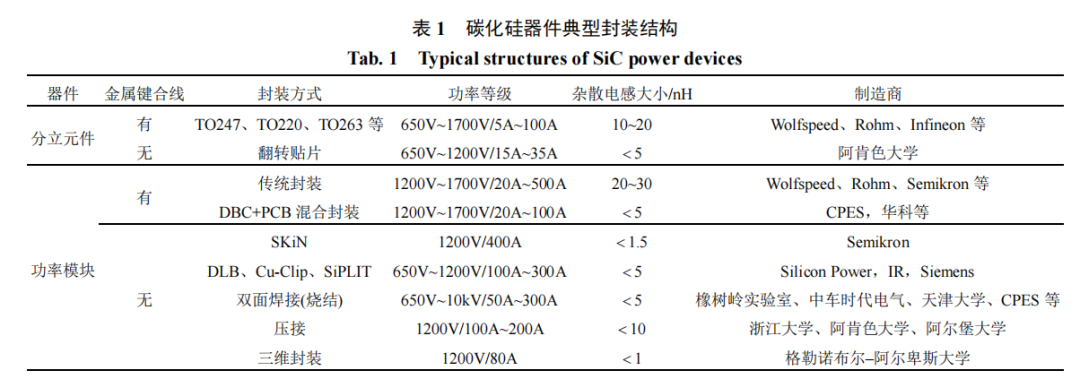
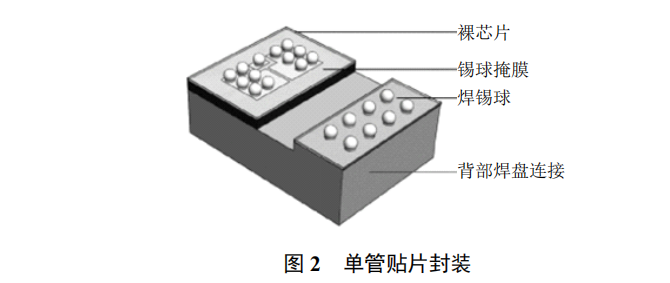
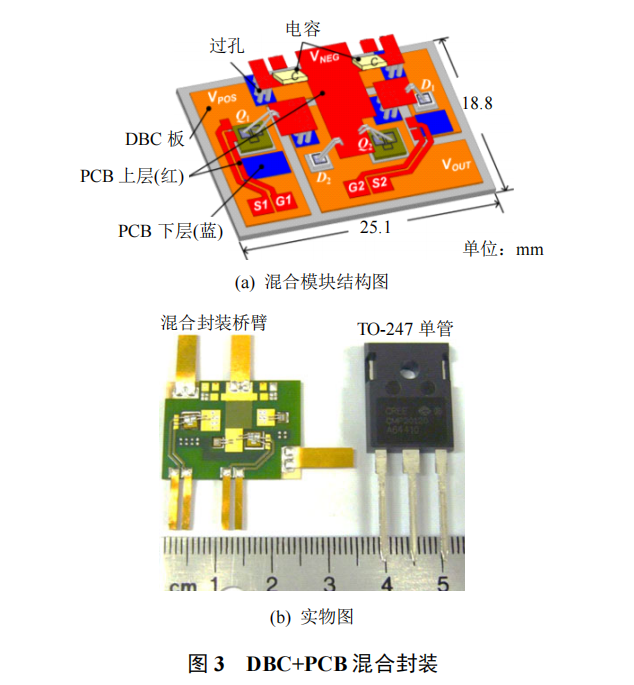
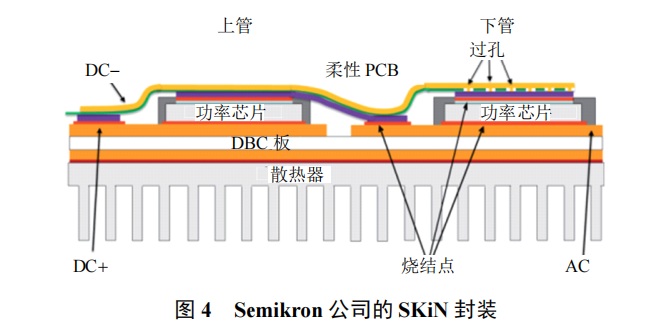
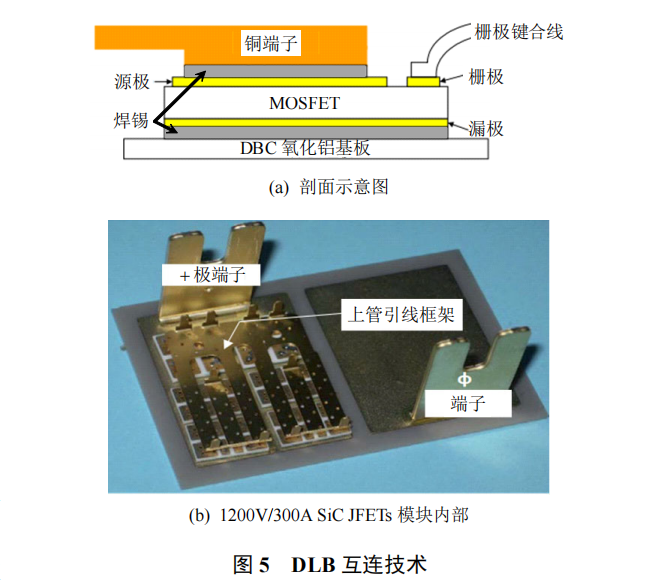
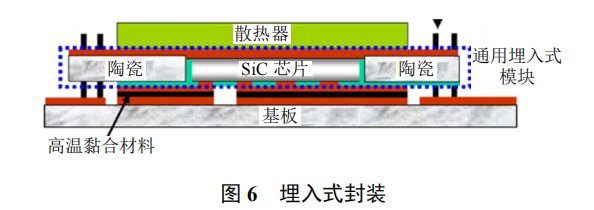
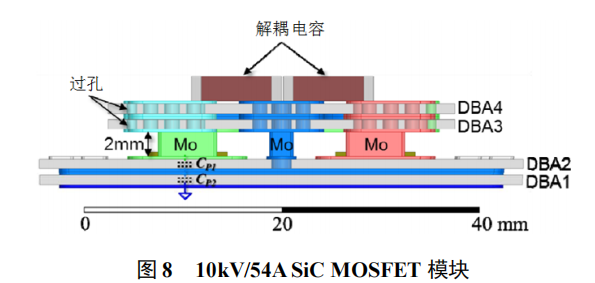
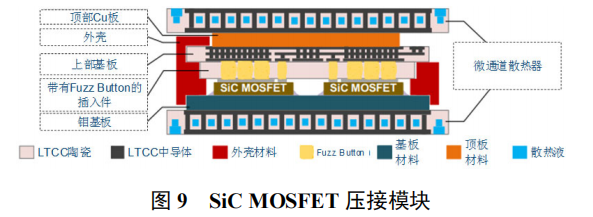
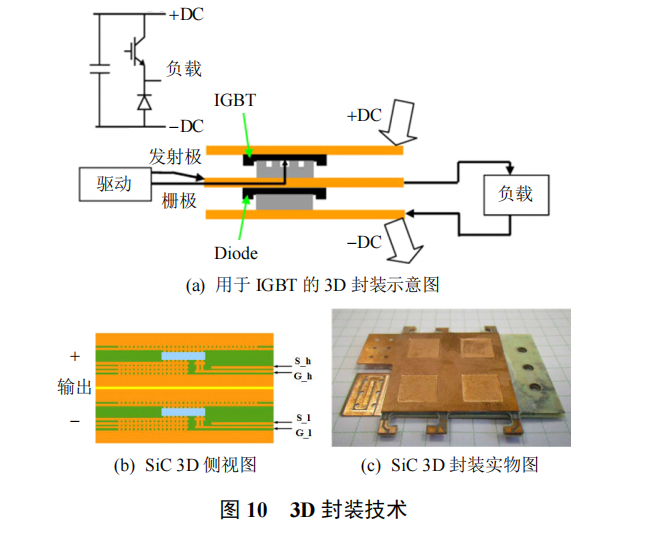
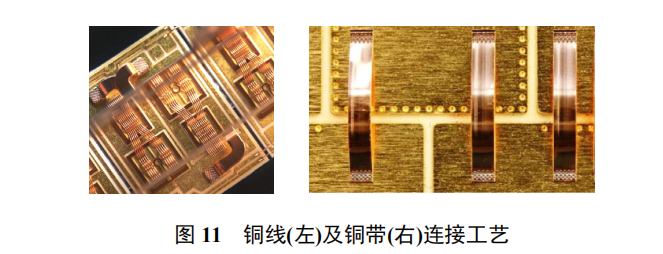
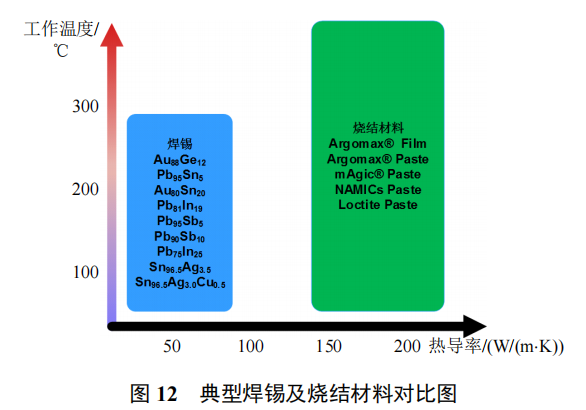



来源:DT半导体
推荐阅读

