

图源:国家知识产权局网站(下同)

专利摘要显示,该专利为一种芯片堆叠封装结构(100)及其封装方法、电子设备(1),涉及电子技术领域,用于解决如何将多个副芯片堆叠单元(30)可靠的键合在同一主芯片堆叠单元(10)上的问题。
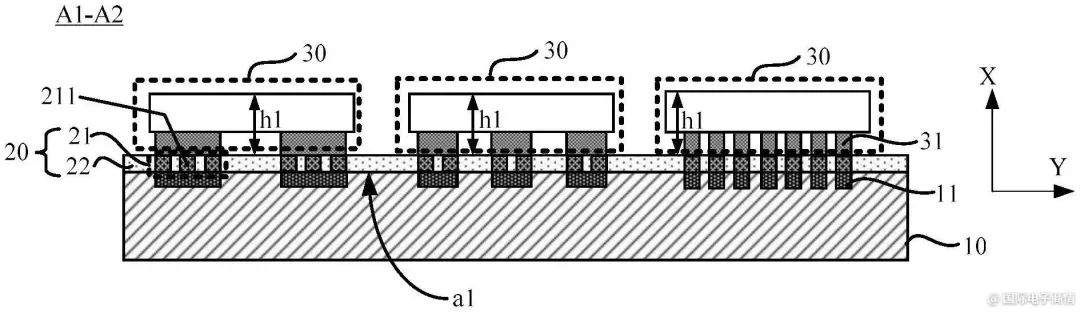
虽然本次公开的两项专利与4月5日公开专利申请时间均为2019年,但早在2012年,华为便向国家知识产权局申请了一项名为“芯片堆叠封装结构”的发明专利。这意味着,华为对芯片堆叠封装的研究在2012年甚至更早的时间就已开始。而华为官方首次公开确认芯片堆叠技术则是在今年3月28日举行的华为2021年年报发布会上。华为轮值董事长郭平当时表示,未来华为可能会采用多核结构的芯片设计方案,以提升芯片性能,同时采用面积换性能,用堆叠换性能,使得不那么先进的工艺也能持续让华为在未来的产品里面,能够具有竞争力。
国际电子商情了解到,堆叠技术也可以叫做3D堆叠技术,是利用堆叠技术或通过互连和其他微加工技术在芯片或结构的Z轴方向上形成三维集成,信号连接以及晶圆级,芯片级和硅盖封装具有不同的功能,针对包装和可靠性技术的三维堆叠处理技术。
该技术用于微系统集成,是在片上系统(SOC)和多芯片模块(MCM)之后开发的先进的系统级封装制造技术。在传统的SiP封装系统中,任何芯片堆栈都可以称为3D,因为在Z轴上功能和信号都有扩展,无论堆栈位于IC内部还是外部。
目前,3D芯片技术的类别包括:基于芯片堆叠的3D技术,基于有源TSV的3D技术,基于无源TSV的3D技术,以及基于芯片制造的3D技术。目前台积电、英特尔、三星等国际半导体厂商都开发了自己的3D芯片封装技术。
来源:国际电子商情
本公众号高薪签约长期专栏作者,欢迎具备优秀写作能力的科技从业或爱好者,联系传感器小编:YG18511751369(微信号)
期待下一篇10W+出自您的笔下!
免责声明:本文版权归原作者所有。本文所用视频、图片、文字如涉及作品版权问题,请第一时间告知,我们将根据您提供的证明材料确认版权并按国家标准支付稿酬或立即删除内容!本文内容为原作者观点,并不代表本公众号赞同其观点和对其真实性负责。


为您发布产品,请点击“阅读原文”
