
芯片从二维跨向三维,封装技术也应当从2D过渡到3D。而半导体封装技术在无法一步从2D封装跨到3D封装的时候,2.5D封装的作用就显现出来了。
 2.5D封装,是桥,也是路
2.5D封装,是桥,也是路
2.5D封装是一种先进的异构芯片封装,可以实现多个芯片的高密度线路连接,进而集成为一个封装。在2.5D封装中,芯片并排放置在中介层顶部,通过芯片的微凸块和中介层中的布线联系起来。中介层是一种由硅和有机材料制成的硅基板,通过硅通孔(TSV)联系上下层,再通过锡球焊接至传统2D的封装基板上,是先进封装中多芯片模块传递电信号的管道,可以实现芯片间的互连,也可以实现与封装基板的互连,充当多颗裸片和电路板之间的桥梁。硅通孔是2.5D封装解决方案的关键实现技术,即在晶圆中填充铜,提供贯通硅晶圆裸片的垂直互连,用最短路径将硅片一侧和另一侧进行电气连通。2.5D封装通常用于ASIC、FPGA、GPU和内存立方体,并最终在高带宽内存(HBM)处理器集成中流行起来。
2.5D封装很好的诠释了一句话:如果不把路直接打通的话,那就多绕几个弯吧。
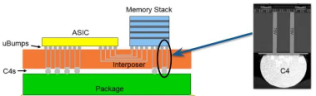
来源:GlobalFoundries
封装行业将2.5D与3D封装统称为先进封装。但是3D封装和2.5D封装还是有很大的区别。
与2.5D封装不同的是,3D封装将逻辑裸片堆叠在一起或与存储裸片堆叠在一起,裸片之间通过中介层连接,3D 封装将多层硅晶圆与采用TSV的元件连接在一起,结构更加立体。3D最大的技术挑战是在芯片内直接制作硅穿孔,难度极高。近年来,由于高效能运算、人工智能等应用兴起,加上TSV技术愈来愈成熟,越来越多的CPU、GPU和存储开始采用3D封装。
3D封装比2D封装来看,面积更小、功耗更低,拥有超大带宽。但是3D封装技术由于其在较小的封装体内堆叠多个芯片,也导致了其严重的散热问题,且在长期可靠性方面受限。
2.5D封装与3D封装并不是你死我活的竞争替代关系,而是可以在不同需求和场景下发挥自己的不同作用的互补关系。
2.5D封装技术的关键优势是较低的芯片空间、优秀的热管理、更快的运行速度、更高的性价比,恰好实现了从成本、性能到可靠性的完美平衡。
根据Yole数据显示,先进封装中,2.5D硅基板的营收将从2019年的1.6亿增长到2025年的14.9亿美元。2020年到2025年期间将是增长的高爆期,其年复合增长率将达到44%,这从一定程度上反映了2.5D封装的发展前景。
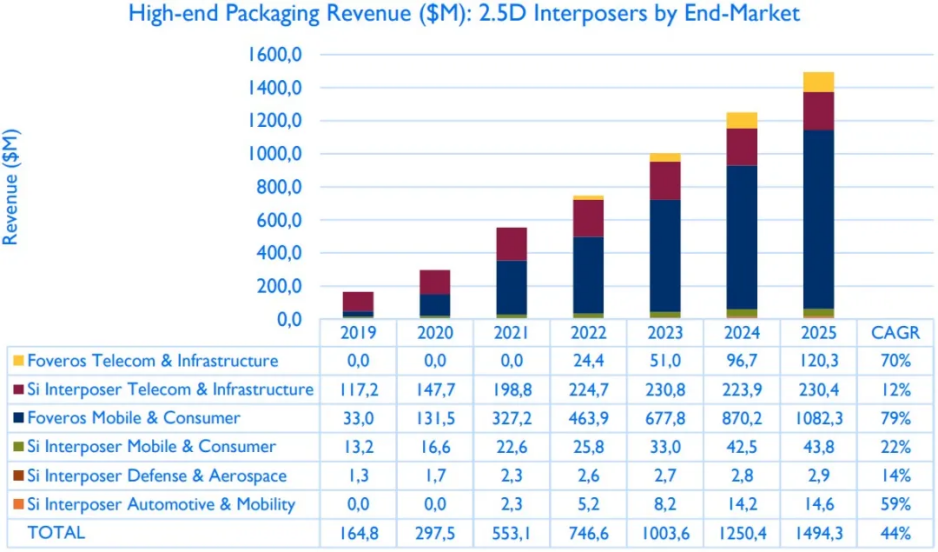
先进封装收入。来源:Yole
 赛道拥挤,IDM、Foundry都来“抢饭碗”?
赛道拥挤,IDM、Foundry都来“抢饭碗”?
2.5D封装产业的供应链形式也和以往不同,以往的封装供应链分工明确,晶圆代工厂提供裸片,再由封测厂完成封装和测试。然而近年来,除了原本就在这个领域里面安营扎寨的封测厂外,晶圆代工厂和IDM厂商也都在纷纷入局2.5D封装市场。

先进封装的竞争格局。来源:Yole
对于代工厂商来说,之所以能够跨入后段封测,主要的驱动力来自于高端客户对芯片性能的需求。相较于传统的后段封测行业,前段晶圆级别封测更具有掌握终端客户需求的优势。另外,2.5D封装中的主要组成部分硅中介层采用的是硅工艺,先进封装对凸块制造、再布线等中段硅片级工艺需求增加,而且技术难度也不断提高,晶圆代工企业在该领域积累深厚,相比传统封测厂具有一定优势。因此各代工厂在整个供应链中占据着重要角色。由于先进封装在半导体产业中的地位在提高以及晶圆代工制程的物理极限临近,晶圆代工厂开始布局先进封装技术,以保证未来的竞争地位。
台积电将2.5D封装技术CoWoS外包,2.5D封装不重要了?
台积电早在2012年便已开启了在封装领域的布局,并2020年整合旗下SoIC、InFO及 CoWoS等3D封装技术平台,并命名为“3D Fabric”。目前,台积电在的先进封测厂区,主要提供晶圆凸块、先进测试、先进封装等业务。
前日,据《电子时报》报道,台积电已将2.5D封装技术CoWoS (Chip On Wafer On Substrate)封装业务的部分流程外包给日月光(ASE)、矽品、安靠(Amkor)等OSATs,尤其是一些需要小批量定制的高性能芯片,台积电只在晶圆层面处理 CoW 流程,而将oS(On Substrate,简称oS)流程外包给OSATs,CoWoS技术先将芯片通过Chip on Wafer(CoW)的封装制程连接至硅晶圆,再把CoW芯片与基板连接(oS)。消息人士称,对台积电来说,在CoWoS技术中,最赚钱的就是CoW技术,oS的利润最低,且oS流程无法实现自动化的部分较多,需要更多人力,而日月光、矽品、安靠等顶尖OSAT厂商在oS流程处理方面的经验更多。类似的合作模式预计将在未来的3D IC封装中继续存在。
台积电外包部分2.5D封装技术,不代表放弃了2.5D封装,相反,台积电在优化2.5D封装的产业链布局。将专业的事情交给专业的厂来做,以实现合理高效的资源利用,实现自己的利益更大化。台积电这步棋,走得明智。传统封测厂商在技术完备性方面具有优势,因此两者的合作有望更加紧密。
从28nm到2.5D,格芯也专注“差异化”
格芯的魅力,不在于台积电独占鳌头的霸气,而在于其洒脱的魄力。2018年的格芯宣布专注于更具有优势的差异化解决方案,令人印象深刻的是格芯无限期的搁置7nm的研发计划。其实,2.5D先进封装也是差异化解决方案其中重要组成部分。
格芯的2.5D封装技术基于格芯成熟的铜互连工艺,有3层Metal和4层Metal工艺可供客户选择。
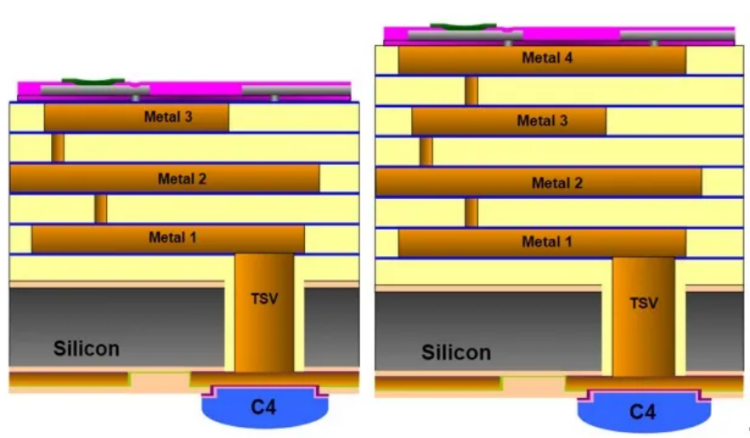
格芯的2.5D封装,来源:格芯
格芯2.5D封装技术至今已成功应用于国内外多个系统厂家的高端芯片,可以覆盖不同产品尺寸。在2.5D先进封装设计服务方面,格芯已完成从物理实现,到仿真分析,到物理验证的全流程开发,并持续开发支持多个主流EDA厂家的设计流程,方便不同客户使用。
或许很多厂商,都想把路走得更远,但是格芯的选择,告诉了我们,把路走宽,也是企业的生存之道。
三星&安靠:H-Cube2.5D封装聚焦高性能芯片
除了晶圆代工厂外,IDM厂商也纷纷入局并发展2.5D封装。
今年11月份,三星推出了全新2.5D封装解决方案H-Cube(Hybrid Substrate Cube,混合基板封装),专用于需要高性能和大面积封装技术的高性能计算(HPC)、人工智能(AI)、数据中心和网络产品等领域。H-Cube是三星电机和安靠共同开发的成功案例。该封装解决方案适用于需要集成大量硅片的高性能芯片。
H-Cube降低了HPC/AI市场的准入门槛,也证明了晶圆代工厂和封测厂生态合作可取。
封装技术一路走来,2.5D已然是必不可少的桥梁。而对于半导体产业链的厂商来说,不管是位于半导体产业链上的哪一环,企业在面对在先进封装技术领域的竞争时,必须寻求对应低成本高性能封装技术,展开差异化竞争,才能在激烈的竞争中不断发展。






