三星新一代2.5d封装技术取得有什么新的进度?新的H-Cube解决方案适用于高性能半导体,需要大量硅芯片的集成,为了扩大和丰富代工生态系统,将提供各种封装解决方案,并在客户面临的挑战中寻找突破口。
三星半导体官微宣布,三星正式推出全新2.5D封装解决方案H-Cube(混合基板封装),专用于高性能和大面积封装技术的高性能计算(HPC)、人工智能(AI)、数据中心和网络产品等领域。
据介绍,2.5D封装技术通过硅中介层把逻辑芯片和高带宽内存芯片集成。
而三星H-Cube通过整合两种具有不同特点的基板:精细化的ABF(味之素堆积膜)基板,以及HDI(高密度互联)基板,可以进一步实现更大的2.5D封装。
随着高性能计算、人工智能和网络应用等细分市场的发展,需要封装在一起的芯片数量和尺寸都在增加。
三星H-Cube封装解决方案
“H-Cube是三星电机(Samsung Electro-Mechanics, SEMCO) 和 Amkor Technology公司共同开发的成功案例该封装解决方案适用于需要集成大量硅片的高性能芯片”, 三星电子晶圆代工市场战略部高级副总裁Moonsoo Kang表示,“通过扩大和丰富代工生态系统,我们将提供丰富的封装解决方案,帮助客户突破挑战”。
“现如今,在对系统集成要求日益提升、大型基板供应困难的情况下,三星晶圆代工厂和Amkor Technology公司成功地联合开发了H-Cube(Hybrid Substrate Cube,混合基板封装)技术,以应对挑战H-Cube降低了HPC/AI市场的准入门槛,晶圆代工厂和OSAT(Outsourced Semiconductor Assembly and Test)公司之间的合作也很成功”Amkor Technology全球研发中心高级副总裁JinYoung Kim表示。
H-Cube结构和特点
2.5D封装使逻辑芯片或高带宽存储器(HBM)能够以较小的外形尺寸放置在硅插入器的顶部。三星的H-Cube技术采用混合基板、能够实现精细凹凸连接的细间距基板和高密度互连(HDI)基板,以实现2.5D封装的大尺寸。
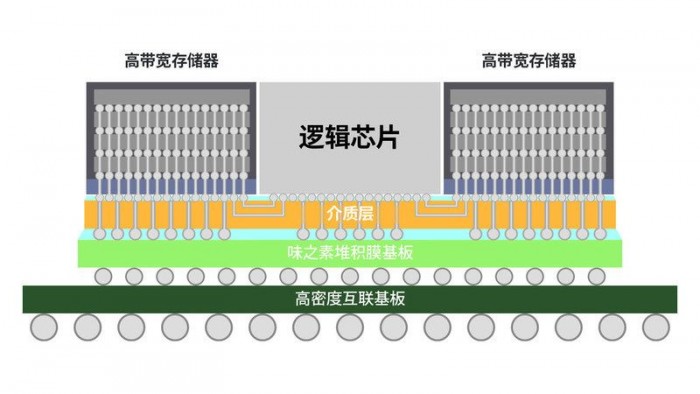
当集成六个或更多高带宽存储器的时候,大面积ABF基板的制造难度会迅速增加,而且会导致生产效率下降,而H-Cube可以解决这个问题,在ABF基板上叠加大面积的HDI基板结构。H-Cube使得芯片和基板的焊锡球的间距缩短35%,缩小了ABF基本的尺寸,添加的HDI基板又确保了与系统板的连接。

通过将电连接芯片和基板的焊球间距比传统的焊球间距减少35%,细间距基板的尺寸可以最小化,同时在细间距基板下增加HDI基板(模块PCB)以确保与系统板的连接。此外,为了提高H-Cube解决方案的可靠性,三星应用了其专有的信号/电源完整性分析技术,在堆叠多个逻辑芯片和HBM时,可以稳定地提供电源,同时最大限度地减少信号损失或失真。
责编:editorAlice


