OPTION_5:HP
编按:本文作者Kevin Gibb,TechInsights产品线工程师;Lev Klibanov,TechInsights制程分析师
为了了解芯片如何制造以及为什么在某些情况下表现出特定结构,TechInsights经常针对芯片进行反向工程。本文讨论在金属闸逻辑制程中所采用的两种电熔丝(eFuse)结构,包括英特尔(Intel)与台积电(TSMC)所打造的eFuse结构。
首 先观察英特尔采用32nm高介电常数金属闸(HKMG)制程的Westmere/Clarkdale处理器(约2009年发表)中的eFuse结构。当时,英特尔采用eFuse作为一次性可编程只读存储器(OTP-ROM)的一部份。如今,我们知道其用途还包括保存编程程序代码、芯片上配置数据以及加密密钥。
在金属闸极出现以前,电子可熔断芯片熔丝通常由多晶硅闸极层制造。但随着金属闸极CMOS制程出现,多晶硅无法再做为熔丝组件。那该怎么办呢?
英 特尔在2010年发表了一份关于其32nm制程OTP-ROM的文件(Kulkarni et al. J. Solid-State Circuits 2010),透露其采用电子熔断金属熔丝(eFuse)作为内存组件。该熔断组件透过第2个过孔(via 2)连接第2层金属(metal 2;M2)总线到第3层金属(metal 3;M3)线制造而成。其3D热建模显示在过孔上面的部份是可熔断的组件。
但是,我们发现在Westmere/Clarkdale处理器中的熔线(fusible link)或熔丝,采用如图1的顶层金属(metal 1;M1)走线建置。
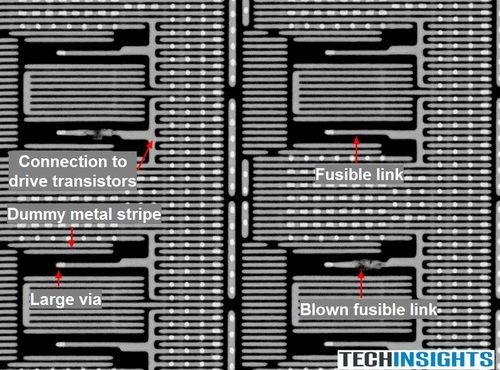
图1:由图中可看到2个熔断的熔丝和6个完整的熔丝,彼此互连至基本的驱动晶体管。熔丝的熔断部份形状并不规则,但与构成M1走线的铜原子电迁移(EM)保持一致
英特尔所发表的论文中描述这种空隙的形成(熔断作用)是根据热辅助电迁移而来。
在熔丝的左侧可看到较大的过孔,这主要用于在过孔底部保持低电流密度,以确保这种电迁移空隙出现在熔在线。
进行电迁移的金属线‘平均无故障时间’(MTTF)可由Black的公式(1)(JEDEC JESD63,1998)计算出来:

公式(1)中的J是电流密度,T为温度,Ea是指大约0.9电子伏特(eV)的活化能量(activation energy),A是常数,k是波兹曼(Boltzman)常数,n则是范围从1到2之间的建模参数,在此取n=1。
我们可以使用公式(1)估计英特尔的eFuse需要多长时间进行熔断。为此,我们测量了熔丝的截面积(1x10-10cm2),估算出MOS驱动晶体管约使用12mA的恒定驱动电流熔断熔丝(~1.2x108A/cm2)。根据现有的数据显示,在温度300℃、1.5mA/cm2的偏置电流下,Damascene镶嵌铜线的MTTF约为440小时(R. L. de Orio et al. VLSI-SoC conference 2009)。440小时MTTF是从其图表之一推论而来,很可能导致相当程度的不确定性。
根据英特尔的论文显示其熔丝在过孔顶部具有温度高达1,000 ℃的热点,但Westmere/Clarkdale eFuse采用像M1的金属片建置。我们怀疑M1熔丝可自加热至1,000 ℃,不过500 ℃也还算合理。这种假设结合公式(1)可实现约0.2微秒(us)的MTTF时间。英特尔使用约1us的时间偏置2V脉冲熔断其熔丝,因此,我们估计约 0.2us的结果也很合理。
我们以库存的一款Westmere/Clarkerdale处理器复制了英特尔的熔丝熔断过程, 并以图2显示熔断熔线的穿透式电子显镜(TEM)截面图。透过为此特定样本进行脱层后,暴露出接触M1熔线的M2走线。这些走线连接至一款4点探针,并施 加0-2V偏置脉冲与13mA峰值电流。出现在M1走线的空隙表示成功熔断了熔丝。
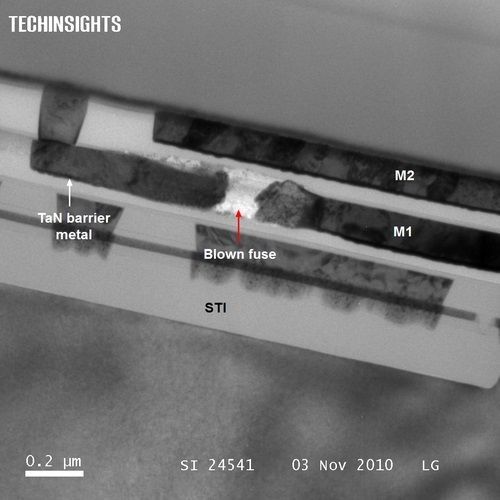
图2:透过为此样本进行脱层后,暴露出接触M1熔线的M2走线。这些走线连接至一款4点探针,并施加0-2V偏置脉冲与13mA峰值电流。在M1走线的空隙表示成功熔断了熔丝
并不是只有英特尔一家公司采用eFuse结构,我们发现该组件也出现在台积电20nm平面HKMG制程的几款产品中。图3显示台积电的熔丝在M2时形成,其中两款已经熔断。这些熔丝成对地出现,其中之一可作为熔线,另一款则可能用于差动感测电路的参考组件。
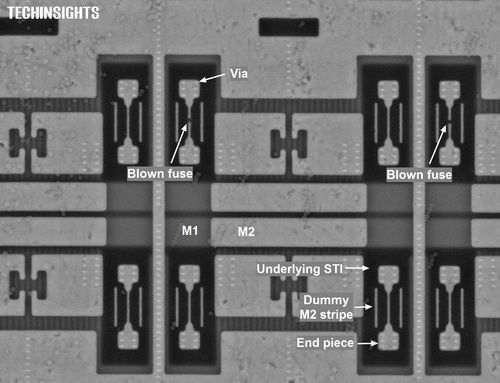
图3:采用台积电eFuse 20nm平面HKMG制程的高通(Qualcomm) Gobi MDM9235调制解调器逻辑结构分析
图4所示的熔丝具有蝴蝶结形状的狭窄熔线,连接至更宽的转换区与较大的终端组件。图中可看到6个过孔接触至终端组件,过孔冗余提供低电阻连接至熔线。
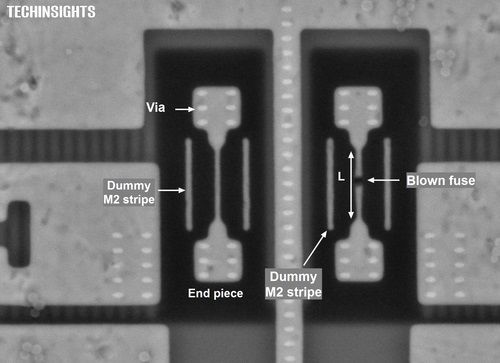
图4:台积电的eFuse的放大图
本文下一页:更多台积电eFuse揭密
{pagination}
较大的端点也可以作为散热片,让熔丝在熔断过程中两端较中间区域冷。熔线的中间部份理应是最热的部份,因为它距离冷却端点最远。这或许可解释为什么我们看到熔丝的熔断部份总是在中间,而非接近任一端点处。
我 们可以估算出台积电eFuse的中间部份有多热。首先,我们假设在熔断过程中并未对端点组件加热,由熔线而来的热会流至端点组件,但不至于流进周围的电介 质。这并不至于不合理,因为铜的热导率大约比熔线周围的低k电介质更好1,000倍(铜:385w/mK;SiOC:~0.4W/mK)。我们还假设在此 计算中,铜的电阻率并不会随温度改变而发生变化。其实这项假设是错误的,但可大幅简化我们的计算。我们估计熔线中间部份的温度大约上升了:

在公式(2)中,p是Cu的电阻率,k则是其热传导率。L是熔丝长度,A是熔丝的横截面。I则是指由于偏置电流而来的驱动电流,可被视为一个常数。
这可使熔丝中间部份的温度提高大约170℃,但还不够热到足以加速电迁移过程。
当金属表现出正的温度系数时,我们在公式(2)中所假设的恒定电阻率显然是错误的,因为所给定的电阻率为:

其中,a是Cu的温度系数(3.9×10-3K-1)。将公式(2)中的170℃温度加入公式(3),显示熔丝中间部份的电阻率增加了近70%。熔线中间部份增加的电阻值导致加速焦耳加热(IR加热),从而造成了热耗散。我们认为这种热耗散在台积电的融合作用(而非电迁移)中占据主导地位。
台积电在其US 8,749,020 (‘020)专利中显示,该公司利用化学机械研磨(CMP)微负载效应削薄了熔丝的中间部份,迫使熔线先在中间熔融,从而提高其电阻率。该‘020专利还 指出,熔线的厚度会受到相邻虚拟金属图案出现的影响,在CMP期间,较大的相邻虚拟金属图案可能导致从熔线移除金属的机会增加。因此,熔丝的中间部份较两 端更薄,如图5。
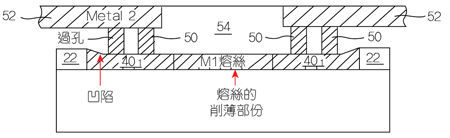
图5:熔丝截面图(USP 8,749,020)
但图4看到的虚拟M2金属片似乎太小,并不至于影响熔线的CMP处理。透过图6的扫描式电子显微镜(SEM)横截面可看到台积电的熔丝长度。
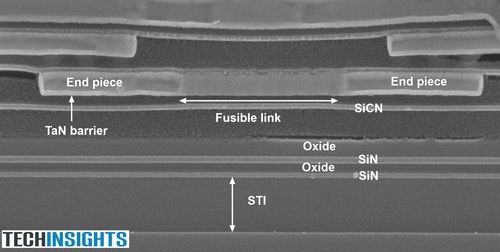
图6:台积电的熔丝SEM横截面图。但我们并未发现熔线的中间部份比两端更薄
此外,图7的TEM截面图可看出一些紧密的间距与单独的M3,显示金属的局部图案并不至于影响金属线宽或厚度。
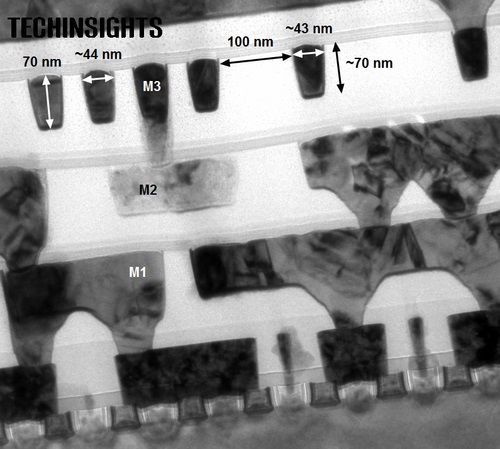
图7:台积电20nm制程实现最小间距的第三层金属(M3)
我们认为,台积电的虚拟金属片并未被用于形成熔线,而是作为被熔断熔丝喷出材料的阻障层。此外,IBM的eFuse专利(8,421,186)也支持这样的解释。在该专利中,IBM将这种虚拟金属片描述为阻障线,作为阻绝熔断熔丝喷出碎屑的阻障层。
从这样的形容中可知熔断过程相当猛烈,就像我们在英特尔的熔丝(图2)所看到的情形一样。如果是这样的话,台积的的虚拟M2金属片作用就像是阻障层一样,用于避免喷发的铜扩散至相邻电路。
经过多次反向工程的努力后,我们总算了解这些eFuses如何运作了。
编译:Susan Hong
本文授权编译自EE Times,版权所有,谢绝转载

关注最前沿的电子设计资讯,请关注“电子工程专辑微信公众号”。